Аналогично не описывается
моделью константных неисправностей повреждение типа «замыкание» транзистора.
Рассмотрим такое повреждение транзистора V1 в схеме (рис. 4.4). На входном наборе ab = 10 получаем состояние схемы: V1 замкнут, V2 и V3 открыты.
В результате создается короткая цепь между питающими полюсами схемы и возникает
большой ток (показан стрелкой). Этот ток ( ![]() -ток)
по величине в несколько раз больше чем нормальный ток покоя КМОП-схемы. Измеряя
ток, можно обнаруживать данную неисправность.
-ток)
по величине в несколько раз больше чем нормальный ток покоя КМОП-схемы. Измеряя
ток, можно обнаруживать данную неисправность. ![]() -тестирование
позволяет обнаруживать многие виды неисправностей в КМОП-схемах, которые не
покрываются моделью константных неисправностей.
-тестирование
позволяет обнаруживать многие виды неисправностей в КМОП-схемах, которые не
покрываются моделью константных неисправностей.
Отметим еще два вида распространенных неисправностей, не являющихся константными. Большую долю повреждений в современных микроэлектронных схемах с высокой степенью интеграции составляют короткие замыкания между линиями схемы (рис. 4.5, а) или мостиковые неисправности (bridging fault).

Рис.4.5. Моделирование короткого замыкания
При изготовлении печатных плат и интегральных схем их доля может составить 50–60%. Эти неисправности изменяют логическую функцию, реализуемую схемой. Логическое моделирование короткого замыкания линий осуществляется с помощью элемента И (рис. 4.5, б), если сигнал «логический 0» доминирует в схеме над сигналом «логическая 1», или с помощью элемента ИЛИ (рис. 4.5, в) в противном случае. Вопросы обнаружения коротких замыканий рассмотрены в разделе 4.4.
Важной областью тестирования является в настоящее время обнаружение временных неисправностей. Это связано с тем, что с увеличением быстродействия время переключения транзисторных схем становится соизмеримым с временем распространения электрических сигналов в монтажных проводах и дорожках печатных плат. Поэтому временные отклонения с большой вероятностью могут нарушать правильную работу логических схем. Рассматриваются две модели временных задержек (delay fault) – это задержки элемента (gate delay fault) и задержки пути (path delay fault). Методам их обнаружения посвящен раздел 4.6.
4.2. Тесты логических элементов
Логический элемент (ЛЭ)
представляет собой устройство (рис. 4.6), имеющее ![]() входов
и один выход, на котором реализуется некоторая функция алгебры логики
входов
и один выход, на котором реализуется некоторая функция алгебры логики ![]() .
.
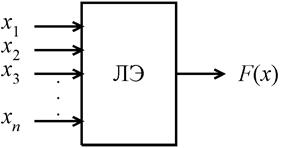
Рис.4.6. Логический элемент
Дефект внутренней структуры элемента
приводит к тому, что на его выходе вместо функции ![]() реализуется
функция неисправности
реализуется
функция неисправности ![]() . Тест проверки ЛЭ должен
определить, какую из функций [
. Тест проверки ЛЭ должен
определить, какую из функций [![]() или
или ![]() ] реализует элемент. Число и вид функций
неисправности определяется внутренней структурой ЛЭ. Анализ неисправностей и
построение теста ЛЭ выполняют при помощи ТФН.
] реализует элемент. Число и вид функций
неисправности определяется внутренней структурой ЛЭ. Анализ неисправностей и
построение теста ЛЭ выполняют при помощи ТФН.
Рассмотрим процесс
построения теста на примере ЛЭ на транзисторе, реализующего функцию ИЛИ-НЕ
(рис. 4.3). Структура элемента содержит резисторы ![]() и
транзистор V. Рассмотрим обрывы резисторов
(короткие замыкания резисторов маловероятны), обрыв и короткое замыкание
перехода эмиттер–коллектор (Э–К) транзистора (обрывы и короткие замыкания
переходов эмиттер–база и база–коллектор в конечном счете приводят к указанным
неисправностям перехода Э–К). Рассмотрим только одиночные повреждения деталей,
хотя в данном случае тест, построенный для одиночных повреждений, будет
обнаруживать и любую их совокупность. К одиночным повреждениям (неисправностям)
относятся:
и
транзистор V. Рассмотрим обрывы резисторов
(короткие замыкания резисторов маловероятны), обрыв и короткое замыкание
перехода эмиттер–коллектор (Э–К) транзистора (обрывы и короткие замыкания
переходов эмиттер–база и база–коллектор в конечном счете приводят к указанным
неисправностям перехода Э–К). Рассмотрим только одиночные повреждения деталей,
хотя в данном случае тест, построенный для одиночных повреждений, будет
обнаруживать и любую их совокупность. К одиночным повреждениям (неисправностям)
относятся: ![]() – соответственно обрывы резисторов
– соответственно обрывы резисторов ![]() ;
; ![]() –
короткое замыкание перехода Э–К транзистора;
–
короткое замыкание перехода Э–К транзистора; ![]() – обрыв
перехода Э–К транзистора;
– обрыв
перехода Э–К транзистора; ![]() – соответственно обрывы
базы, эмиттера, коллектора транзистора.
– соответственно обрывы
базы, эмиттера, коллектора транзистора.
В табл. 4.1 представлена ТФН для рассматриваемого элемента.
|
№ |
Входной набор |
F |
Функции неисправности |
||||||||
|
|
|
|
|
|
|
|
|
|
|||
При внесенной неисправности |
|||||||||||
|
a b |
|
|
|
|
|
|
|
|
|
||
|
0 |
0 0 |
1 |
1 |
1 |
0 |
1 |
0 |
1 |
1 |
1 |
1 |
|
1 |
0 1 |
0 |
0 |
1 |
0 |
0 |
0 |
1 |
1 |
1 |
1 |
|
2 |
1 0 |
0 |
1 |
0 |
0 |
0 |
0 |
1 |
1 |
1 |
1 |
|
3 |
1 1 |
0 |
0 |
0 |
0 |
0 |
0 |
1 |
1 |
1 |
1 |
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.