Для монохроматического света,
 МКМ
МКМ
5. Содержание отчета
1. Краткое описание установки
2. Порядок работы
3. Режим напыления
4. Результаты измерения толщины пленки
5. Обработка результатов
6. Выводы
ЛИТЕРАТУРА
1. В.Н.Черняев. Технология производства интегральных микросхем. "Энергия", М.,1977.
2. А.С.Березин, О.Р. Мочалкина. Технология и конструирование интегральных микросхем. Москва. "Радио и связь", 1903.
3. М.Ф.Понамарев, Б.Г.Конаплев. Конструирование и расчет микросхем и микропроцессоров. Учебное пособие для вузов. М., Радио и связь.1986.
4. Данилин Б.С. Применение низкотемпературной плазмы для нанесения тонких пленок.М.,Энератомиздат,1989.
ПРИЛОЖЕНИЕ 1
Ионное-плазменное напыление происходит в тлеющем разряде и состоит в распылении материала отрицательно заряженного электрода-мишени под действием ударяющихся о него ионизированных атомов газа и осаждении распыленных атомов на подложку. Для возникновения разряда в газе между двумя электродами катодом и анодом, расположенными в камере с низким давлением газа, прикладываем постоянное напряжение. Для прохождения тока между электродами необходима постоянная эмиссия электронов с катода. Эмиссия электронов может начаться под действием высокого напряжения между электродами. Если приложенное напряжение превышает потенциал ионизации рассматриваемого газа, то столкновения электронов с молекулами газа являются ионизирующими. Возникающие ионы ускоряются электрическим полем и движутся по направлению к катоду. Накопление ионов перед катодом приводит к возникновению здесь локализованного пространственного заряда и к возрастанию электрического поля. Ионы, приобретающие энергию в этом поле при бомбардировке катода вызывают эмиссию вторичных электронов из катода, которая поддерживает самостоятельный тлеющий разряд. Структура этого разряда и распределение потенциала между электродами представлены на рисунке.
Механизм структуры тлеющего разряда можно трактовать следующим: в катодном темном пространстве (1) происходит сильное ускорение электронов и положительных ионов, бомбардирующих катод за счет передачи энергии этих ионов атомам катода происходит распыление материала катода. В зоне отрицательного свечения (2) электроны теряют свою энергию при ударной ионизации молекул газа. В результате образуются положительные ионы, необходимые для бомбардировки катода и поддержания разряда. В области положительного столба (б) концентрация электронов и ионов примерно одинакова и очень велика. Эта область служит как бы проводником и расстояние (б) можно менять.
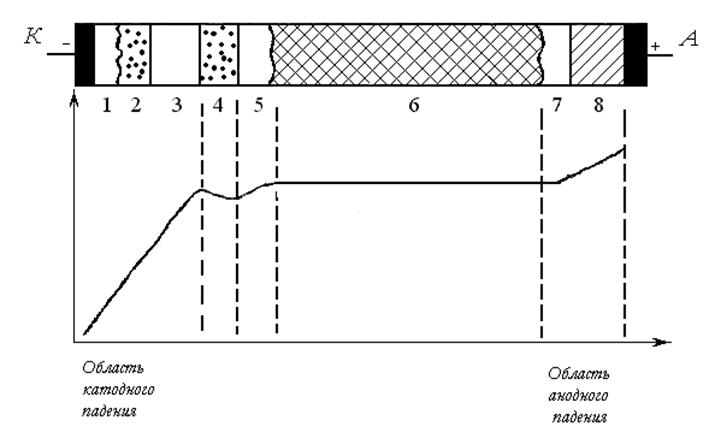 |
1 - темное астоново пространство
2 - первое катодное свечение
3 - темное катодное пространство
4 - отрицательное тлеющее свечение
5 - темное фарадиво пространство
6 - положительный столб
7 - анодное свечение
8 - темное анодное пространство
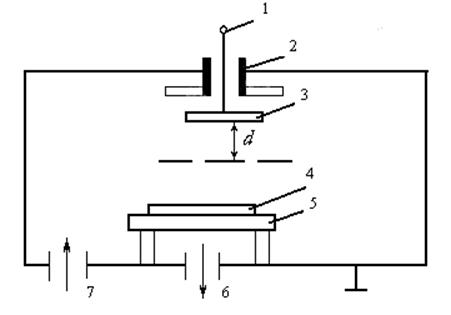 |
1 – высоковольтный ввод, 2 – экран, 3 – катод, 4 – подложка, 5 – анод, 6 – выход к откачной системе, 7 – натекатель для аргона.
Для эффективного осаждения распыленных атомов на подложку она должна располагаться достаточно близко к катоду. Обычно расстояние между катодом и подложкой составляет полторы-две длины темного катодного пространства. Основным фактором, определяющим скорость напыления, являются напряжение и ток разряда, давление газа, концентрация примесей в рабочем газе и температура подложки. Число атомов, удаленных с поверхности одним ионом, называют коэффициентом распыления.

Na – число распыляемых атомов вещества,
NO – число бомбардирующих ионов. Для того, чтобы атом вещества покинул поверхность мишени, его энергия должна быть больше некоторого порогового значения - энергии связи атома с твердым веществом. Нужно отметить, что значения пороговой энергии En лежат в пределах 10......30 эВ. Связь коэффициента распыления с параметрами ионов взаимодействующих веществ (массой, энергией) имеет эмпирическую зависимость:

где 6,025 1023 - постоянная Авогадро,
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.