Источник света подбирается по спектральной характеристике и мощности. Достаточную высокую интенсивность излучения в диапазоне 300...450 нм и мощность 100...500 Вт обеспечивают ртутно-кварцевые лампы высокого давления ДРШ-100, ДРШ-250, ДРШ-500. Для создания равномерного светового потока с параллельным пучком света используют системы кварцевых конденсаторов. Время экспонирования задается специальным устройством - электромагнитным затвором. Для совмещения элементов с размерами 2...5 мкм необходимо увеличение в 200 раз. Если При этом требуется глубина резкости 10...15 мкм, то рабочее поле составляет около 1...3мм. Разрешающая способность контактной фотолитографии ограничена длиной волны излучения, к которому чувствительны разработанные фото фоторезисты. При серийном производстве контактная фотолитография обеспечивает в слое фоторезиста минимальный размер 0,8 мкм
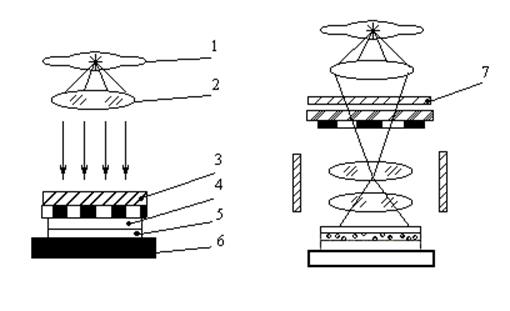 |
Рис.1 (а) Рис.1(6)
1 - источник света, 2 - конденсатор, 3 - фотошаблон, 4 -фоторезист, 5 - пластина кремния, 6 - столик, 7 - светофильтр, 8 - проекционный объектив
При проекционном экспонировании достигается повышение разрешающей способности фотолитографии, при котором дифракционные явления характерные для контактной фотолитографии устраняются. Минимальный размер в слое фоторезиста, получаемый при проекционной фотолитографии составляет 0,4 мкм. При выборе оптимального времени экспонирования следует учитывать также взаимосвязь времен экспонирования и проявления и исходить из того, чтобы время проявления было меньше, поскольку в этом случае снижается воздействие проявителя на неэкспонированные участки и уменьшается плотность дефектов. Вместе с тем повышение времени экспонирования ограничено двумя факторами - снижением точности передачи размеров и плохой воспроизводимостью процесса. Позитивные фоторезисты проявляются в сильно разбавленных растворах КОН, NaОН или тринатрийфосфат Na5РО4. После проявления производят вторую сушку резиста (задубливание). Цель этой операции состоит в повышении адгезии и кислотостойкости. Сушка проводится при температуре 130...200°С для резистов различных марок, как правило, в несколько этапов с постепенным повышением температуры. На этом завершается создание защитного рельефа фоторезиста. Фоторезист удаляют кипячением в серной кислоте, обработкой в горячей (70...80°0) смеси диметилформамида и моноэтанопамина.
2. Очистка пластин
Нанесению фоторезиста предшествует обработка подложки, улучшающая сцепление слоя резиста с подложкой или ухудшающая смачивание подложки травителем. Для этого могут быть использованы простая очистка (обезжиривание) поверхности; физико-химическая обработка, изменяющая свойства поверхности; нанесение смазывающего подслоя.
В лабораторных условиях кремниевые пластины будут поступать на фотолитографию непосредственно после окисления. Пластины, пролежавшие свыше 5 часов после окисления должны подвергаться отжигу в печи при температуре 800...9ОО°С.
3. Фотошаблоны
Изображение в слое фоторезиста формируется с помощью фотошаблонов, представляющих собой прозрачные пластины с рисунком, состоящим из сочетания непрозрачных и прозрачных для света определенной длины волны участков, образующих топологию одного из слоев структуры прибора или элементов ИС, многократно повторенных в пределах Поля пластины. Обычно используют металлостекпянные фотошаблоны, в которых рисунок получается тонкой металлической пленкой, нанесенной на стеклянную подложку. Фотошаблоны должны иметь высокую разрешающую способность, высокую точность идентичных изображений, высокую точность соблюдения размеров элементов и числа между элементами, стабильность характеристик, плоскостность рабочей стороны фотошаблона, высокая устойчивость к испарений.
Достоинства процесса фотолитографии:
– возможность получения элементов микросхем весьма малых размеров (до одного микрометра) практически любой конфигурации;
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.