3. Травление должно быть однородно по пластине, по лоту и между лотами пластин.
4. Размер рисунка должен быть перенесен без “ухода размера”
(анизотропность, т.е. направленность, травления).
5. Травитель не должен повреждать подложку.
Процессы травления делят обычно на “жидкостное” и “сухое” травление.
При жидкостном удалении материала происходит химическая реакция и переход от исходного твердого вещества к раствору продукт его реакции с травящим агентом. Достоинство – селективность одного материала по отношению к другому, недостаток жидкостного травления – изотропия травления (слой травится с одинаковой скоростью во всех направлениях). В итоге изотропного травления “уход“ размера элемента происходит примерно на 2 толщины травимого слоя материала. Поскольку элементы ИМС должны иметь четко фиксированные и очень малые размеры, эффект изотропии жидкостного травления должен быть преодолен.
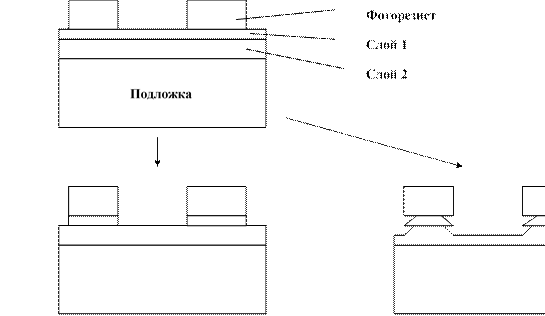
Анизотропное и селективное травление Изотропное и неселективное травление
Рис.1.40. Исходный объект после фотолитографии (вверху) и варианты травления (внизу).
В этой связи в технологии ИМС стали широко использоваться “сухие” методы, дающие возможность осуществлять “анизотропное травление”. “Сухие” методы обычно делят на три группы, см. табл.1.3.
В основном используется метод RIE. Добавление кислорода к плазме CF4 дает увеличение скорости травления кремния и диоксида кремния потому, что кислород снижает скорость рекомбинации CFх и F. Концентрация фтора возрастает. При добавлении водорода скорость травления кремния снижается, а диоксида кремния остается постоянной, т.к. водород реагирует с F образуя HF, т.е. снижает концентрацию F. То есть добавка водорода приводит к улучшению селективности травления SiO2 к Si.
Плазменное травление может осуществляться во фтор-, хлор-, бромсодержащих газах и парах. Это чрезвычайно чувствительный метод к входным параметрам.
Таблица 1.3
|
Сухие методы травления |
|||
|
Метод Термин |
Физическое распыление Physical sputtering |
Реактивно-ионное травление Reactive ion etch (RIE) |
Плазменное травление Plasma chemical etch |
|
Идея метода |
Ионная бомбардировка |
Комбинация двух соседних c добавлением O2 или H2 |
Удаление благодаря химическим реакциям в плазме: CF4 + e- Æ CF3+ + 2e- + F Si + 4F Æ SiF4 SiO2 + 4F Æ SiF4 + O2 |
|
Достоинства |
Максимальная анизотропия |
Анизотропия |
Изотропия |
|
Недостатки |
Нет селективности удаления |
Селективность |
Есть селективность травления |
Суммируя основные проблемы и задачи травления, можно фиксировать следующие основные моменты.
1. Однородность воспроизведения размера элементов по площади подложки и в пределах чипа при травлении элементов с различной геометрией и плотностью. Необходимо минимизировать т.н. micro-loading effect., то есть снижение скорости травления на участках с максимальной плотностью элементов с малым зазором.
2. Необходимо использовать максимальную селективность травления должна повышаться.
3. Необходима максимальная скорость травления для производительности процессов.
4. Необходимо контролировать профиль травления.
5. Необходимо исключать возможность влияния плазмы на приборы (plasma damage).
6. После плазменного травления необходимо удаление полимерные образования на стенках травимого объекта (sidewall passivation). Процесс травления должен завершаться удалением полимера со стенок (polimer removal).
7. Необходимо осуществлять оптимизацию образования и удаление побочных продуктов травления (residues) на стенках реакционной камеры.
8. Необходимо следить за эффектами коррозии при травлении металлических слоев.
9. Необходимо следить за процессами образования микрочастиц в ходе травления.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.