
















№ 337
КОНСТРУИРОВАНИЕ И ТЕХНОЛОГИЯ
МИКРОСХЕМ И МИКРОПРОЦЕССОРОВ
Методические указания к
лабораторным работам № 3 и 4
НОВОСИБИРСК— 1990
ИССЛЕДОВАНИЕ
ТЕХНОЛОГИЧЕСКОГО ПРОЦЕССА ЭПИТАКСИАЛЬНОГО ВЫРАЩИВАНИЯ КРЕМНИЕВЫХ
ПЛЕНОК
1. Цель работы.
Целью настоящего цикла из двух лабораторных работ является приобретение навыков в проведении технологических расчетов, исследование и регулирование процесса эпитаксии с помощью моделирования на ЭВМ. Используется модель хлоридного процесса при атмосферном давлении. Модель и основные расчетные соотношения могут быть использованы также для анализа процесса осаждения пленок поликристаллического кремния, нашедших широкое применение в технологии изготовления полупроводниковых приборов и микросхем.
2. Основные сведения.
2.1. Схема процесса.
Схема технологического процесса эпитаксии приведена на рис.1.
Кремниевые подложки размещаются на графитовой подставке, представляющей из себя
многогранную пирамиду, цилиндр с углублениями под пластины, либо усеченный
конус с различными углами между образующей и вертикалью.
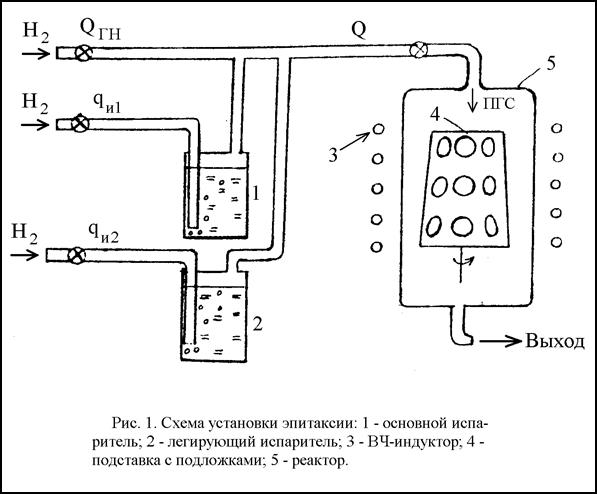
В настоящей работе для упрощения подставка рассматривается в виде усеченного конуса (рис.2), в котором может изменяться угол q.

Подложки размещаются в 3 яруса, контрольный замер проводится на одной пластине с каждого яруса.
С помощью высокочастотного индуктора подставка нагревается до температуры 1000...1300 °С.
На вход реактора подается парогазовая смесь (ПГС) из газа-носителя (H2) и паров реагента: источник кремния (SiCl4), легирующего вещества (PCl3, BBr3 и т.д.) - для получения эпитаксиальных пленок кремния заданного типа проводимости и удельного сопротивления. Легирующее вещество обычно добавляется либо непосредственно в рабочий испаритель с SiCl4 (в этом случае выращиваются пленки с фиксированным удельным сопротивлением), либо подается из отдельного, легирующего испарителя с повышенной концентрацией легирующей примеси в SiCl4. В этом случае, меняя поток газа-носителя через легирующий испаритель, можно в довольно широких пределах изменять удельное сопротивление выращиваемой пленки. В настоящей работе предусматривается возможность работы как с одним, так и с двумя испарителями (по указанию преподавателя).
На поверхности нагретой подложки происходит реакция химического восстановления кремния и легирующего вещества в соответствии с уравнениями:
![]() ; (1)
; (1)
![]() ; (2)
; (2)
В итоге растет легированная эпитаксиальная пленка, толщина которой определяется скоростью роста и длительностью технологического процесса. В свою очередь скорость роста определяется рядом факторов технологического процесса:
а) Относительная объемная концентрация SiCl4 в ПГС (![]() ). В связи
с малым уровнем легирования ((1014...1017)×см-3)
концентрация легирующего вещества практически не влияет на скорость роста. В
свою очередь концентрация SiCl4 определяется
температурой испарителя (
). В связи
с малым уровнем легирования ((1014...1017)×см-3)
концентрация легирующего вещества практически не влияет на скорость роста. В
свою очередь концентрация SiCl4 определяется
температурой испарителя (![]() ) и
расходом газа-носителя через испаритель (
) и
расходом газа-носителя через испаритель (![]() ) и может
быть рассчитана из соотношения:
) и может
быть рассчитана из соотношения:
 . (3)
. (3)
(Примечание: соотношение (3) справедливо для испарителя с
барботажем.) Здесь ![]() - давление ПГС;
- давление ПГС; ![]() - давление паров
- давление паров
![]() в испарителе, определяемое температурой испарителя (
в испарителе, определяемое температурой испарителя (![]() );
);
![]() - общий поток
парогазовой смеси;
- общий поток
парогазовой смеси; ![]() - поток водорода через
основную магистраль, обычно он значительно больше чем
- поток водорода через
основную магистраль, обычно он значительно больше чем ![]() ,
поэтому для приближенных расчетов величиной
,
поэтому для приближенных расчетов величиной ![]() можно пренебречь, т.е. считать, что
можно пренебречь, т.е. считать, что ![]() .
.
 При работе из двух испарителей,
через которые пропускаются потоки соответственно
При работе из двух испарителей,
через которые пропускаются потоки соответственно ![]() и
и ![]() , следует
учитывать также
, следует
учитывать также ![]() , поступающий из второго испарителя
, поступающий из второго испарителя
(4)
Давление
![]() ;
; ![]() -
температура, К;
-
температура, К; ![]() - в мм рт. ст. В
реальных условиях обычно
- в мм рт. ст. В
реальных условиях обычно ![]() =
= ![]() (оба испарителя находятся в едином термостате). Чтобы
изменение потока через второй испаритель (легированный) при корректировке
величины сопротивления не влияло существенно на скорость роста
(оба испарителя находятся в едином термостате). Чтобы
изменение потока через второй испаритель (легированный) при корректировке
величины сопротивления не влияло существенно на скорость роста ![]() .
.
б)
Температура эпитаксии (![]() )
влияет как на скорость доставки реагента к поверхности, так и на скорость
реакции на поверхности подложки, зависимость носит сложный характер и будет детально
рассмотрена ниже.
)
влияет как на скорость доставки реагента к поверхности, так и на скорость
реакции на поверхности подложки, зависимость носит сложный характер и будет детально
рассмотрена ниже.
в) Ряд газодинамических факторов, влияющих
главным образом на скорость доставки реагентов к поверхности за счет диффузии
через газовую фазу: давление на входе в систему, температура ПГС, зависящая от ![]() ,
температуры стенок реактора (
,
температуры стенок реактора (![]() ), геометрии
системы (радиус реактора
), геометрии
системы (радиус реактора ![]() , радиус
подставки (
, радиус
подставки (![]() ), расстояние от
начала подставки до точки, в которой происходит осаждение, z);
скорость газового потока, определяемая общим расходом ПГС (
), расстояние от
начала подставки до точки, в которой происходит осаждение, z);
скорость газового потока, определяемая общим расходом ПГС (![]() )и сечением, через которое проходит ПГС.
)и сечением, через которое проходит ПГС.
2.2.
Факторы, определяющие скорость роста при наличии
двух конкурирующих процессов.
В нашем случае следует учитывать
наличие двух основных факторов, определяющих суммарную скорость роста:
скорость доставки реагентов к зоне реакции (![]() ) через
газовую фазу и скорость реакции на поверхности (
) через
газовую фазу и скорость реакции на поверхности (![]() ). В
этом случае итоговая скорость (
). В
этом случае итоговая скорость (![]() ) определяется выражением [l,2]
) определяется выражением [l,2]
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.