4. амплитуда тепловых колебаний атомов решетки подложки, определяемая ее температурой.
Значительную роль в правильном выборе траектории ионов в подложке играет эффект каналирования: это движение ионов примеси вдоль одного из открытых направлений в решетке подложки по кристаллографическим осям или по атомным плоскостям. Каналирование ионов увеличивает глубину залегания p-n переходов и уменьшает дефектность структуры.
Средний пробег иона с начальной энергией ![]() можно рассчитать из выражения:
можно рассчитать из выражения:
 (1)
(1)
где N – концентрация атомов в подложке;
Sn – поперечное сечение ядерного торможения (ядерная
тормозная способность) ![]() .
.
 (2)
(2)
 (3)
(3)
где ![]() и
и
![]() - заряды ядер иона и атома;
- заряды ядер иона и атома;
![]() и
и ![]() - атомные веса иона и атома.
- атомные веса иона и атома.
Проинтегрировать выражение (1) с учетом (2) и (3) получаем:
 (4)
(4)
На пробег иона влияет ориентация подложки (эффект деканалирования), которая учитывается углом каналирования. Превышение этого угла приводит к ядерным столкновениям и разупорядочению структуры.
Критический угол при внедрении в кремний ионов бора и
фосфора в зависимости от энергии ионов и кристаллографического направления
составляет ![]() . Наибольший пробег достигается по
направлению <110>; наименьший - <100>. На практике с достаточной
точностью нормальный пробег ионов бора и фосфора в кремнии при энергиях Е=20¸100 кэВ можно принять равным:
. Наибольший пробег достигается по
направлению <110>; наименьший - <100>. На практике с достаточной
точностью нормальный пробег ионов бора и фосфора в кремнии при энергиях Е=20¸100 кэВ можно принять равным:

Математическое распределение примеси вблизи максимума определяется законом Гаусса:

где Q – доза
облучения; ![]() -
среднее отклонение нормального пробега
-
среднее отклонение нормального пробега ![]() .
.
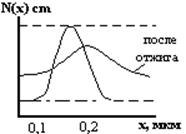 В принципе ионную
имплантацию, как и диффузию, можно проводить многократно, встраивая один слой в
другой, но сочетание энергий, времен экспозиции и режимов отжига, необходимых
для многократной имплантации очень затруднительно, поэтому ионная имплантация
применяется главным образом при создании тонких одинарных слоев.
В принципе ионную
имплантацию, как и диффузию, можно проводить многократно, встраивая один слой в
другой, но сочетание энергий, времен экспозиции и режимов отжига, необходимых
для многократной имплантации очень затруднительно, поэтому ионная имплантация
применяется главным образом при создании тонких одинарных слоев.
Концентрация примеси в имплантированном слое зависит от плотности тока в ионном пучке и времени проведения процесса (времени экспозиции). В зависимости от плотности тока и желаемой объемной концентрации время экспозиции составляет от нескольких секунд до 3-5 минут. Чем больше время экспозиции, тем больше количество радиационных дефектов.
Максимальное значение концентрации носителей, например
в ионно-легированных слоях кремния достигает ![]() для
бора и
для
бора и ![]() для фосфора.
для фосфора.
Ионное легирование полупроводника в планарной технологии применяется:
1. для введения фиксированного количества примеси в локальную область;
2. для создания контролируемого распределения концентрации примеси в заданной области;
Преимущества ионного легирования:
1. возможность точного задания конфигурации распределения концентрации примеси как по глубине, так и по площади облучения, при этом градиент концентрации примеси в области p-n перехода значительно больше чем у диффузионного профиля;
2. осуществление процесса при низких температурах, это позволяет сохранить заданный профиль распределения концентрации примеси в структурах и их электрофизические параметры;
3. возможность легирования полупроводника любыми легирующими примесями в любых количествах, вплоть до предельной растворимости;
4. получение изотропной чистоты ионов легирующей примеси, сепарированных в магнитном поле;
5. отсутствие влияния окружающей среды, так как процесс идет в вакууме;
6. высокая воспроизводимость результатов, благодаря точному контролю интенсивности пучка и дозы внедряемых атомов;
7. возможность осуществления на одной установке комплекса операций, включая легирование, металлизацию и защиту поверхности.
Недостатки метода:
1. сложность технологических установок;
2. возможность образования дефектного слоя на поверхности подложки.
Применение: ионное легирование используется для создания биполярных транзисторов СВЧ - диапазона, МДП-транзисторов с самосовмещающимся затвором, диодов, высокоомных резисторов и других элементов полупроводниковых ИМС.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.