В случае диффузии из неограниченного источника график распределения примеси по глубине залегания выглядит так:
Глубину диффузионного слоя можно найти из выражений (6) и (7) полагая что, в левой части N=N0, тогда x=LN:
 (8)
(8)
Диффузия из ограниченного источника: функция распределения это распределение Гауса имеет нулевую начальную производную, точку перегиба и почти экспоненциальный хвост.
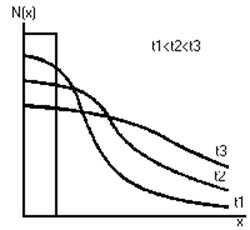 Глубину диффузионного слоя
можно найти из выражений (6) и (7) полагая что, в левой части N=N0, тогда x=LN:
Глубину диффузионного слоя
можно найти из выражений (6) и (7) полагая что, в левой части N=N0, тогда x=LN:
 (9)
(9)
Если сравнить выражения (8) и (9): они имеют одинаковую структуру и дают возможность сделать два вывода:
1. время проведения диффузии пропорционально квадрату желаемой глубины залегания примеси (продолжительность диффузии велика), реально создаваемые диффузионным методом переходы имеют глубину рабочих диффузионных слоев от1…4 мкм.
2. при заданной глубине диффузионного слоя, изменение коэффициента диффузии эквивалентны изменению времени процесса, по закону Аррениуса коэффициент диффузии есть функция от температуры, при изменении температуры коэффициент диффузии изменяется на порядок, при DТ=±10С, DD=±2,5%.
Современные методы высокотемпературного диффузионного легирования обеспечивают формирование локальных диффузионных областей в широком диапазоне концентраций и глубин введения примеси. Создаваемые р- n-переходы имеют бездефектную структуру.
Главная принципиальная проблема диффузионного легирования — необходимость высокотемпературного проведения процесса, что накладывает определенные ограничения на последовательность формирования ИМС из-за перераспределения примесей, ранее введенных в пластину.
Дальнейшее совершенствование этого метода легирования — улучшение качественных показателей процесса, сокращение продолжительности и снижение температуры.
Ионная имплантация – это метод легирования полупроводниковых пластин или эпитаксиальных слоев путем бомбардировки ионами примеси ускоренными до энергии достаточной для внедрения в глубь твердого тела. Очень широко применяется в технологии интегральных микросхем.
Физическая сущность метода заключается в следующем: ионы примеси получаются в специальных источниках, ускоряются и фиксируются в электрическом поле, они бомбардируют подложку и внедряются в приповерхностный слой полупроводника.
При внедрении в подложку ионы примеси расходуют свою энергию на два вида процессов:
1. возбуждение или ионизация атомов в кристаллической решётке подложки за счет кулоновского взаимодействия с ионами внедряемой примеси.
2. упругие ядерные столкновения ионов примеси с атомами подложки, в результате которых образуется большое число точечных дефектов решётки: междоузельные атомы в подложке и вакансии в структуре подложки – это нежелательный эффект, поэтому для упорядочения нарушений внедрением ионов в структуру и устранения радиационных дефектов, подложки подвергают отжигу (низкотемпературному 500-800С). Применяется лазерный отжиг.
Процесс ионного легирования состоит из внедрения
ионов примеси и отжига одновременного с внедрением или после него. Площадь
ионного пучка невелика, порядка 1-2 ![]() , поэтому его перемещают
вдоль пластины плавно либо скачками, идет сканирование луча вдоль пластины с
помощью специальных отклоняющих систем. Глубина внедрения ионов зависит от их
энергий и массы. Чем больше энергия (Е), тем больше глубина имплантированного
слоя, но больше концентрация радиационных дефектов в кристалле, за счет чего
ухудшаются электрофизические параметры микросхем, поэтому существуют
ограничения на энергию (Е): Е
, поэтому его перемещают
вдоль пластины плавно либо скачками, идет сканирование луча вдоль пластины с
помощью специальных отклоняющих систем. Глубина внедрения ионов зависит от их
энергий и массы. Чем больше энергия (Е), тем больше глубина имплантированного
слоя, но больше концентрация радиационных дефектов в кристалле, за счет чего
ухудшаются электрофизические параметры микросхем, поэтому существуют
ограничения на энергию (Е): Е![]() 100…150кэВ, нижний
предел Е³5…10кэВ, при таком значении энергии глубина
проникновения составляет 0,1…0,4 мкм.
100…150кэВ, нижний
предел Е³5…10кэВ, при таком значении энергии глубина
проникновения составляет 0,1…0,4 мкм.
Основные параметры определяющие пробеги ионов:
1. энергия и порядковый номер легирующего вещества;
2. порядковый номер металла подложки;
3. ориентация подложки;
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.