 , (4)
, (4)
где D3 и t3 - коэффициент диффузии и время процесса загонки; N03-концентрация примеси, поддерживаемая на поверхности пластины в течение процесса загонки.
Из начальных условий нам известна NВ – концентрация примеси в исходной пластине полупроводника, зададим температуру загонки примеси Т1 = 1050°С, при этой температуре величину N01 – предельная растворимость фосфора в кремнии составляет 1·1021см-3. Определим D1-коэффициент диффузии примеси для температуры Т1 он равен 6·10-13 см2/с.
Далее зададим температуру проведения разгонки примеси Т2=1150°С и аналогично, как и для процесса загонки определим параметры разгонки примеси: N02=2·1021 см-3, D2=5·10-12 см2/с.
 , где хj – глубина залегания примеси (уже
определенная нами величина). Отсюда можно найти t2
– время проведения разгонки примеси.
, где хj – глубина залегания примеси (уже
определенная нами величина). Отсюда можно найти t2
– время проведения разгонки примеси.
t=44 секунды.

t=1137 секунд.
6. Вторичное окисление.
При вторичном окислении на поверхности образуется тонкий слой двуокиси кремния, который предохраняет тензорезисторы от воздействия окружающей среды.
Затем проводится повторная фотолитография и вскрытие окон под контакты.
 |
7. Металлизация.
На пластину напыляют пленку алюминия толщиной 0,1…0,2 мкм. С помощью еще одной фотолитографии формируют металлическую разводку, объединяющую отдельные тензорезисторы в мостовую схему.
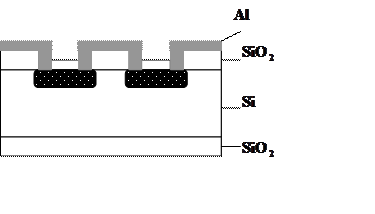 |
8. Пассивация.
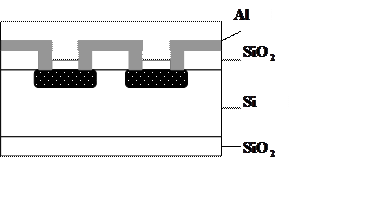 На поверхность пластины наносят еще один
защитный слой, в котором методом фотолитографии вскрываются окна к контактным
площадкам сенсора.
На поверхность пластины наносят еще один
защитный слой, в котором методом фотолитографии вскрываются окна к контактным
площадкам сенсора.
9. Профилирование.
На не
планарной стороне, кремниевой пластины, противоположной той, где создана
электрическая схема, с помощью фотолитографии вскрывается окно в ![]() для анизотропного травления кремния. Далее
проводят анизотропное травление, например в КОН.
для анизотропного травления кремния. Далее
проводят анизотропное травление, например в КОН.
Скорость
травления ![]()
![]() -
- ![]()
Скорость
травления ![]() -
- ![]()
Исходная толщина пластины составляет hисх= 250мкм, толщина упругого элемента hуэ=40мкм.
Найдем время травления кремния:
 .
.
Теперь рассчитаем толщину защитной маски:
![]() .
.
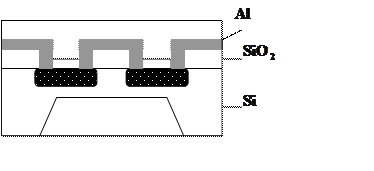 В процессе профилирования формируется
упругий элемент необходимой толщины.
В процессе профилирования формируется
упругий элемент необходимой толщины.
10. Скрайбирование пластин и разделение пластин на отдельные кристаллы (чипы).
11. Электростатическое присоединение кремниевого кристалла к переходной компенсирующей пластине из стекла Pirex-7740.
12. Кристалл вместе с переходной пластиной с помощью легкоплавкого стекла присоединяют к корпусу сенсора.
13. Защитное покрытие планарной стороны кристалла тензопреобразователя. Покрытие из эластичного органического материала защищает электрическую схему сенсора от воздействий внешней среды.
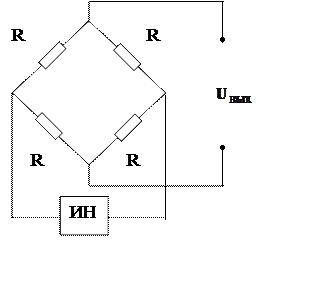 |
Рис. 14. Схема включения тензорезистивного моста.
 , (7.1)
, (7.1)
где ![]() ,
,
![]() ,
,
![]() ,
,
![]() ,
,
При напряжении питания 5 В и при номинальном давлении в P=1 атм получаем Uвых= 0,207 В.
На рис. 15 представлена зависимость выходного напряжения от давления, приложенного к упругому элементу.
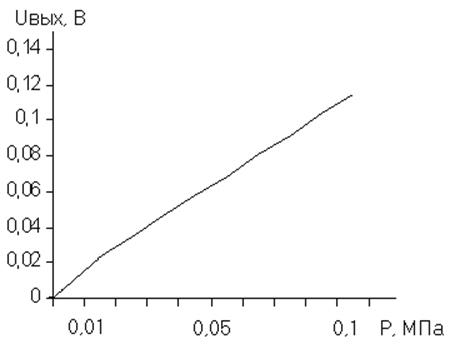
Рис. 15. Преобразовательная характеристика сенсора.
1. Курносов А.И., Юдин В.В. Технология производства полупроводниковых приборов и интегральных микросхем: - М. В.Ш., 1986.
2. Ваганов В.И. Интегральные тензопреобразователи. – М. «Энергоатомиздат», 1983
3. Черняев В.М. Физико-химические процессы в технологии РЭА. – М. В.Ш., 1987.
4. Конструирование и технология микросхем. Под ред. Коледова Л.А.-Учебное пособие. М. В.Ш., 1984.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.