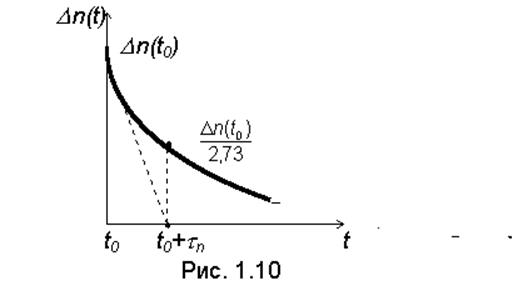 Время жизни электронов является величиной, обратной
вероятности встречи электрона с дыркой, которая равна g · p,
где g - коэффициент рекомбинации, определяемый структурой
кристаллической решетки полупроводника, а время жизни дырки - величина,
обратная вероятности встречи с электроном. Вероятность такой встречи
практически незначительна. В реальных структурах рекомбинация происходит по схеме
“зона - ловушка - зона”.
Время жизни электронов является величиной, обратной
вероятности встречи электрона с дыркой, которая равна g · p,
где g - коэффициент рекомбинации, определяемый структурой
кристаллической решетки полупроводника, а время жизни дырки - величина,
обратная вероятности встречи с электроном. Вероятность такой встречи
практически незначительна. В реальных структурах рекомбинация происходит по схеме
“зона - ловушка - зона”.
Ловушками называются разрешенные энергетические уровни, возникающие посередине запрещенной зоны за счет дефектов кристаллической структуры. При таком механизме рекомбинации электроны сначала захватываются ловушкой ( при этом рекомбинации дырки не происходит), а затем переходят в валентную зону (происходит рекомбинация дырки). (Рис. 1.11). В этом случае время жизни электронов является величиной , обратной вероятности захвата электрона ловушкой. При этом захват может быть осуществлен свободной ловушкой. Если M - концентрация ловушек, то M[1-P(Ei)] - концентрация свободных ловушек, где P(Ei) - вероятность нахождения электрона посередине запрещенной зоны, то есть в ловушке. Вероятность P(Ei) зависит то положения уровня Ферми. Следовательно:
 ,
(1.24)
,
(1.24)
соответственно рекомбинация дырок происходит через занятые ловушки, следовательно:
 .
(1.25)
.
(1.25)
Уравнения (1.24) и (1.25 ) позволяют сделать вывод о причинах, влияющих на время жизни неравновесных носителей заряда.
 Во-первых,
время жизни зависит от концентрации ловушек M. Чем больше дефектов в
кристаллической структуре полупроводника, тем меньше время жизни.
Во-первых,
время жизни зависит от концентрации ловушек M. Чем больше дефектов в
кристаллической структуре полупроводника, тем меньше время жизни.
Во-вторых, время жизни зависит от концентрации примесей. Чем больше содержится примесей, тем дальше от середины запрещенной зоны расположен уровень Ферми. Поэтому в электронном полупроводнике возрастает P(Ei) и соответственно уменьшается t p, а дырочном полупроводнике возрастает [1- P(Ei)] и соответственно уменьшается t n.
В-третьих, время жизни зависит от температуры. С повышением температуры уровни Ферми в электронном и дырочном полупроводниках сдвигаются к середине запрещенной зоны. Кроме того, графики P(E) приобретают более плавный изгиб. Поэтому уменьшается P(Ei) в электронном полупроводнике и уменьшается [1-P(Ei)] в дырочном полупроводнике. В результате чего с ростом температуры возрастает время жизни неравновесных носителей заряда.
Распределение концентрации неравновесных носителей заряда
Вследствие инжекции электронов в дырочный полупроводник возрастает их концентрация в приповерхностной области, что ведет к возникновению диффузии вдоль оси x. Диффундируя вглубь полупроводника электроны, встречаясь с дырками, рекомбинируют. Так как процесс рекомбинации носит вероятностный характер, то различные электроны, прежде чем рекомбинировать, успевают проникнуть вглубь полупроводника на различные расстояния. Вследствие этого, концентрация электронов оказывается распределенной неравномерно. Количество электронов, пересекающих в единицу времени единичную площадку, перпендикулярную направлению диффузии, пропорционально градиенту концентрации электронов, то есть:
 . (1.26)
. (1.26)
При инжекции дырок в электронный полупроводник количество дырок, диффундирующих через сечение x, определяется аналогичным образом, то есть:
 , (1.27)
, (1.27)
где Dn и Dp - коэффициенты диффузии электронов и дырок.
Поскольку электроны и дырки диффундируют в направлении убывания их концентрации, то это обстоятельство учитывается знаком минуса.
Для нахождения закона распределения избыточной концентрации вдоль оси x выделим внутри полупроводника объем, ограниченный сечениями x1 и x2 , приняв площадь поперечного сечения равной 1 см2 (рис. 1.12). Через сечение x1 в соответствии с (1.26) за время dt проходит D n(x1,t) электронов:
 , (1.28)
, (1.28)
а через сечение x2 проходят D n (x2,t) электронов:
 . (1.29)
. (1.29)
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.