25.09.01
Критическая площадь, допустимая плотность дефектов.
Критическая площадь – это площадь поверхности микросхемы, в пределах которой появление хотя бы одного локального приводит к браку всей микросхемы. Чем больше критическая площадь, тем больше требования к качеству фотошаблона.
Точность выполнения размеров элементов по всему полю изображения, их взаиморасположения в настоящее время – десятые доли микрона.
Точность воспроизведения геометрической конфигурации элементов в интегральной схеме характеризуется резкостью края контура, ограничивающего элемент, параметром нерезкостью и неровностью края.
Эксплуатационные требования – износостойкость, эксплуатационная надежность, стабильность параметров во времени.
Обозначение фотошаблонов состоит из буквы и двух цифр. Буква характеризует показатель размера, первая цифра – показатель точности, вторая цифра – показатель дефектности.
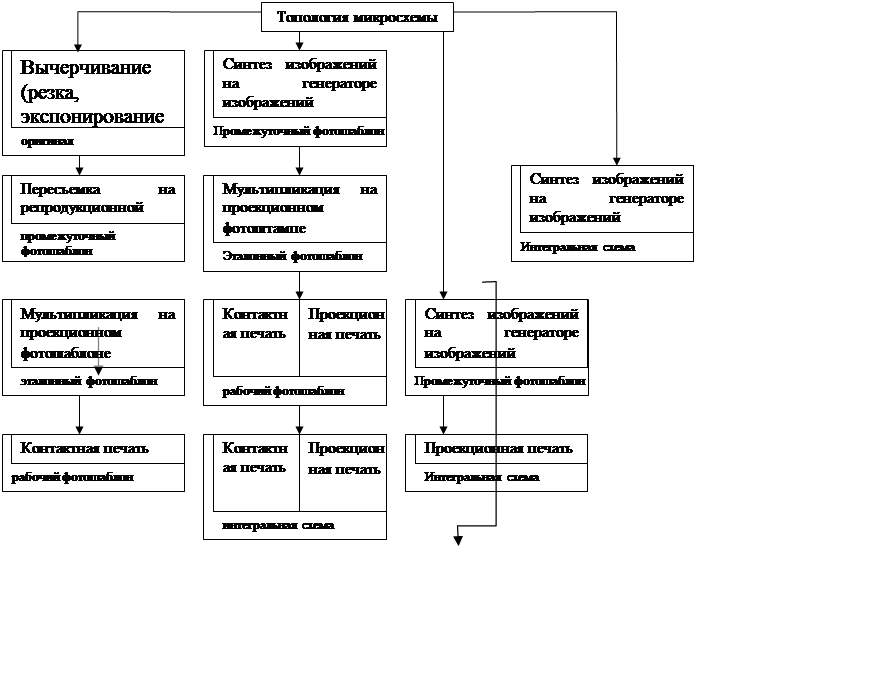
Конструирование фотошаблонов
 |
 |
 |
Наиболее распространенными покрытиями являются фотоэмульсии и пленки хрома.
С эмульсионным покрытием: минимальный размер 3 микрона, получаемый при фотопечати, малый срок эксплуатации. В случае контактной печати выдерживают 20 – 30 совмещений.
а) При хромовом покрытии, имеется высокий коэффициент отражения, и это многократное изображение формируют стоячие волны в толще фоторезиста. Минимальный размер элемента ³1,5 микрона. Качество маскирующих покрытий, когда достигает предела необходимо улучшать и изображать новый вид фотошаблона.
б) С двойным покрытием. Дефекты в нем распределяются по случайному закону и не совпадают с покрытием хрома и могут выдержать 200 циклов контактной печати.
в) Конструирование фотошаблонов с двойным маскирующим слоем – второй слой наносят в места дефектов первого слоя дополнительной фотолитографией с использованием экспонирования с обратной стороны пластины, причем первый слой является маскирующим.
г) Используется кварцевая пленка толщиной 0,2 микрона или прозрачная полимерная пленка, толщиной 1,5 – 3 микрона.
д) Буртик делается из кварцевого стекла по периметру фотошаблона, толщиной 1,5 – 3 микрона. Защитный слой создает гарантированный зазор при фотопечати.
е) Имеет идентичные маскирующие рисунки, повышенную эксплуатационную надежность, скорость нарастания дефектов уменьшается, изнашивается только одна сторона, но в этом случае необходима высокая точность совмещения с источником излучения.
ж) Фотошаблоны с двойным маскирующим покрытием, разделенным стеклом. Увеличивается износостойкость. Подобная конструкция может лежать в основе фазосдвигающего фотошаблона и минимальный размер меньше 1 микрона.
з) маскирующий слой в рельефном фотошаблоне заглублен в объем стекла, за счет формирования в нем каналов.
Для точной передачи размеров элементов, контурная часть рисунков выводится на поверхность стекла.
Диффузионные фотошаблоны образованы диффузией металла (Н: меди). Может быть оптимальной в условиях экспонирования приконтактной печати, уменьшаются интерференционные эффекты. Размер порядка нескольких микрон.
Гибкие фотошаблоны. Могут возникать дифракционные искажения из-за кривизны соприкасающихся поверхностей. h= 20 – 60 микрон, минимальный размер – 0,4 микрона.
Этапы изготовления фотошаблонов.
1) Разработка топологии;
2) Определение класса фотошаблона;
3) Определение конструкции фотошаблона;
4) Выбор способа изготовления фотошаблона;
5) Изготовление комплекта фотошаблонов.
Дано: структура базового элемента: транзистор биполярный;
тип изделия: интегральная микросхема;
минимальный размер изображения: 3 микрона;
допуск на размер: 0,8 микрона;
критическая площадь: 2,5 мм2.
Требуется определить:
1) при каких технологических операциях изготовления данного изделия требуются фотошаблоны. Сколько необходимо фотошаблонов.
2) Определить класс фотошаблона, пользуясь заданными данными.
3) Нарисовать схематически фрагмент изображения каждого фотошаблона (вид сверху) с использованием позитивного фоторезиста.
Решение:
1) 6 операций;
2) В 34;
3) Планарно-эпитаксиальная технология;
4) Конструкция фотошаблона – а.
4.10.01
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.