При обсуждении методов, используемых для формирования тонких окисных пленок, и получаемых при окислении свойств этих пленок необходимо подчеркнуть, что на рост тонких окисных пленок оказывают влияние применяемые методы очистки поверхности и степень чистоты используемых газов. На рис. 38 приведен пример зависимости толщины тонких окисных пленок от времени окисления в сухом кислороде.
|
Ионной имплантацией называют процесс загонки ускоренных электрическим полем ионов примесей в объем основного материала с энергией, достаточной для проникновения в его приповерхностные области. В последнее время ионная имплантация является основным методом формирования слоев при производстве интегральных схем.
Преимущества использования ионного легирования:
1. Универсальность и гибкость метода, можно имплантировать все, что угодно и с любой концентрацией;
2. ИЛ может осуществляться при низких температурах (даже при комнатной), благодаря чему могут быть сохранены электрофизические характеристики кристалла;
3. Возможность автоматизации и точный контроль процесса;
4. ИЛ является чистым и «сухим» процессом, так как проводится в вакууме и может быть совместим с другими технологическими операциями, например, с очисткой поверхности;
5. Малое боковое распространение пучка, то есть слабое проникновение под маску.
К недостаткам ИЛ относятся высокая стоимость оборудования и большое количество радиационных дефектов в образце.
Энергия легирующих ионов бора, фосфора или мышьяка в диапазоне 3…500 кэВ достаточна для их имплантации в приповерхностную область кремниевой подложки на глубину 10…1000 нм. На глубине атомы расположены под любыми поверхностными слоями естественного окисла толщиной до 3 нм, и, следовательно, при внедрении примеси отсутствуют барьерные эффекты, связанные с наличием поверхностных окислов. Глубина залегания имплантированной примеси, которая пропорциональна энергии ионов, может быть выбрана исходя из требований конкретного применения имплантированной структуры.
Основной задачей при моделировании ионного легирования является расчет профиля концентрации примеси в мишени в двух- и трехмерном случае. Формирование профиля концентрации примеси в кремнии при ИЛ происходит благодаря остановке ионов примеси в мишени после их многочисленных хаотических столкновений с атомами кристаллической решетки кремния. Ясно, что наиболее адекватной моделью ИЛ является статистическая модель, учитывающая случайную природу процесса и использующая соответствующий математический аппарат – метод Монте-Карло. Большим недостатком метода Монте-Карло является его трудоемкость.
В большинстве
современных технологических маршрутов ионное легирование представляет собой
первоначальную стадию внедрения примесей, именно на стадии ионного легирования
внедряется исходное количество примеси ![]() в виде
числа ионов на см2 поверхности. Эта величина остается постоянной в
том смысле, что при последующих высокотемпературных обработках она только
перераспределяется между подложкой и растущими на поверхности слоями кремния и
окислов. Величина
в виде
числа ионов на см2 поверхности. Эта величина остается постоянной в
том смысле, что при последующих высокотемпературных обработках она только
перераспределяется между подложкой и растущими на поверхности слоями кремния и
окислов. Величина ![]() легко контролируется по
плотности ионного тока
легко контролируется по
плотности ионного тока ![]() и времени имплантации
и времени имплантации ![]() ,
,  , заряд
электрона
, заряд
электрона ![]() Кл. Обычно используются однозарядные ионы
и, например, доза
Кл. Обычно используются однозарядные ионы
и, например, доза ![]() = 1 мкКл/см2 соответствует
внедрению
= 1 мкКл/см2 соответствует
внедрению ![]() см-2 ионов.
см-2 ионов.
Существенно, что первоначальное распределение ионов в значительной степени аналогично распределению примесей при диффузии и приближенно может быть описано тоже гауссовым законом:

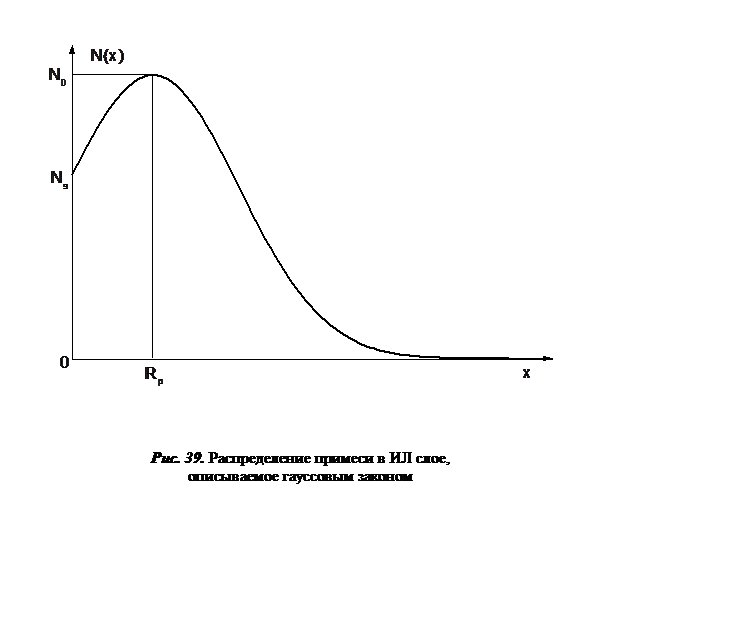 где
где
![]() - проецированный пробег ионов,
- проецированный пробег ионов, ![]() - разброс пробегов.
- разброс пробегов.
Аналогично диффузии общее количество ионов связано с максимальной
концентрацией ![]()
![]() .
Существенно только, что пик
.
Существенно только, что пик ![]() углублен в
кремний на величину
углублен в
кремний на величину ![]() . Термин проецированный
пробег означает статистически усредненное значение проекции пробегов на
направление ионного пучка. Разброс пробегов
. Термин проецированный
пробег означает статистически усредненное значение проекции пробегов на
направление ионного пучка. Разброс пробегов ![]() обычно
составляет величину
обычно
составляет величину ![]() и показывает среднеквадратичное
отклонение
и показывает среднеквадратичное
отклонение ![]() . Коэффициент
пропорциональности между энергией внедряемого иона и величиной
. Коэффициент
пропорциональности между энергией внедряемого иона и величиной ![]() не превышает 0.1 мкм/100 кэВ.
не превышает 0.1 мкм/100 кэВ.
Эксперименты показывают, что число регистрируемых ионов для пиковой концентрации пропорционально дозе имплантированных ионов, а суммарное число регистрируемых ионов также является линейной функцией дозы имплантированных ионов, полученной при одинаковой энергии имплантации.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.