Размеры Sэ опт часто оказываются трудно реализуемыми из-за ограничений в возможностях технологических процессов. Получение линейных размеров (в) элементов по планарной технологии осуществляется с точностью (Dв) равной 5,5 мкм [5]. По этой причине минимальный размер окна в окисле для контакта составляет 12,5´12,5 мкм2, минимальное расстояние от контактного окна до края диффузионной области - 6,25 мкм, рабочие расстояние - 12,5 мкм. Минимальный размер эмиттерной области, следовательно, составляет 25´25 мкм2. При таком размере точность воспроизведения площади эмиттерных областей будет определяться величиной DSЭ/S Э=2Db/b=2*5,5/25=0,44 (44%)
что может явиться причиной значительного разброса в парамет-
рах ИБТ. Компромиссным решением с учетом минимальных разме-
ров и приемлемого разброса параметров проектируемых ИБТ следует считать минимальный рабочий размер эмиттера 25х37,5мкм
[4].Этот размдер является типовым для ИБТ с рабочим током
эмиттера до 10-20 мА (см.рис.1 и 2). Для ИБТ с большим рабо-
чим током площадь эмиттера следует увеличивать за счет удлинения эмиттера и увеличения числа эмиттерных областей (рис.6)
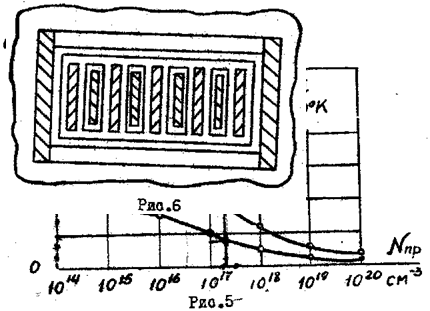 |
Размеры базовой области и области коллектора ИБТ определяются через размер эмиттерной области c учетом числа базовых контактов и конфигурации омического контакта к коллектору. Наиболее распространенные типовые размеры этих областей даны на рис.1 и 2.
Основными электрическими параметрами ИБТ являются [4]:
- зависимость тока эмиттера от напряжения на эмиттер-базовом переходе IЭ (Uэб);
- коэфициент усиления по току в режиме общая база (ОБ) и общий эмиттер (ОЭ) и его зависимость в диапазоне частот, соответственно,
a0, b0, b(f);
- паденае напряжения на коллекторе в режиме насыщения Uкэн
- напряжение пробоя коллектора в режиме ОЭ Uкэ пр .
Характер зависимости IЭ (UЭб) дан на рис.7.
 |
 |
где SЭ - активная площадь перехода эмиттер-база, nб – кон-
центрация электронов в области базы, определяется по формуле
nб=ni/pб (9)
где pб - концентрацыя дырок в области базы, определяемая по графику рис.З и 4; ni - концентрация собственных носителей заряда в полупроводнике при заданной температуре, при Т = 300°К для кремния ni = 1,5*1010 см-3. Для кремния величина ni 2 определяется по формуле
ni 2=2,33*1031T3e-1,31/kT (10)
xарактеристика IЭ (UЭб) имеет явно выраженное напряжение отсечки U0, которое определяет значительную (ощутимую по току) инжекцию электронов в базу. Напряжение отсечки U0 ориен-
 |
где ND и NA –соответственно,концентрации примесей на переходе.
 |
 |
Результаты расчета по данной формуле сведены в табл.1
Таблица 1.
|
UЭБ [В] |
0,60 |
0,65 |
0,70 |
0,75 |
0,80 |
|
IЭ [мА] |
0,013 |
0,10 |
0,69 |
5,09 |
37,6 |
 |
где Rсл.э , Rсл.б - соответственно, сопротивление слоя эмиттерной и базовых областей, эти величины фиксированы типовыми распределениями (рис.3,4) и равны 2,5 Ом/кВ а 200 Ом/кВ;
Lnб -диффузионная длина неосновных электронов в базе, для типовых структур ИБТ Lnб равна 4 мкм.
 |
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.