Ck=1,0+0,83=1,83 пФ,
RквСк=43,0*1,83*10-12=78,6*10-12 c.
Следовательно,
fT =1/2p(1+0,4)(204+81,7+7,1+78,6)10-12=3068106 Гц =306 МГц.
 |
где ai - коэффициент усиления ИБТ в режиме ОБ при инверсном включении, для типовых структур ai приблизительно равно 0,1;
Iк и Iб - соответственно, ток коллектора и ток базы, в режиме насыщения отношение Iк/bIб < 1.
 |
Электрическая прочность ИБТ определяется электрической прочностью рабочих p-n переходов, а также электрической прочностью комбинации переходов. Электрическая прочность p-n перехода оценивается через напряжение пробоя ( Uпр ), которое определяется величиной концентрации примесей в обедненном слое ( Nоб ). Для ступенчатых переходов (n+-p ) обедненный слой развивается, главным образом, в слабо лигируемую область. Поэтому при расчете электрической прочности перехода принимают во внимание концентрацию примесей на переходе со сто-
роны слабо легируемой области. Зависимость Uпрот Nоб для ступенчатого кремниевого перехода дана на рис. 9 [6].
Штриховая линия на рис.9 указывает максимальные концентрации, выше которых преобладающую роль при пробое играет туннельный эффект. Для плавного перехода, который характеризуется градиентом концентрации примесей в обедненном слое ( a ) зависимость Uпр от а дана на рис.10.
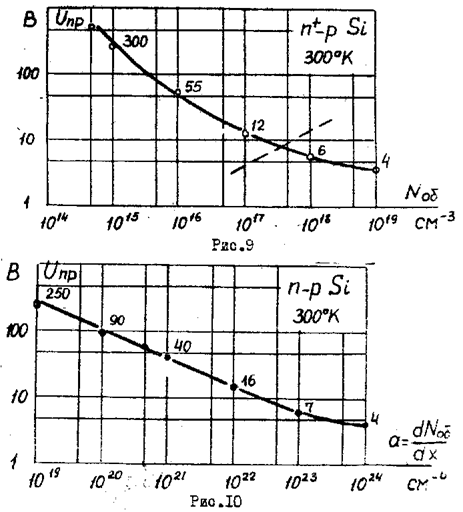 |
Uкэ пр »Uкб пр при Rбэ » 0,
 |
где Uкб пр - пробивное напряжение перехода коллектор-база.
Пример 8. Для ИБТ из примера 6 пробивное напряжение перехода коллектор-база равно Uкб пр= 55 В (из рис.9), так как концентрация примесей в коллекторной области постоянна и равна 1,2*1016 см-3. Пробивное напряжение Uкэ пр при Rбэ ~ ¥равно
Uкб пр »55/3Öb0=14,5 В.
§ 3. Проектирование резисторов интегральной микросхемы.
3-1. Проектирование диффузионных резисторов.
Диффузионные резисторы строятся на конечной проводимости объема полупроводника, ограниченного обедненным слоем. Распределение примесей в объеме резистора в глубь кристалла соответствует распределению примесей в эмиттерной области или базовой области ИБТ, так как диффузионные резисторы изготовляются одновременно с изготовлением ИБТ. Поэтому диффузионные резисторы подразделяются на эмиттерного или базового типа. Размеры для диффузионных резисторов плоскости кристалла определяются размерами диффузионного окна, которые могут быть линейного или зигзагообразного типа. Обычно все диффузионные резисторы данного типа (эмиттерного или базового) объединяются в одну изолирующую область. Для резисторов эмиттерного типа общая изолирующая р - область подключается к самому отрицательному потенциалу в схеме, для резисторов базового типа изолирующая n - область - к самому положительному потенциалу в cxeмe. Конструкция резисторов эмиттерного и базового типа дана на рис.11.
Расчет величины сопротивления диффузионных резисторов линейного типа (рис.12а,б) с учетом влияния растекания тока вблизи контактов осуществляется по формулам
Ra=Rсл(i/b+0,14),
Rб=Rсл(i/b+1,8), (24)
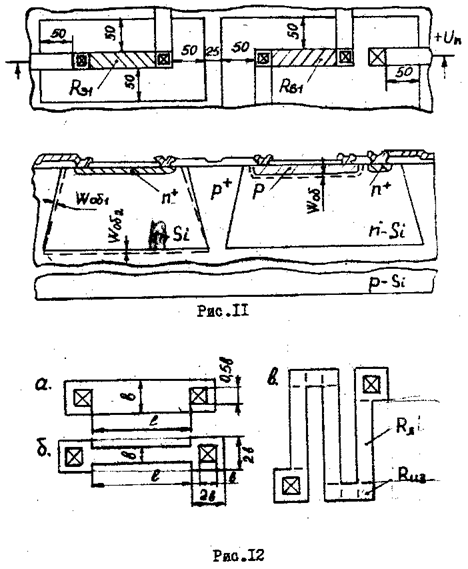 |
 |
Где RАiи Rиз- соответственно, сопротивления линейных участков и сопротивления на изгабе, n и m- соответственно, чсло линейных участков и число изгибов резистора. Проектирование диффузных резисторов осуществляется в следующем порядке: - по заданной величине сопротивления выбираются параметры резисторного слоя (Rсл),
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.