Физические основы термического вакуумного напыления
Требования к процессу нанесения тонких пленок. Элементы тонкопленочных микросхем формируют на основе проводящих, резистивных, полупроводниковых и диэлектрических пленок, толщина которых обычно находится в пределах 10-1 000 нм.
Степень влияния толщины пленки на точность основного параметра для резисторов и конденсаторов определяется выражениями относительных погрешностей сопротивления и емкости:

где δρ - относительная погрешность объемного удельного сопротивления резистивной пленки; δε - относительная погрешность диэлектрической проницаемости диэлектрической пленки; δρ - относительная погрешность толщины пленки; δa и δl - относительные погрешности размеров элемента в плане (рис. 2.1).
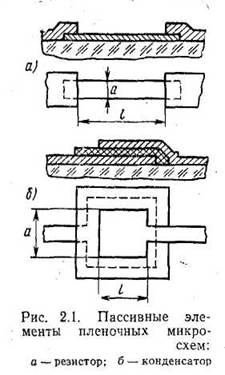
Если предположить, что все четыре фактора имеют равное влияние на основной параметр, то для резистора с точностью по сопротивлению ±10% допустимое отклонение толщины должно равняться ±2,5%, что при толщине пленки порядка сотен атомных слоев. Точность электрофизических параметров ρ и ε определяется чистотой исходных резистивных и диэлектрических материалов, наличием посторонних загрязнений в процессе напыления, а также воспроизводимостью структуры пленки, зависящей от стабильности технологических режимов. Геометрия элементов в плане (размеры о и I) обеспечивается применением масок и слабо зависит от физической природы процесса.
Из сказанного следует, что процесс нанесения тонких пленок должен удовлетворять следующим основным требованиям:
1) исходный материал должен наноситься на подложку диспергированным до атомарного (молекулярного) состояния;
2) содержание в рабочем пространстве посторонних веществ, способных реагировать с наносимым материалом или абсорбироваться в нем, должно быть ничтожно малым;
3) процесс должен быть универсальным, т. е. допускать нанесение различных материалов (от проводящих до диэлектрических) единым по физической сущности методом.
Этим требованиям в достаточной мере удовлетворяет процесс термического вакуумного напыления.
На рис. 2.2 приведена упрощенная схема подколпачного устройства для нанесения тонкой пленки на подложку путем испарения материала в вакууме.

В условиях вакуума материал, помещенный в испаритель 1, (разогревается и испаряется, в результате чего молекулы (атомы) вещества движутся к подложке 2, где они конденсируются, образуя пленку. Процесс осуществляется внутри колпака 3, связанного с непрерывно работающей системой откачки воздуха.
Таким образом, для осуществления процесса необходимо обеспечить следующие основные условия: достаточно интенсивное испарениематериала, направленный молекулярный поток к подложке и конденсацию пара на подложке.
Испарение вещества. Энергия выхода молекулы при нагреве вещества должна быть достаточной для преодоления межмолекулярных связей. В первую очередь поверхность материала покидают наиболее «нагретые» молекулы, т. е. молекулы, обладающие наибольшей энергией. Поэтому испарение имеет место при любой температуре, хотя испарение вещества с понижением температуры значительно уменьшается. Одновременно с испарением происходит и обратный процесс: некоторые молекулы в результате столкновения с другими молекулами пара возвращаются обратно в вещество (конденсируются). При равенстве количества испаряющихся и конденсирующихся в единицу времени молекул наступает термодинамическое равновесие (состояние насыщения). Равновесная плотность пара данного вещества, а следовательно, и его давление psзависят только от температуры: с возрастанием температуры давление пара быстро возрастает (рис.2.3). Связь давления насыщенного пара psс абсолютной температурой Т выражается следующей эмпирической [, зависимостью
![]()
где А и В — постоянные, характеризующие вещество (табл. 2.1).
Температуру вещества, при которой давление насыщенного пара ps=10-2 мм рт. ст., называют условной температурой испарения Тусл. Как видно из табл. 2.1, для некоторых веществ условная температура испарения ниже температуры плавления, т. с. эти вещества достаточно интенсивно испаряются из твердого состояния (возгонка или сублимация).
Скорость испарения, т. е. количество вещества (в граммах), покидающее 1 см2 свободной поверхности вещества в 1 с,
W = C(ps - p) / p0
где р - давление пара над поверхностью вещества; ps - давление насыщенного пара; p0 - давление окружающего газа; С - постоянная, характеризующая род вещества.
Из выражения (2.4) следует, что процесс вакуумного напыления пленок возможен при ps>p, т. е. при неравновесном состоянии пара. Если потребление пара из области, окружающей вещество, отсутствует
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.