Поверхность кремниевых монокристаллнческих пластин окисляют и покрывают светочувствительным фоторезистом. Слой фоторезиста экспонируют через фотошаблон, изменяя при этом его химические свойства. При использовании негативного фоторезиста облученные места теряют растворимость, в то время как в случае позитивного фоторезиста они растворяются в проявляющем растворе. Затем окисленный слой травится в местах, свободных от лака, и фоторезист полностью удаляют. Через вскрытые таким образом окна производят легирование, во время которого доноры или акцепторы из газовой фазы диффундируют в монокристаллическую подложку кремния на определенную глубину в зависимости от температуры и времени процесса, при этом рельеф окисного слоя действует как маска по отношению к легирующему веществу. Последующим окислением окна снова закрываются. Повторяя технологические операции окисления, селективного травления на основе фотолитографии и диффузии, которые в совокупности образуют планарную технологию, можно реализовать различные схемные элементы: диоды, транзисторы, сопротивления и емкости. Далее эти технологические операции рассматриваются более подробно.
Эпитаксия
Как следует из принципов функционирования ИМ, часто требуются разнообразные подложки, состоящие из нескольких гомогенно-легированных слоев с сильно отличающимися удельными сопротивлениями или слоев с различным типом проводимости (р- или n-типа). Выращивание тонких монокристаллических полупроводниковых пленок на монокристаллической подложке называется эпитаксией. Существующие способы эпитаксии приведены на рис. 1. Наибольшее технологическое значение имеет в настоящее время химическая эпитаксия. Высокотемпературная эпитаксия представляет собой термохимический процесс. Кремний получают термическим разложением тетрахлорида кремния в атмосфере водорода при 1150—1250°С
![]()
или восстановлением трихлорсилана
![]() .
.
Одновременно на основе определенных добавок галогенидов легирующих элементов (ВС13, AsCl3, PC13) к газовой смеси, например
![]()
можно получать определенное сопротивление и тип проводимости в выращенных слоях. При высокотемпературной эпитаксии может произойти диффузия примесей из подложки. Но если необходимы эпитаксиальные слои с резким профилем примесей, используют низкотемпературную эпитаксию. Для низкотемпературной эпитаксии применяют двухступенчатый процесс, при котором за очень короткой высокотемпературной фазой (2 мин при 1175°С) следует продолжительная низкотемпературная фаза (45 мин при 1050°С) или пиролиз силана при 9500С
![]() .
.
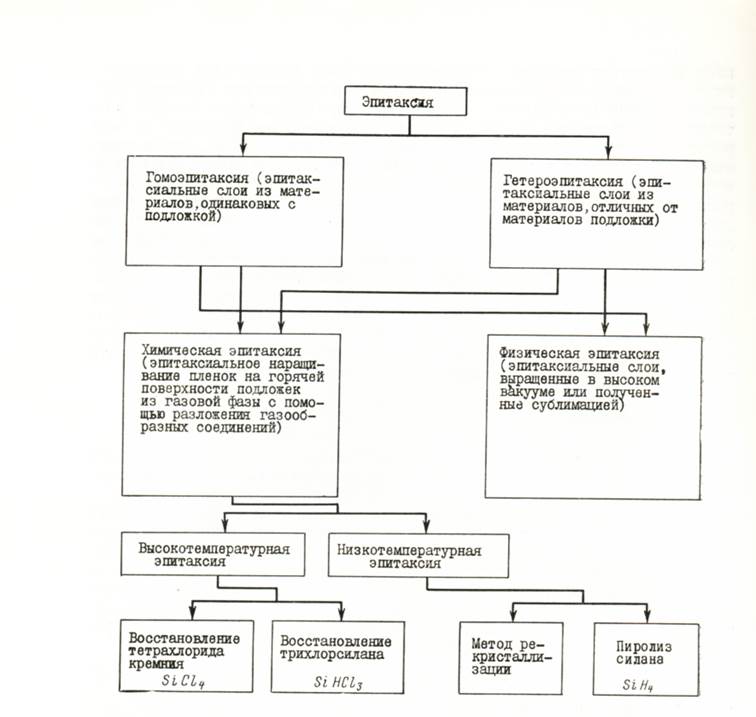
Рис. 1. Методы эпитаксии.
На основе эпитаксии можно выращивать па подложках с очень низким удельным
сопротивлением — около 5 мОм*см слои хотя и той же проводимости, но с высоким удельным
сопротивлением (2—20 Ом*см). Эти слои и
служат, собственно, основой для формирования интегральных элементов. В этом случае говорят о ![]() или
или
![]() +-эпитаксии.
Схема установки для эпитаксиального
наращивания показана на рис. 2.
+-эпитаксии.
Схема установки для эпитаксиального
наращивания показана на рис. 2.

Рис.2. Схема установки для эпитаксиального наращивания пленок кремния:
1 – кран;
2 – измеритель скорости потока; 3 – кварцевая труба; 4 – графитовая подставка4 5 – пластины кремния; 6 – высокочастотный индуктор.
Окисление
Целенаправленное введение атомов примеси в подложку возможно потому, что поверхность кремния покрыта твердой, химически стойкой и температуростабильной окисной пленкой, очень трудно преодолимой при проведении диффузии для атомов примеси (доноров или акцепторов). Эту пленку можно удалить с определенных мест с помощью фотолитографии. Окисные слои, кроме того, обеспечивают пассивацию поверхности изготовленных элементов, а значит, повышение надежности всей интегральной микросхемы, изоляцию внутрисхемных проводников друг от друга и формирование полевого электрода униполярных элементов.
При термическом окислении кремниевые пластины нагревают в кварцевой трубчатой печи приблизительно до температуры 12000С и окисляют в потоке сухого и влажного кислорода (рис.3).
|
|
Рис.3. Принцип термического окисления:
1 – кран; 2 – измеритель скорости потока; 3 – термостат; 4 – кварцевый баллон; 5 – кварцевая труба; 6 – пластины кремния; 7 – печь нагревательная.
 Скорость роста окисной пленки составляет в соответствии с рис. 4 0,2
мкм/ч для сухого и приблизительно 1 мкм/ч для влажного кислорода.
Оптимальная толщина пленки ограничена сверху необходимой
адгезионной прочностью и отсутствием трещин (из-за различия в
температурных коэффициентахлинейного расширения Si и SiO2) и снизу — скоростью, с которой впоследствии при диффузионном процессе атомы примеси проникают в пленку кварца (пленка
Скорость роста окисной пленки составляет в соответствии с рис. 4 0,2
мкм/ч для сухого и приблизительно 1 мкм/ч для влажного кислорода.
Оптимальная толщина пленки ограничена сверху необходимой
адгезионной прочностью и отсутствием трещин (из-за различия в
температурных коэффициентахлинейного расширения Si и SiO2) и снизу — скоростью, с которой впоследствии при диффузионном процессе атомы примеси проникают в пленку кварца (пленка ![]() ).
).
Рис.4. Зависимость роста толщины ![]() окисла
кремния от времени
окисла
кремния от времени ![]() и
температуры
и
температуры
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.