![]()
Расчет топологии интегрального конденсатора
Рассчитаем топологию интегрального диффузионного конденсатора номиналом 300 пФ. Для получения конденсатора с заданным номиналом емкости целесообразно использовать pn-переход база-эмиттер, который обладает следующими параметрами необходимыми при расчете геометрических размеров конденсатора:
· C0 – удельная емкость pn-перехода эмиттер-база (C0=600пФ/мм2);
· Соб – удельная емкость боковых частей pn-перехода эмиттер-база (Соб =1000 пФ/мм2);
· xj – глубина залегания эмиттера (xj =1.5 мкм);
· U – пробивное напряжение перехода ~ 7 В.
На рис. 2 показан разрабатываемый конденсатор в разрезе (перпендикулярно поверхности кристалла):
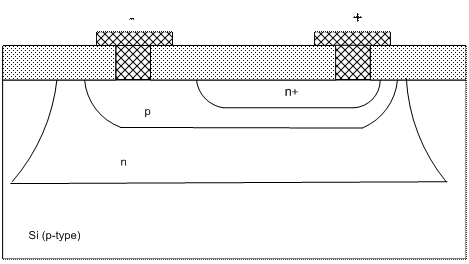
Рис. 5. Диффузионный конденсатор на переходе база-эмиттер.
Емкость диффузионного конденсатора прямоугольной формы на основе обратносмещенного pn-перехода:
![]() , где
a,b и xj – геометрические размеры pn-перехода.
, где
a,b и xj – геометрические размеры pn-перехода.
Примем, что a=b. Данное отношение a/b=1 является наиболее оптимальным, так как при нем доля «боковой» емкости минимальна. Тогда получим квадратное уравнение относительно a.
![]() ,
,
Это уравнение имеет два действительных корня. Причем один из них отрицательный, и не подходит из физических соображений. А положительный корень a=100 мкм. Вычислим напряжение пробоя UBR данного конденсатора (напряжение лавинного пробоя pn-перехода база-эмиттер). Примем концентрацию в базе равной 2*1017 см-3.
 .
.
Расчет топологии интегрального транзистора
Расчет транзисторов и диодов сложен, трудоемок, без применения специального программного обеспечения и точность его невысока. В связи с этим этап расчета конструкции транзисторов и диодов часто опускают, акцентируя внимание на экспериментальном этапе. При этом разработчиком используется банк интегральных транзисторов и диодов с широким спектром их характеристик. При таком подходе перед проектировщиком интегральной схемы стоит задача подбора элементов из банка данных подходящих по своим электрическим характеристикам разрабатываемой схеме.
Сначала необходимо выбрать физическую структуру различных областей транзистора (подложки, базы, эмиттера, коллектора, скрытого слоя и.т.д.). Удельное сопротивление подложки, для обеспечения высокого пробивного напряжения и малой емкости обратносмещенного pn-перехода коллектор-подложка должно быть большим (1÷10 Ом*см). Для разрабатываемой интегральной схемы примем удельное сопротивление равным 5 Ом*см.
Выбор параметров коллекторной области или эпитаксиального слоя сопряжен с поиском компромисса между величиной последовательного сопротивления коллектора, которое уменьшается с увеличением уровня легирования и величиной емкости и пробивного напряжения (для уменьшения емкости и для увеличения напряжения пробоя уровень легирования должен быть низкий). Обычно он выбирается в интервале 1013 см-3 и 5*1014 см-3. Выберем 1014 см-3.
Толщина эпитаксиального слоя варьируется в пределах 2-15 мкм. Она выбирается с учетом глубины залегания коллекторного перехода. В разрабатываемом транзисторе глубина равна xj=4 мкм, поэтому толщину эпитаксиального слоя выберем 4 мкм. Удельное сопротивление эпитаксиального слоя выбирают в пределах 0.1÷0.5 Ом*см. В структурах со скрытым n+ слоем и подлегированием коллекторного контакта последовательное сопротивление коллектора составляет 10÷50 Ом.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.