Диаметр - 330 см
Длина - 2-3 м
Температура процесса - 1420
Скорость - несколько миллиметров в минуту
Отрезают хвостовую затравочную часть. После делают базовой срез. Таким образом делают большую часть ИС.
Недостатки:
- небольшое загрязнение кислородом и материалом тигля.
Чтобы снизить содержание добавок применяется метод безтигельной зонной плавки.
В камере стержень поли кремния закрепляется. Внизу затравка - моно кремния. Индуктор находится первоначально внизу. Начинают подавать нагрев - 1500 - нижняя часть между затравкой и поли кремния начинает расплавляться и происходить образования моно кремния. Продувается вся камера аргоном.
Что нам это дает:
- отсутствие контакта кремния с частями конструкции
- происходит очистка (оттесняет все загрязнения в нижнюю часть)
Таким методом получаем порядка 10% производства моно кремния.
Скорость выращиванию вдвое больше.
Возможно проведение одновременно с выращиванием моно кремния и легирование.
Недостаток:
- радиальная неоднородность распределения удельного сопротивления
Создание структур на этих пластинах:
![]()
![]()
![]()
![]() SiO2
SiO2
![]()
![]()
![]() p-Si
p-Si
n-Si
Эпитаксия процесс наращивания слоев на кремний, при котором кристаллографическая ориентация повторяет ориентацию подложки.

Осаждение кремния - температура процесса - 1200.
Газ носитель - водород.
Сверхтонкие слои не создаются. И не применяется многослойная эпитаксия.
Толщина наращиваемого слоя порядка 10мкм.
SiО2 термическое окисление кремния.

Пленки (0.5-0.8 мкм) - функции защиты микросхемы
Пленки (0.05-0.1) - диэлектрика под затвором МОП транзистора.

Рассмотрим метод диффузии
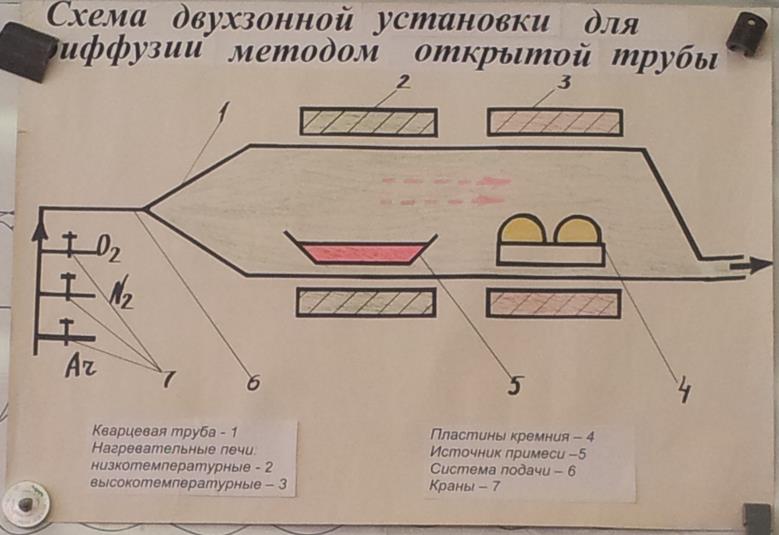
Диффузии могут быть общие и локальные.
Общая - диффузия осуществляется по всей поверхности
Локальная - на отдельных элементах пластины.
Скорость диффузии, концентрация диффузии разная.
Диффузию можно проводить один раз или многократно.
Анизотропное травление использует анизотропию химических свойств кремния. Скорость химической реакции растворения кремния зависти от кристаллографического направления. Минимальная скорость направления (1,1,1) максимальная скорость в направлении (1,0,0).

Литография - процесс создания на поверхности полупроводникового кристалла защитной маски, необходимой для локальной обработки при формировании интегральной структуры ИС по планарной технологии.
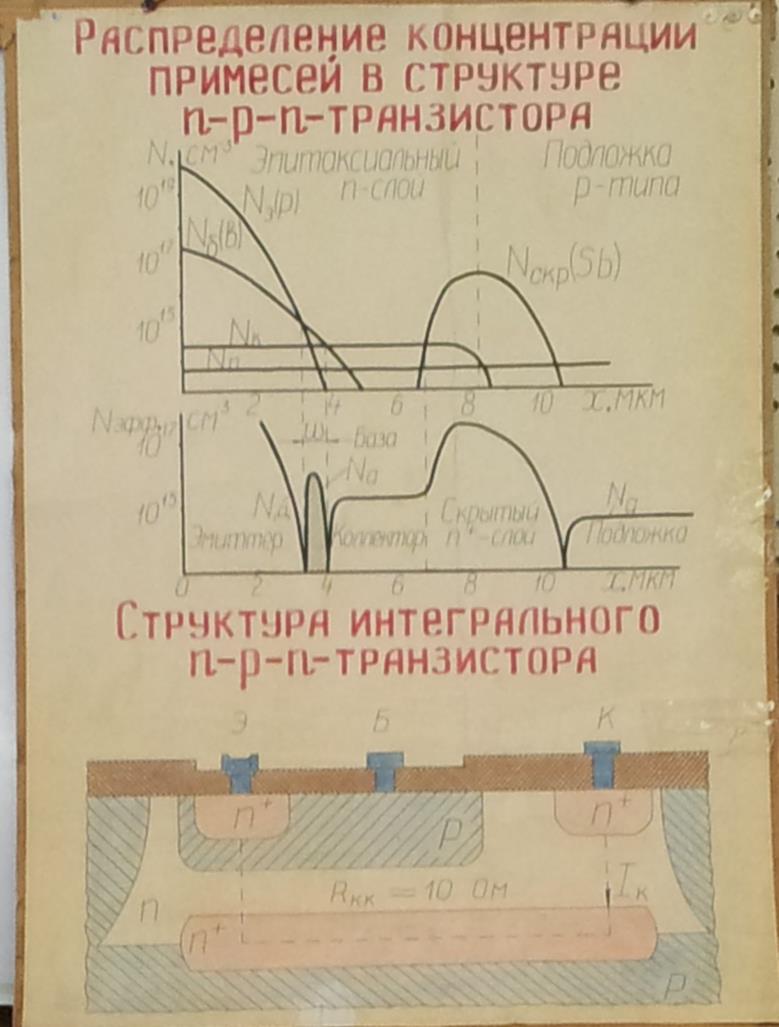
Основным параметром является разрешающая способность, определяемая главным образом длиной волны фотонов, т.е. длиной волны облучения.
Современные литографические процесс
- фотолитография (0.2-0.3 мкм)
- ренгенолитография (0.4-0.5 нм)
- электроннолучевая литография (меньше одной сотой нм)
- ионолитография (меньше одной тысячной нм)
Фотолитография (методичка)
Использование ультрафиолета позволяет получить минимальные размеры интегральных элементов (0.1 мкм), меньше уже сложно, из-за размытия тени от фотошаблона
Возникают проблемы проекционной фотолиграфии:
Аберрация оптической системы, необходимость устранения вибрации все системы, необходимость стабилизации температуры до 0.01 С и проблемы совмещения фотошаблоны при последующих проекциях фотолитографии.
Электронная литография
Используется эффект - движущийся электрон обладает волновыми свойства.
Используют электронные пучки для облучения поверхности пластины
Проекционная и сканирующая.
Проблемы:
Термический нагрев шаблонов
Большие числовые апертуры.
Рентгеновская литография
Дает возможность высокого разрешения.
Используется ренгенорезист.
Ионолучевая литография.
Используется облучение потоков ионов через шаблон.
Проекционная и сканирующая.
Ограничения:
Возникновение определенных искажений (сферическая аберрация, астигматизм)
Радиационные повреждения активных
Низкая производительность.
Высокая стоимость оборудования
Наиболее перспективные рентгенолитография и современная фотолитография.
2.5. Элементы ИС
2.5.1. Методы изоляции ИС

Достоинства:
Токи утечки на 3-5 порядков меньше чем обратные токи p-n-переходов.
Паразитные емкости тоже меньше, на порядок.
Комбинированная изоляция:
Боковые поверхности карманов изолированы диэлектриком а донная область изолирована обратно смещенным p-n-переходом.

Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.