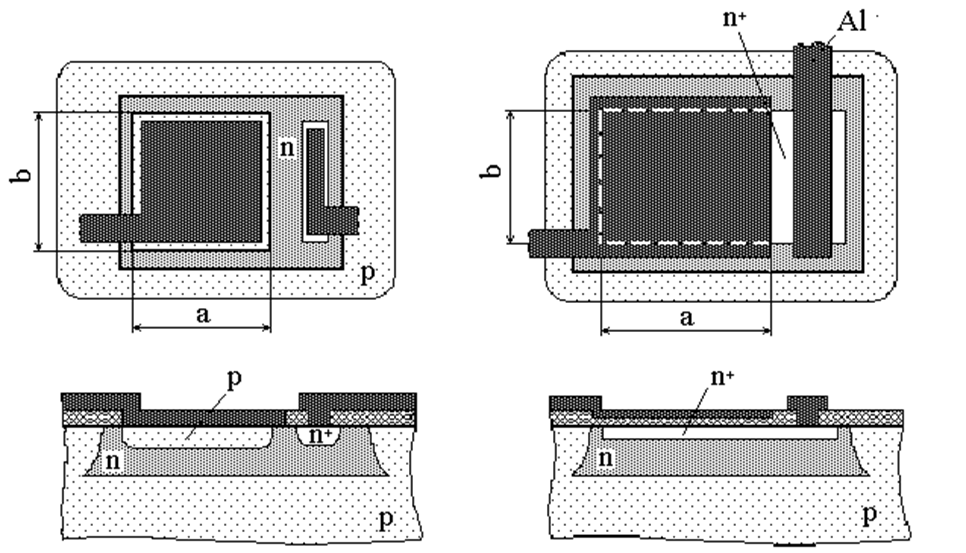 а)
б)
а)
б)
Рис. 14. Топология и структура диффузионного (а) и
МОП - конденсатора (б)
Возможно применение ДК также на основе эмиттерно-базового перехода и перехода “коллектор-подложка”. Основные параметры различных вариантов ДК приведены в табл.4. Достоинством ДК является совместимость их технологии с типовой технологией БТ-ИС. К их недостаткам можно отнести:
— необходимость обеспечения запирающего потенциала на переходе;
— зависимость удельной емкости С0 от напряжения;
— большой расход площади подложки.
МОП-конденсатор принципиально отличен от ДК. Структура МОП-конденсатора приведена на рис.14,б. Роль нижней обкладки выполняет n+‑слой, на котором с помощью дополнительных технологических процессов выращен тонкий (0,08-0,12 мкм) слой SiO2. Верхняя обкладка из алюминия формируется при выполнении металлической разводки.
Основные параметры МОП-конденсатора также приведены в табл.4. Достоинством МОП-конденсатора является то, что он работает при любой полярности напряжения, хотя удельная емкость С0 в некотором интервале напряжений зависит от напряжения. Недостатком МОП-конденсатора является необходимость дополнительных операций, не свойственных БТ-ИС. МОП-конденсатор больше подходит МДП-ИС, с которой он имеет полную технологическую совместимость.
Основные параметры ДК и МОП конденсаторов Таблица 4
|
Тип коденсатора |
С0, nФ мм2 |
СМАКС, nФ |
Разброс номина- лов, % |
Темпера- турный коэффи- циент, % / °С |
Пробив- ное напряже- ние, В |
Добротность на частоте 1 МГц |
|
Переход БК |
150 |
300 |
±20 |
-0,1 |
50 |
50-100 |
|
Переход БЭ |
1000 |
1200 |
±20 |
-0,1 |
7 |
1-20 |
|
Переход КП |
100 |
300 |
±20 |
-0,1 |
50 |
50-100 |
|
МОП-конденсатор |
300 |
500 |
±25 |
0,02 |
20 |
200 |
Максимальная емкость конденсаторов СМАКС ограничивается допустимым расходом (не более 25%) площади подложки под конденсаторы.
1.3.3. Элементы МДП-ИС
В основе МДП-ИС лежит структура МОП-транзистора, названного так из-за использования SiO2 в качестве диэлектрика. На рис.15 приведены типичная топология и структура интегрального МОП-транзистора с индуцированным n-каналом. Сравнивая рис.8 и рис.15, можно отметить следующие особенности МОП-транзистора как элемента ИС.
Во-первых, технология МОП-транзистора проще: она включает только 1 процесс диффузии и 4 процесса фотолитографии против 4 процессов диффузии и 6 процессов фотолитографии для биполярного транзистора. Простота технологии обеспечивает меньший процент брака и меньшую себестоимость МДП-ИС.
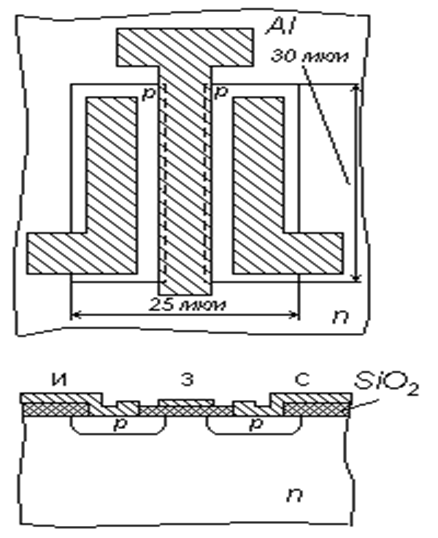
Рис. 15. Топология и структура МОП-транзистора
с индуцированным р-каналом
Во-вторых, как уже было отмечено ранее, для МОП-транзистора не требуются изолированные карманы, что способствует более экономичному использованию площади подложки, т.е. повышению степени интеграции ИС.
В третьих, МОП-транзистор занимает значительно меньшую площадь ( примерно в 5 раз ), что также способствует повышению степени интеграции и снижению стоимости ИС.
Недостатком МОП-транзистора является меньшее быстродействие, обусловленное сильным влиянием паразитных емкостей. Хотя величины этих емкостей относительно малы (около 0,6 пФ), высокие значения входных и выходных сопротивлений затягивают время их перезаряда.
В настоящее время широко применяются ИС на комплементарных МОП-транзисторах ( КМОП-ИС), для реализации которых необходимо изготавливать в одном кристалле транзисторы с n и p -каналом. Существующие методы получения комплементарных МОП структур показаны на рис.16.
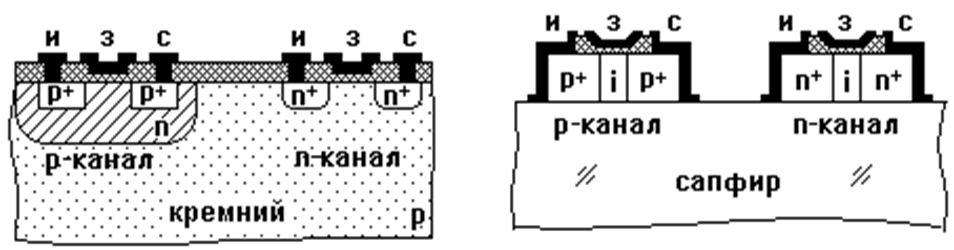
а) б)
Рис. 16. Структуры комплементарных МОП-транзисторов,
использующие изолирующий n-карман (а)
и технологию “кремний на сапфире”
Недостатком обоих методов является увеличение количества технологических операций, приводящее к повышению стоимости ИС. Сущность первого метода очевидна. При втором методе на сапфировой подложке наращивается слой собственного кремния, из которого формируются островки. Далее в части островков формируются области истока и стока транзисторов с n-каналом (диффузия донорных примесей ), а затем на других островках формируются области истока и стока транзисторов с p-каналом ( диффузия акцепторных примесей ).
В качестве резисторов используются МОП-транзисторы, включенные по схеме двухполюсника ( затвор соединен со стоком ). Для повышения потенциала сопротивления у этих транзисторов увеличивают длину канала ( до 40 мкм ) и уменьшают ее ширину.
В качестве конденсаторов используются МОП-конденсаторы, структура которых отличается от приведенной на рис.14,б отсутствием изолирующих карманов. Тонкий окисел SiO2 для конденсатора получается одновременно с изоляцией затвора транзистора, а низкоомный слой полупроводника получается при формировании стока и истока.
1.4. Особенности топологии ИС
Топология ИС определяет геометрию элементов в плане их расположения на подложке. При групповой технологии, характерной для ИС, стоимость изготовления элементов и их монтажа не зависит от числа элементов на пластине (при одинаковой технологии ). В результате стоимость каждой ИС оказывается обратно пропорциональной площади подложки этой ИС, поэтому при разработке топологии стремятся свести площадь подложки к минимуму. Степень реализации этого требования определяют два параметра топологии:
— плотность упаковки элементов ИС ( РУП );
— коэффициент использования площади подложки ( КИСП ).
Указанные параметры определяются следующими соотношениями:
РУП = NЭЛ / SПОДЛ , (5)
NЭЛ
КИСП = å SiЭЛ / SПОДЛ , (6)
i=1
где NЭЛ — общее количество элементов ИС, включая контактные площади;
SПОДЛ — площадь подложки, мм2;
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.