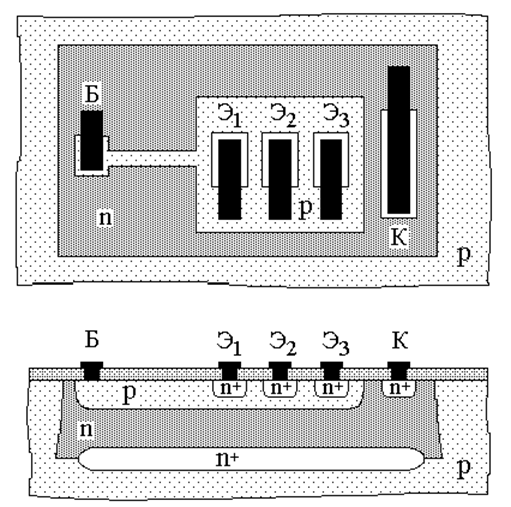
Рис. 9. Топология и структура
многоэмиттерного транзистора
Структура вертикального p-n-p транзистора показана на рис.10. Однако, для реализации такой структуры нужна дополнительная операция формирования области эмиттера p++, что повышает стоимость ИС. В едином технологическом цикле можно изготовить паразитный p-n-p транзистор (рис.11,а) и горизонтальный p-n-p транзистор (рис.11,б).
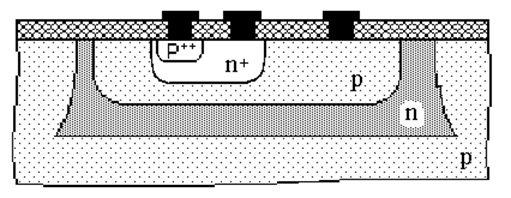
Рис. 10. Вертикальный транзистор
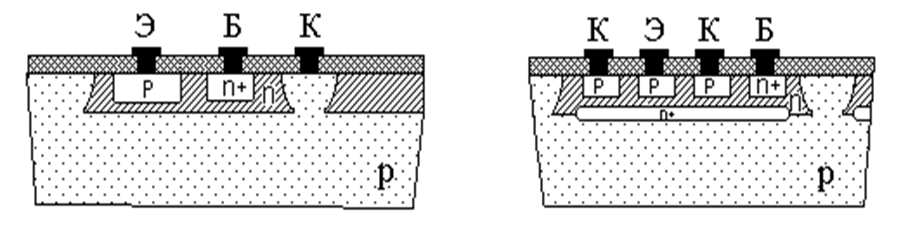
а) б)
Рис. 11. Структура паразитного (а) и горизонтального (б) транзисторов
Паразитные p-n-p транзисторы применялись на ранних этапах развития микроэлектроники. Недостатками их являются отсутствие изоляции коллектора от подложки и низкие значения ¦Т и b.
В горизонтальном p-n-p транзисторе эмиттерная и коллекторная области получаются на этапе формирования базы n-p-n транзистора. Для повышения коэффициента усиления коллекторная область выполнена охватывающей эмиттер со всех сторон. Ширина базы составляет порядка 2 мкм. Поскольку база (эпитаксиальный n-слой) легирована равномерно, то рассматриваемый транзистор является бездрейфовым. В результате граничная частота горизонтального p-n-p транзистора оказывается более чем на порядок меньше, чем у n-p-n транзистора той же ИС, а коэффициент усиления составляет около 5.
В качестве интегрального диода используется транзистор в диодном включении. Возможны 5 вариантов такого включения, при которых в качестве диода используются:
· переход “эмиттер-база “ при разомкнутом переходе “коллектор-база” (обозначается Б-Э);
· переход “коллектор-база” при разомкнутом переходе “эмиттер-база” (обозначается Б-К);
· переход “эмиттер-база” при короткозамкнутом переходе “коллектор-база” (обозначается БЭ-К);
· переход “коллектор-база” при короткозамкнутом переходе “эмиттер-база” (обозначается БК-Э);
· параллельное включение обоих переходов (обозначение Б-ЭК).
Типичные параметры интегральных диодов при различных схемах включения приведены в табл. 2.
Параметры интегральных диодов Таблица 2
|
Параметр |
Схема включения |
||||
|
БК-Э |
Б-Э |
БЭ-К |
Б-К |
Б-ЭК |
|
|
Пробивное напряжение, В |
7-8 |
7-8 |
40-50 |
40-50 |
7-8 |
|
Обратный ток, мкА |
0,5-1 |
0,5-1 |
15-30 |
15-30 |
20-40 |
Сравнивая различные варианты, можно прийти к выводу, что предпочтительны варианты БК-Э и Б-Э, т.к. малые напряжения пробоя не играют в ИС существенной роли.
В качестве резистора в БТ-ИС используются диффузионные и ионно-легированные резисторы. Для диффузионных резисторов (ДР) используются полоски базового или эмиттерного слоя, расположенные в изолированном кармане и имеющие два контакта. На рис.12 приведена структура ДР на базовом слое.
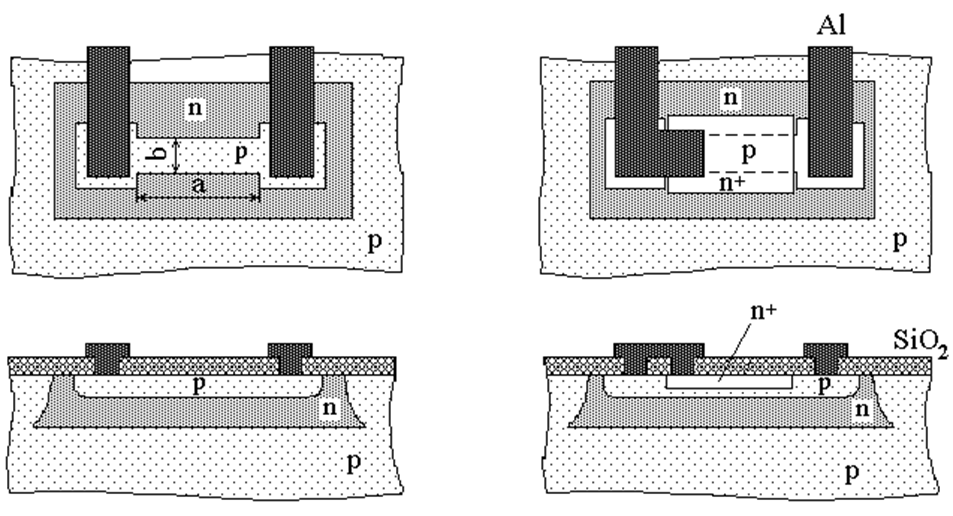
Рис.12. Диффузионный резистор Рис.13. Пинч-резистор
с полосковой конфигурацией
на базовом слое
Сопротивление ДР такой конфигурации записывается в виде:
R = RS × a/b , (3)
где RS — удельное сопротивление слоя, определяемое по формуле (2); a,b — длина и ширина резистора.
Как следует из табл.1, для базового слоя RS = 200 Ом/. Длина резистора ограничивается размером подложки и не превышает 1-5 мм. Минимальная ширина ограничена возможностями фотолитографии, боковой диффузией, допустимым разбросом сопротивления резистора (10-20%) и составляет 10-15 мкм. При этих условиях типичное значение максимального сопротивления составляет 20 кОм. Для увеличения сопротивления применяют зигзагообразную конфигурацию ДР. При количестве петель m £ 3 (ограничиваются площадью, отводимой под ДР) максимальное сопротивление достигает 60 кОм. Дальнейшее увеличение сопротивления можно получить при использовании пинч-резистора (рис.13), в котором в качестве резистивного слоя служит база транзисторной структуры. Ввиду малой толщины и слабого легирования удельное сопротивление этого слоя обычно составляет 2-5 кОм/ , что позволяет получить сопротивление до 300кОм даже при простой (без зигзага) конфигурации. Недостатком пинч-резисторов является большой разброс номиналов ( до 100%) и повышенный температурный коэффициент.
Сопротивления номиналом менее 100 Ом выполняются на основе эмиттерного слоя, который имеет RS=5-15 Ом/ . При этом минимальное сопротивление резистора составляет 3-5 Ом, а его температурный коэффициент примерно в 20 раз меньше температурного коэффициента ДР на основе базового слоя ( из-за высокой степени легирования).
Наилучшими параметрами обладают ионно-легированные резисторы, которые получаются по технологии ионного внедрения. Структура этого резистора аналогична структуре ДР, но глубина внедренного p-слоя значительно меньше (0,2-0,3 мкм), а концентрация примесей в слое практически может быть любой. В результате величина RS может достигать до 10-20 кОм/, что позволяет получить номиналы сопротивления в сотни кОм при минимальных для полупроводниковых резисторов значениях разброса (5-10%).
Основные параметры полупроводниковых резисторов сведены в табл.3.
Параметры полупроводниковых резисторов Таблица 3
|
Тип резистивного слоя |
RS, Ом/ |
Максимальное сопротивление, кОм |
Допуск, % |
Температур- ный коэффи- циент, % / °С |
|
База |
200 |
50-60 |
±(10-20) |
0,15-0,3 |
|
1 |
2 |
3 |
4 |
5 |
|
Эмиттер |
5-15 |
0,1 |
±(10-20) |
0,01-0,02 |
|
Пинч-слой |
2000-5000 |
200-300 |
±100 |
0,3-0,5 |
|
Ионное внедрение |
104 - 2*104 |
±(5-10) |
В качестве конденсаторов в БТ-ИС используются закрытые переходы, которые называют диффузионными конденсаторами (ДК) и МОП-конденсаторами. Типичная структура ДК на коллекторно-базовом переходе показана на рис.14,а. Емкость конденсатора определяется по формуле
C = С0× a b, (4)
где С0 — удельная емкость;
a,b — ширина и длина конденсатора.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.