Лекция 2
Тонкослойные материалы в современных ИМС
2.1. Тонкослойные материалы в ИМС
2.2. Важная особенность тонкослойных материалов для технологии ИМС
2.3. Физико-химические основы ХОГФ
2.4. Химические реакции
2.5. Основные функциональные зависимости ХОГФ
2.6. Проблематика ХОГФ
2.7. Аппаратура для ХОГФ
2.8. Методика осаждения слоев и основные параметры оборудования
2.9. Краткие основы вакуумной техники
2.10. Измерение давления
2.11. Соотношение единиц измерения в вакуумной технике
***
2.1. Тонкослойные материалы в ИМС
Основой современных многоуровневых ИМС являются тонкие слои диэлектрических, полупроводниковых и металлических материалов, используемые для создания конструкционных элементов интегральных микросхем. Они используются для создания изоляции в подложке, изготовления активных и пассивных элементов ИМС. Кроме того, они применяются в качестве вспомогательных материалов для создания элементов ИМС с участием других тонкослойных материалов, а после использования могут удаляться с поверхности подложки.
Схема поперечного сечения транзисторной структуры в условной многоуровневой КМОП ИМС, с проектными нормами менее 0.25 мкм, приведена на рис.2.1. Она иллюстрирует пример местоположения тонкослойных материалов (поликристаллического кремния, диоксида кремния, нитрида кремния, силикатных стекол) в современной микросхеме. Дополнительная расшифровка аббревиатур тонкослойных материалов, общие сведения о методах и условиях получения тонкослойных материалов, об используемых исходных реагентах, дается в табл. 2.1.
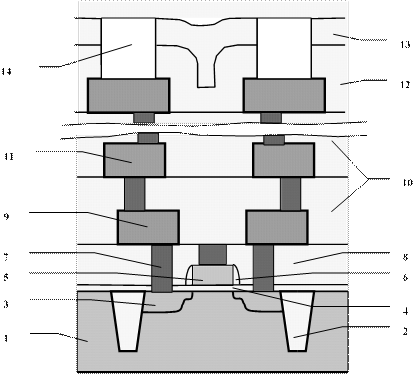 Рис.2.1. Упрощенная
схема поперечного сечения транзисторной структуры металл-оксид-полупроводник в интегральной
микросхеме с изолирующими областями в кремнии и несколькими слоями металлических
проводников (показано не в масштабе).
Рис.2.1. Упрощенная
схема поперечного сечения транзисторной структуры металл-оксид-полупроводник в интегральной
микросхеме с изолирующими областями в кремнии и несколькими слоями металлических
проводников (показано не в масштабе).
Обозначения: 1- подложка кремния; 2изолирующая канавка в кремнии, заполненная диоксидом кремния; 3область стока-истока транзистора; 4- подзатворный термический диоксид кремния; 5-затвор транзистора; 6изолирующая область “спейсер”; 7контакт из вольфрама; 8-слой межуровневого диэлектрика; 9-слой первого уровня алюминия; 10-слой межслойного диэлектрика; 11-слой второго уровня алюминия; 12-слой фосфоросиликатного стекла; 13-слой нитрида кремния; 14-вскрытая область для приваривания проволочного контакта. Примечание: области 10 и 11 могут повторяться неоднократно.
Таблица 2.1
|
№ |
Материал тонкого слоя, температурный диапазон синтеза |
Метод ХОГФ |
Исходные вещества, температура синтеза |
Назначение и обозначение на рис.2.1 |
|
|
1 |
Кремний |
Поликристаллический |
РНД |
SiH4, 620°C |
Затвор транзисторов (5) |
|
Аморфный |
РНД |
SiH4, 550°C |
Затвор транзисторов (5) |
||
|
2 |
Нитрид кремния |
Высокотемпературный |
РНД |
SiH2Cl2 – NH3, 800°C |
Вспомогательный слой – формирование изолирующих областей в кремнии |
|
Низкотемпературный |
ПХО |
SiH4–N2, < 400°C |
Защитное покрытие ИМС (13) |
||
|
3 |
Оксинитрид |
Низкотемпературный |
ПХО |
SiH4-N2O-N2, < 400°C |
Вспомогательный слой - антиотражающее покрытие |
|
4 |
Диоксид кремния |
Высокотемпературный |
РНД |
Si(OC2H5)4-O2, 650-700°C |
Изолирующие области в кремнии (2) и спейсер (6) |
|
Среднетемпературный |
РПД |
Si(OC2H5)4-O3/O2, 550°C |
Изолирующие области в кремнии (2) |
||
|
ПВП |
SiH4-О2, 650°C |
||||
|
Низкотемпературный |
РАД/ РПД |
Si(OC2H5)4-O3/O2,400-440°C |
Изолирующие области в кремнии (2) и межслойная изоляция (10) между слоями металлических проводников |
||
|
ПХО |
Si(OC2H5)4-O2, < 4O0°C |
||||
|
SiH4-N2O, < 400°C |
|||||
|
ПВП |
SiH4-О2, < 400°C |
||||
|
5 |
Легированные оксиды |
Высокотемпературный (БФСС) |
РПД |
Si(OC2H5)4-O2-B(OC2H5)3-PH3, 800°C |
Межуровневая изоляция (8) между затвором и первым слоем металлических проводников |
|
Среднетемпературный (ФСС, БФСС) |
РПД |
Si(OC2H5)4-O3/O2-B(OC2H5)3- -PO(OC2H5)3, 400-550°C |
Межуровневая изоляция (8) |
||
|
ПВП |
SiH4-О2-РН3, 650°C |
||||
|
Низкотемпературный (ФСС) |
ПХО |
SiH4-N2O-РН3, < 400°C |
Защитное покрытие ИМС (12) |
||
|
Si(OC2H5)4-O2-PO(OC2H5)3, 360°C |
|||||
|
6 |
Фторированный оксид |
Низкотемпературный |
ПХО |
Si(OC2H5)4-C2F6-O2, < 400°C |
Межслойная изоляция (10) с пониженной диэлектрической постоянной |
|
Si(OC2H5)4-SiF(OC2H5)3-O2, 300-400°C |
|||||
|
ПВП |
SiH4-SiF4-O2, < 400°C |
||||
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.