Маршрут Сечения
1.  Химическая обработка
Химическая обработка
2. Диффузия Подложка
3. Окисление Термический окисел
4. Фотолитография Исток-сток
Затвор
5. Травление
6. Напыление Финишная пассивация
7. Пассивация
(а) (б)
Рис.1.2. Примеры отображений маршрута изготовления ИМС: а) последовательность процессов, б) представление в виде поперечных сечений приборов.
Маршрут также принято изображать в виде последовательных рисунков поперечного сечения прибора, см. рис.1.2(б). В маршруте принято указывать основные режимы проведения процессов, требования к получаемым параметрам, номера фотошаблонов, типы оборудования и т.д. Маршруты могут быть более или менее сложные, а также полными и ограниченными (решается частная задача). Полные современные маршруты групповой технологии ИМС достигают 300-500 технологических процессов; соответственно возрастает и набор рисунков поперечного сечения ИМС.
1.5. Прогресс ИМС
Гигантский прогресс ИМС за прошедшие годы можно проиллюстрировать рис.1.3, на котором показан внешний вид первой двухтранзисторной ИМС фирмы Fairchild (1961 г.) и микропроцессора Пентиум фирмы Intel (2001 г.).
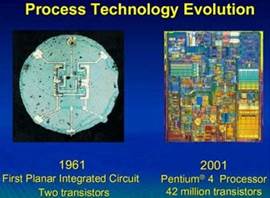
Рис.1.3. Внешний вид первой планарной интегральной микросхемы и микропроцессора Пентиум 4.
На рис.1.4(а,б) в полулогарифмических координатах показана динамика изменения количества транзисторов (степень интеграции) и проектных норм (размеров) транзисторов. Подчеркнем, что изменения происходят по экспоненциальному закону.


(а) (б)
Рис.1.4. Изменения количества транзисторов на кристалле (а) и размера транзисторов (б) от времени.
Обычно для описания происходящих изменений используют т.н. закон Мура, согласно которому удвоение числа транзисторов на кристалле происходит каждые 2 года, рис.1.5.

Рис.1.5. Закон Мура
Движущей силой прогресса ИМС является возрастание быстродействия при уменьшении удельной стоимости приборов, см. рис.1.6.

Рис.1.6. Изменение технических и экономических характеристик ИМС.
1.6. Основные технологические изменения в ходе прогресса ИМС
Основные технологические изменения, позволившие достичь высокой степени интеграции, состоят в новом подходе к технологии изоляции активных структур и к технологии многоуровневой системы металлизации.
Три варианта маршрутов изоляции продемонстрированы на рис.1.7. Изоляцию т.н. “толстым окислом” заменили на изоляцию LOCOS (производное от слов Local Oxidation), что дало возможность уменьшить зазор между транзисторами. Однако, при уменьшении проектных норм до ~0.25 мкм возникла необходимость исключения лишних для технологии боковых, существенно более тонких сторон изоляции, называемых bird beaks. Это было решено разработкой нового варианта изоляции – т.н. изоляции поверхностными канавками - STI (от слов Shallow Trench Isolation).

Увеличение числа транзисторов на кристалле привело к возникновению задачи их надежной коммутации. Соединять все возрастающее количество транзисторов оказалось возможным путем увеличения количества слоев металлизации. Система многоуровневой металлизации, см. рис.1.8, создается методами осаждения из газовой фазы, напыления, фотолитографии, травления.

Рис.1.8. Схема поперечного сечения системы многоуровневой металлизации. (IMD или ИМД – интерметаллический диэлектрик)
Современные интегральные микросхемы, см. схему поперечного сечения транзисторных структур на рис.1.9, фактические изготавливаются по двум субмаршрутам: FEOL и BEOL.
FRONT-END OF LINE (FEOL) включает процессы, которые выполняются в подложке кремния и заканчивается уровнем затворов транзисторов.
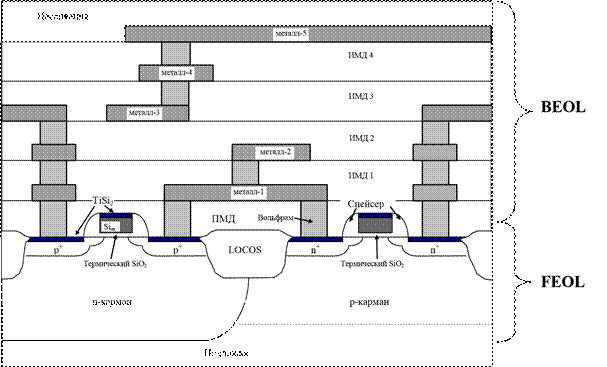
Рис.1.9. Упрощенная схема поперечного сечения ИМС с LOCOS–изоляцией транзисторных структур (ПМД – предметаллический диэлектрик).
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.