Базовую область получают локальной диффузией на глубину 2 – 3 микрона.
Удельное сопротивление базы 100 – 200 Ом/ÿ;
Граница базы является одновременно границей коллекторного p – n перехода и определяет его площадь.
Эмиттер – глубина залегания 1,5 – 2 микрона;
Удельное сопротивление 2 – 3 Ом/ÿ.
К подложке на периферийной части кристалла создается омический контакт, на который подается напряжение, чтобы обеспечить изолированный p – n переход. Так как обратный ток изолированного p – n перехода маленький, то изоляция будет достаточной.
Достоинство: Простота в технологии.
Недостатки: 1) обратный ток перехода при повышении температуры может увеличиваться, кроме того, этот p – n переход несет в себе барьерную емкость. Если барьерная емкость увеличивается, то будет увеличиваться и задержка переключения.
1) Большая занимаемая площадь.
Так как ширина защитного слоя должна быть больше удвоенной толщины эпитаксиального слоя – это условие связано с изотропностью процесса диффузии.
Комбинированный способ изоляции
1. Первый этап
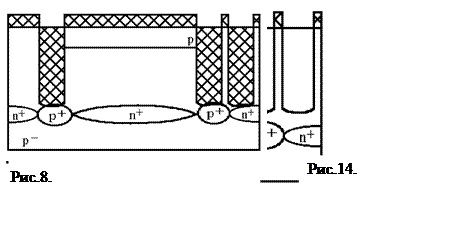 |
2. Второй этап.
–– Производится наращивание эпитаксиального слоя n – типа 1 –3 микрона, затем поверхность покрывается слоем нитрида кремния, затем с помощью фотолитографии формируют защитную маску, затем проводят травление на глубину 0,5 эпитаксиального слоя. Далее ионным легированием в области 1 вводят примесь р+ .
–– Производится селективное окисления кремния таким образом, чтобы нижняя граница окисла проходила до n+ и до р+ .
–– Получаются карманы изолированные толстым слоем диоксида кремния с боковых сторон и с другой стороны n+ - p+ переходом.
–– С помощью ионного легирования делается слой базы р – типа.
–– Боковые границы базового слоя совмещаются с границами SiO2, слой SiO является маской для базы, таким образом, получают самосовмещающуюся базу.
–– Легированием фосфора создается эмиттер и приколлекторный контакт.

Достоинства:
1) При одинаковой площади эмиттерного перехода, общая площадь транзистора гораздо меньше, чем при обычной планарной структуре;
2) Использование тонкого эпитаксиального слоя приводит к уменьшению площади изолирующих областей;
3) Пассивные области базы и коллектора не используют подконтакты (все боковые стенки граничат с SiO2).
Назначение р+ – областей: на границе SiO2 существует неподвижный положительный заряд, под влиянием этого заряда дырки отталкиваются вглубь подложки, а электроны из n+ поступает к границам раздела, а т.к. концентрация подложки низкая, то у поверхности может образоваться инверсный слой канала n – типа замкнет все коллекторные области других транзисторов.
Такие транзисторы имеют лучшие импульсные, частотные характеристики, за счет уменьшения площади уменьшается барьерная емкость.
Другой вариант: Полипланарный транзистор

Основной недостаток изопланарного транзистора – это длительное окисление.
Для сокращения времени травления уменьшают толщину эпитаксиального слоя соответственно база – эмиттера.
Изопланар практически получается при эпитаксиальном слое 3 –4 микрона.
1) Проводится сквозное травление;
2) Окисление;
3) Заполнение поликристаллическим кремнием канавок.
Эпитаксиальный процесс или диэлектрическая изоляция
1) Исходная пластина;
 |
2) С помощью фотолитографии вытравливаются канавки;
 |
3) Переворачивается и в карманах производят формирующую структуру.
 |
Нанесение проводящих материалов на полупроводник
1) Вся поверхность окисляется – SiO2;
2) Вытравливаются контактные отверстия;
3) Наносится проводящая пленка на всю поверхность кристалла;
4) Производят травление через маску для формирования рисунка соединений.
Требования к материалу пленки
1) Должна обеспечивать омический контакт с кремнием;
2) Иметь низкое удельное сопротивление, хорошую адгезию к кремнию и к SiO2; без разрушения выдавать высокую плотность тока, механическая прочность;
3) Не подвергаться воздействиям высоких температур, не подвергаться коррозии, не образовывать химических соединений.
Пример:
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.