В області 2 середня енергія фононів соизмерима з енергією іонізації домішок, але ще значно менше ніж ширина забороненої зони. При температурі Тмакс майже всі донори іонізовані, а концентрація власних електронів ni незначна. Повне число вільних електронів тут приблизно постійне, а їх концентрація рівна концентрації донорів n» NД. Таким чином, в областях 1 і 2 переважають домішкові, основні носії.
В області 3 високих температур енергія фононів збільшується настільки, що концентрація власних носіїв стає більше концентрації донорів (ni > NД ). Тут справедливе співвідношення ni=A exp[-DEз /2kT)]. Тому залежність концентрації від (1/T) в напівлогарифмічному масштабі зображається прямою лінією з кутом нахилу b, тангенс якого пропорційний ширині забороненої зони.
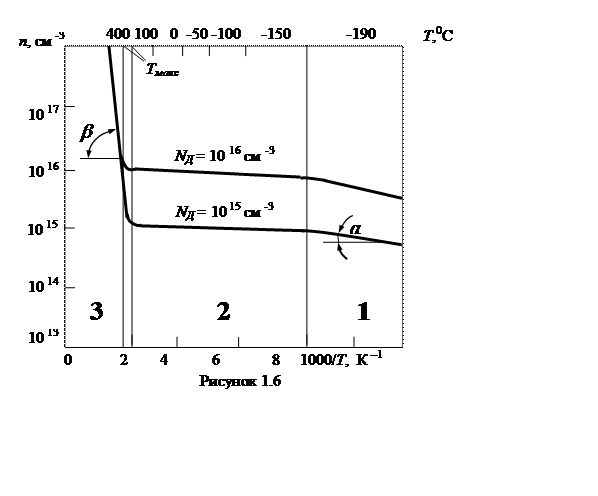 |
Таким чином, робочий температурний діапазон домішкових напівпровідників обмежений знизу температурою повної іонізації домішок, а зверху - критичною температурою, при якій домішковий напівпровідник перетворився на власний. В робочому діапазоні можна вважати всі домішкові атоми повністю іонізованими і нехтувати власною концентрацією ni, поклавши концентрації основних носіїв заряду рівними концентраціям домішкових атомів:
nn = NД ; p = NА . (1.4)
Температуру Тмакс, відповідну верхній межі області 2, можна приблизно визначити з умови ni =Nд і графіків, приведених на малюнку. Максимальна температура пропорційна ширині забороненої зони і збільшується із зростанням концентрації домішок. Залежність Тмакс від концентрації домішок приведена на малюнку . Якнайменше значення Тмакс має германій, оскільки у нього ширина забороненої зони менше ніж у кремнію і арсеніду галію. Так, верхня температурна межа для германію складає 75-850 З, а для кремнію 150-1700 З. Нижня температурна межа роботи напівпровідникових приладів складає від - 55 до - 600С.
1.4 Дрейфове і дифузійне рухи носіїв заряду
У відсутність електричного поля в кристалі і однаковій концентрації носіїв заряду в об'ємі напівпровідника електрони і дірки знаходяться в безперервному тепловому (хаотичному) русі, розподіленому по всіх напрямах. Зважаючи на хаотичний характер руху носіїв заряду струм в кристалі рівний нулю.
Електричне поле і нерівномірність розподілу концентрацій носіїв заряду є чинниками, що створюють впорядкований рух носіїв заряду, тобто обуславливающими електричний струм в кристалі напівпровідника.
Направлений рух носіїв заряду під впливом електричного поля називають дрейфом (дрейфовим рухом), а під впливом різниці концентрацій носіїв заряду - дифузією (дифузійний рух).
Залежно від характеру руху носіїв заряду розрізняють відповідно дрейфовий і дифузійний струми в напівпровідниках, а залежно від типу носіїв заряду - електронні і дірчасті складові цих струмів.
Переміщення носіїв заряду в кристалі під впливом електричного поля (дрейфовий рух) відбувається при безперервному їх зіткненні з вузлами кристалічних грат і атомами домішки. Носії заряду переміщаються в кристалі з деякою середньою швидкістю, пропорційній напруженості електричного поля:
![]() Vср n = -mn·E
, Vср p = mp·E
. (1.5)
Vср n = -mn·E
, Vср p = mp·E
. (1.5)
Коефіцієнт пропорційності називають рухливістю електронів (mn) і дірок (mp). Електрони переміщаються у напрямі дії поля. Рух дірок, обумовлюваний заміщенням валентними електронами дефектів ковалентных зв'язків атомів в гратах, є більш скрутним, ніж вільних електронів. Тому при однаковій напруженості електричного поля середня швидкість електронів вище, ніж дірок, і mn > mp .
Для германію mn = 0,38 м2 /(В·с), mp = 0,18 м2 /(В·с).
Для кремнію mn = 0,13 м2 /(В·с), mp = 0,05 м2 /(В·с).
Густина дрейфових складових струму в кристалі визначається величиною заряду, переносимого через одиничний перетин в одиницю часу:
J др n = -qnmnE, J др p = -qpmpE , (1.6)
де n і p - концентрація електронів і дірок в об'ємі напівпровідника;
q - заряд електрона.
Сумарна густина струму, що протікає через напівпровідник під дією електричного поля :
J др= J др n + J др p = qpmpE+ qnmnE. (1.7)
В чистих напівпровідниках n = p, але mn приблизно удвічі вище mp . З цієї причини в чистих напівпровідниках електронна складова густини струму в те ж число раз більше дірчастої. В домішкових же напівпровідниках концентрації n і p розрізняються на декілька порядків, у зв'язку з чим в електронному напівпровіднику дрейфовий струм обуславливается переважно електронами, а в дірчастому - дірками.
З формули виходить, що густина струму напівпровідників залежить від концентрації носіїв заряду і їх рухливості. Рухливість носіїв заряду зменшується із зростанням температури. Це пояснюється підвищенням інтенсивності теплових коливань атомів в кристалічних гратах і збільшенням вірогідності зіткнень з ними електронів і дірок. В чистих напівпровідниках, не дивлячись на зниження рухливості носіїв, густина струму і провідність збільшуються із зростанням температури унаслідок підвищення концентрації носіїв заряду. В домішкових напівпровідниках в робочому діапазоні температур концентрація носіїв заряду мало змінюється, оскільки її визначає головним чином концентрація основних носіїв заряду, створена домішкою (всі атоми домішки іонізовані). У зв'язку з цим густина струму і провідність тут із зростанням температури дещо зменшуються унаслідок зменшення рухливості ( m ? Т -3/2 ). Зважаючи на меншу рухливість носіїв заряду питомий опір кремнію більше, ніж германію.
Дифузійний рух носіїв заряду виникає, коли є відмінність в концентрації електронів (дірок) в сусідніх шарах напівпровідника. Носії заряду переміщаються з шару з більшою концентрацією в шар з меншою концентрацією. Якщо в даному шарі постійно підтримується більш висока концентрація носіїв заряду, ніж в сусідньому з ним шарі, то створюється безперервний дифузійний потік носіїв заряду у напрямі убування концентрації.
Густина потоків носіїв заряду пропорційна градієнту їх концентрації; при одновимірній дифузії (коли концентрація уздовж осі x падає: dn/dx < 0 або dp/dx < 0 ) їх знаходять із співвідношень (1.7) :
Jдиф n = qDn·dn/dx , Jдиф p = qDp·dp/dx , (1.7)
де Dn і Dp - коефіцієнт дифузії електронів і дірок;
dn/dx і dp/dx - градієнт концентрації електронів і дірок.
Коефіцієнт дифузії пов'язаний з рухливістю носіїв заряду співвідношенням Ейнштейна :
D = φT ·m , (1.8)
де цT = kT/q - тепловий потенціал;
Т - абсолютна температура (при Т= 300 До цT=0, 025 В).
В кремнії при кімнатній температурі Dn ? 0,0032 м2 / с,Dp ? 0,0012 м2 /с. Залежність цT і m від температури обумовлює і температурну залежність коефіцієнта дифузії ( D ? Т -1/2 ) .
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.