Для МДП-транзистора с индуцированным каналом проводящий слой находится в непосредственной близости от поверхности, поэтому подвижность носителей заряда определяется поверхностной концентрацией примеси.
Удельная крутизна ![]() характеризует
коэффициент усиления транзистора в режиме малого сигнала и зависит от размера
канала транзистора.
характеризует
коэффициент усиления транзистора в режиме малого сигнала и зависит от размера
канала транзистора.
 ;
;  ;
;
Сg - удельная емкость затвора;
 ;
;
 – напряжение плоских зон;
– напряжение плоских зон;
 – контактная разность потенциалов;
– контактная разность потенциалов;
 – потенциала инверсии;
– потенциала инверсии;
![]() – заряд акцепторов;
– заряд акцепторов;
Напряжение на затворе, при котором наступает инверсная проводимость на поверхности подложки, называется пороговым напряжением. Это условие выполняется, когда изгиб зон на поверхности достигает значения потенциала инверсии φi.
Ns – концентрация фиксированных в окисле зарядов;
Nag – концентрация акцепторов в затворе;
Na – концентрация акцепторов в подложке;
 ;
;
![]() для Si;
для Si;
![]() – Ширина ОПЗ в подложке;
– Ширина ОПЗ в подложке;
В высокоомных подложках заряд ОПЗ ионов примеси Q существенно не сказывается на работе прибора. Однако изменение напряжения на подложке приводит к его увеличению и влиянию Q на концентрацию подвижных носителей заряда в канале. Кроме того, с увеличением напряжения подложка-исток изменяется пороговое напряжение за счёт третьего слагаемого. Поэтому для низкоомных подложек вводят коэффициент влияния подложки:
 – удельная емкость
подложки;
– удельная емкость
подложки;
 – коэффициент влияния
подложки;
– коэффициент влияния
подложки;
Моделирование статической ВАХ
Крутая область ВАХ, когда Ud меньше напряжения насыщения Uds:
 ;
;
 – напряжение насыщения;
– напряжение насыщения;
Напряжение в пологой области ВАХ:
 ;
;
Параметры МДП-транзистора:
|
Вариант |
Затвор |
Подложка |
Исток-сток |
Канал |
|||||||
|
Тип |
Толщ. диэл. |
Фикс. заряд |
Конц. Примеси |
Тип |
Конц. Примеси |
Конц. на поверхн. |
Глубина залеган. истока |
Подвиж-ность |
Длинна |
Ширина |
|
|
d, А |
Ns, см-2 |
Nз, см-3 |
Ng, см-3 |
Nb, см-3 |
X, мкм |
m, |
L, мкм |
B, мкм |
|||
|
5 |
SiПК |
500 |
|
|
p |
|
|
0.2 |
800 |
3 |
20 |
Обозначение |
Значение |
Единица измерения |
Физический смысл |
|
k |
1.38*10-23 |
Дж/К |
Постоянная Больцмана |
|
T |
290 |
К |
Температура материала |
|
q |
1.6*10-19 |
Кл |
Заряд электрона |
|
e0 |
8.85*10-14 |
Ф/cм |
Электрическая постоянная |
|
e0X |
3.8 |
- |
Относительная диэлектрическая проницаемость SiO2 |
|
eS |
12 |
- |
Относительная диэлектрическая проницаемость Si |
|
DEg |
1.12 |
ЭВ |
Ширина запрещенной зоны у Si |
|
gS |
4.15 |
ЭВ |
Электронное сродство для Si |
|
cg |
4.1 |
ЭВ |
Работа выхода из алюминия |
|
ni |
1.4*1010 |
См-3 |
Собственная концентрация электронов в Si |
Operation factors for MOS-transistor
![]()
![]()
![]()
![]()
![]()
![]() -acceptor
density in gate (cm^(-3))
-acceptor
density in gate (cm^(-3))
![]()
![]() -acceptor density (cm^(-3))
-acceptor density (cm^(-3))
![]()
![]() -impurity density on surface (cm^(-3))
-impurity density on surface (cm^(-3))
![]() -occurrence depth of sourse (cm)
-occurrence depth of sourse (cm)
![]()
![]() -carrier mobility
-carrier mobility
![]()
![]()
![]()
![]()
Physicals constants:
![]() -Planck
constant
-Planck
constant
![]()
![]()
![]()
![]() -ambient temperature (K)
-ambient temperature (K)
![]() -charge of
electron (Kl)
-charge of
electron (Kl)
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]() -band-gap energy Si (eV)
-band-gap energy Si (eV)
![]() -proper
electrons concentration in Si (cm^(-3))
-proper
electrons concentration in Si (cm^(-3))
![]() -electron affinity (eV)
-electron affinity (eV)
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]() Напр_плоских_зон(В)
Напр_плоских_зон(В)
![]()
![]()
![]()
![]()
![]() Заряд_акцепторов_в_ОПЗ(Кл)
Заряд_акцепторов_в_ОПЗ(Кл)
![]()
![]()
![]()
![]()
![]()
![]()
![]()

![]()
![]()
![]()
![]() Удельная_ёмкость_подложки(Кл*см^2)
Удельная_ёмкость_подложки(Кл*см^2)
![]()
![]()
![]()
Построение статистических ВАХ
![]()
![]()
![]()
![]()

![]()


![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()
![]()


![]()
![]()
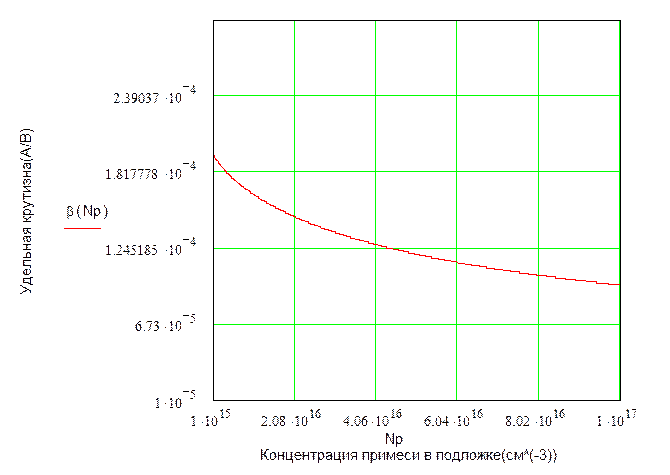
![]()
![]()

![]()

![]()
![]()
![]()
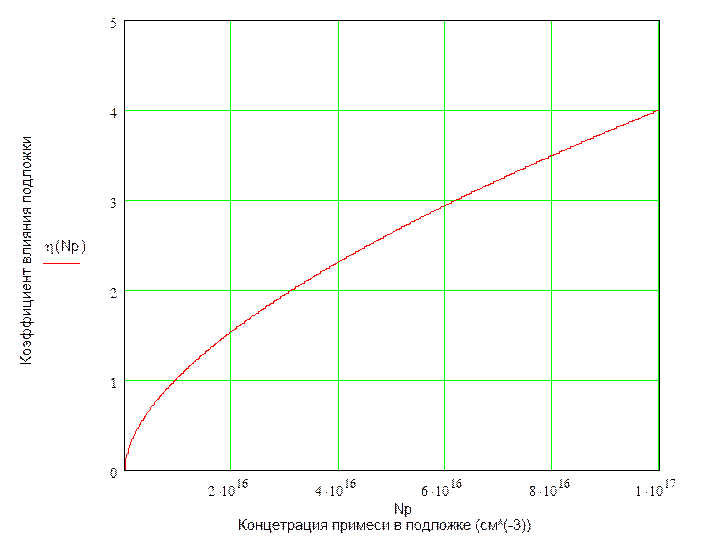
![]()
![]()
![]()
![]()
![]()
![]()
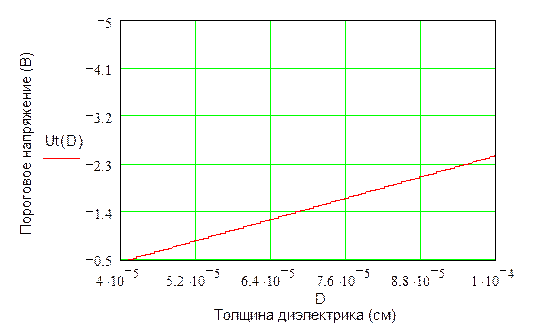
![]()
![]()
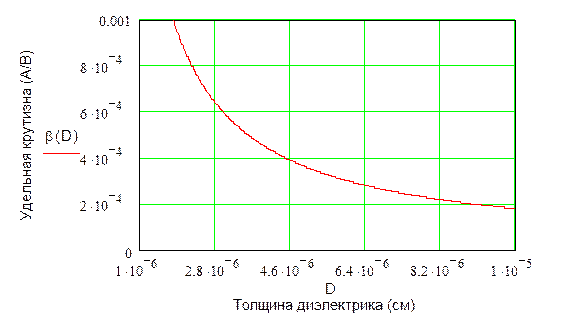
![]()

![]()
![]()
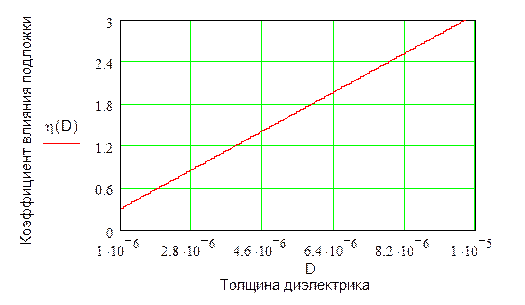
Список литературы.
1. Н.М.Тугов, Б.А.Глебов, Н.А.Чарыков «Полупроводниковые приборы» М.:Энергоатомиздат, 1990.
2. Макаров Е.А. Каменская А.В. Физика полупроводниковых приборов. Методическое пособие по курсовому проектированию. - Новосибирск: НГТУ, 2000.
3. Зи С.М. Физика полупроводниковых приборов. - М.: Мир, т1-2,1984.
4. Макаров Е.А. Физика полупроводниковых приборов и компонентов интегралъных схем. - Новосибирск: НЭТИ, 1983.
5. Макаров Е.А., Кочетов Ю.А. Физика полупроводниковых приборов. Проектирование элементов интегральных МДП схем. Методические указания по курсовому проектированию. - Новосибирск: НГТУ, 1993.
6. Куликовский А. А. Справочник по элементам радиоэлектронных устройств. - М.: Энергия, 1977.
7. Степаненко И.П. Основы теории транзисторов и транзисторных схем. - М.: Энергия, 1973
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.