Термодинамические характеристики указанных веществ дают основание считать, что в условиях роста Р, Аs, В и Sb остаются на поверхности в моноатомном состоянии. Тогда механизм процессов легирования эпитаксиального слоя протекает следующим образом: легирующее соединение через газовую фазу переносится к поверхности, где оно полностью восстанавливается и выделяет легирующий элемент в моноатомном состоянии; часть атомов легирующего элемента захватывается растущим слоем и легирует его, а часть остается в газовой фазе вблизи поверхности растущего слоя, находясь в равновесии со своим твердым раствором. В равновесном состоянии должно выполняться условие, согласно которому поток легирующих атомов (в составе хлоридов), направленный к поверхности должен быть равен сумме потоков свободных атомов, уходящих от поверхности, и легирующих атомов, входящих в растущий слой.
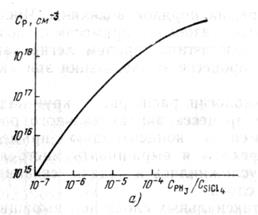 |
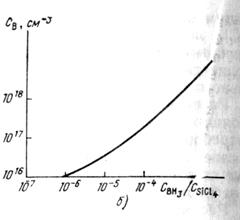 |
||
Рис 1.6. Зависимость концентрации фосфора (а) и бора (б) в эпитаксиальной пленке от относительной концентрации фосфина и диборана
Легирование эпитаксиальных слоев можно проводить с использованием не только жидких и газообразных хлоридов бора и фосфора, но и газообразных гидридов этих элементов (РН3, АsН3, SbН3, В2Н6), которые отличаются большой летучестью и потому позволяют быстрее менять концентрацию легируюших примесей в газовом потоке. На рис. 1.6 показаны зависимости концентраций фосфора и бора в эпитаксиальных слоях, выращенных хлоридным методом, от концентраций фосфина РН3 и диборана В2Н6 в газовой фазе. Эти гидриды ядовиты, и применять их надо с осторожностью. Чтобы обращение с ними было безопасным, их используют в виде сильно разбавленных смесей с водородом. Такие смеси транспортируют в специальных баллонах.
1.4. ВАКУУМНАЯ ТЕХНОЛОГИЯ ВЫРАЩИВАНИЯ ЭПИТАКСИАЛЬНЫХ ПЛЕНОК
Процесс получения эпитаксиальных пленок методом конденсации на подложке разреженных паров веществ впервые основательно изучили советские ученые Г.. А. Куров, С. А. Семилетов, 3. Г. Пинскер еще в 1953–1957 г. Первоначально этот метод был назван вакуумной эпитаксией, а впоследствии – молекулярно-лучевой эпитаксией (МЛЭ).
Эпитаксиальный рост пленок в глубоком вакууме отличается от обычного термовакуумного напыления тем, что осаждение пленки ведется в сверхвысоком вакууме (133-10-10... 133*10-11 Па) на чрезвычайно чистую монокристаллическую подложку, температура которой поддерживается сравнительно невысокой (на 300... 500 °С ниже, чем при химических методах осаждения). Кремний испаряется из жидкой или твердой фазы и конденсируется на нагретую до заданной температуры монокристаллическую подложку. Атомы кремния вследствие высокой температуры подложки диффундируют по ее поверхности и встраиваются в места решетки, обладающие минимумом свободной энергии, образуя эпитаксиальный слой.
Для обеспечения чистоты рабочего пространства системы источник и подложка нагреваются электронным лучом или токами ВЧ. Кроме того, подложки окружаются системой специальных экранов, предохраняющих их от загрязнений в подготовительный период работы установки.
Низкая температура роста пленок при МЛЭ дает возможность избежать их загрязнения за счет диффузии примесей из подложек. Малая и легко управляемая скорость роста способствует формированию чистых и очень тонких пленок (до долей микрометра) строго заданного состава. Легирование осуществляется испарением примеси из отдельного испарителя.
Технология МЛЭ ничем не отличается от термовакуумного осаждения пленок
Подготовка подложек к эпитаксиальному росту — крайне ответственный процесс. Для химической очистки и травления подложек используются особо чистые травители. Окончательная очистка производится в специальных камерах установок МЛЭ методами ионно-плазменного и термического травления. Последний применяется для удаления газов, адсорбированных на поверхности подложек.
Концентрация примесей на поверхности подложек не должна превышать 1011 ат/см2 (0,01%). Для создания атомно-гладкой поверхности подложки отжигаются при высоких температурах (1300°С для Si, 500 °С для GаАs).
Список использованной литературы:
1. "Технология производства интегральных микросхем и микропроцессоров" В.Н. Черняев, "Радио и связь", 1987 г.
2. "Технология микросхем" О.Д. Парфенов, "Высшая школа", 1986 г.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.