Для химического анализа поверхностей и пленок используется ряд методов, в которых предпочитают рентгеновские и ионные пучки, а не электроны. Коллимированный пучок рентгеновских лучей при одинаковых с электронами энергиях проникает в вещество значительно глубже и, следовательно, дает больше информации о составе материала на больших глубинах. Длина волны рентгеновского излучения соответствует параметрам кристаллической решетки вещества, поэтому работает как дифракционная решётка. Изучая отраженный или прошедший сквоз материал пучок, мы можем судить о строении вещества. Кроме того, рентгеновские лучи выбивают электроны, которые несут информацию о состоянии химических связей атомов, а измерение энергетического спектра эмиттированных с поверхности электронов позволяет осуществлять химический анализ приповерхностной области образца.
В ионно-рассеивающей спектроскопии твердых поверхностей применяются ионные пучки низких энергий (0,1– 1 кэВ) относительно большой интенсивности, сфокусированные в пятно малого диаметра на исследуемую поверхность и перемещаемые по ней с помощью ионно-оптической системы, в! большинстве случаев используются ион инертных газов.
Метод упругого обратного рассеяния легких ионов с большой энергией (например гелия при 1-3 МэВ), называемый резерфордовской спектроскопией обратного рассеяния, используется для изучения дефектов кристаллической решетки после имплантации и отжига, распределения примесных атомов в кристалле и исследования поверхностей и тонких пленок.
В методе вторичной ионной масс спектрометрии анализируются массы распыленных первичным ионным пучком вторичных ионов. Для этой цели обычно используются квадрупольные масс-спектрометры разрешением порядка 1 а. е. м. Изображения поверхностных неоднородностей могут получаться путем проецирования или растрового сканирования. Первичный ионный пучок используется также для удаления поверхностных слоев при исследовании профилей концентрации по глубине с шагом порядка 5 нм. Вторично-ионные масс-спектрометры могут работать как в качестве ионного микрозонда, так и для формирования реального изображения поверхности. Они позволяют наблюдать все химические элементы, включая водород, исследовать отдельные изотопы элемента, их номера и время жизни. По чувствительности этот метод превосходит оже-электронную спектроскопию и электронный зондовый микроанализ.
Для исследования работы активных полупроводниковых приборов применяется лазерное сканирование, с помощью которого строятся карты коэффициентов усиления транзисторов, распределения температур на поверхности приборов, внутренних логических состояний интегральных микросхем и т.п. Для этого используются лазеры с длиной волны видимого света (0,633 мкм) и инфракрасного излучения (1,15 мкм).
Таким образом, в качестве инструмента для измерений, контроля и исследований электронные, ионные, оптические и рентгеновские лучи позволяют определять геометрические размеры вплоть до размеров отдельных атомов (0,1– 0,3 нм), выявлять химический состав вещества с погрешностью до 10-4 % как на поверхности образца, так и по всей его толщине и проверять качество функционирования готовых приборов.
Минимальные размеры lmin элементов, обрабатываемых с помощью атомных частиц и излучений (рис. 1.3), могут уменьшаться до тех пор, пока не начнут проявляться ограничения, связанные с физическими принципами работы электронных приборов или принципиальной возможностью получения требуемых размеров и допусков. Для микроэлектроники, например, ограничения планарной технологии связаны с возможностью нанесения слоев с заданной толщиной и свойствами, а также, формирования в этих слоях рисунка с заданными допусками.
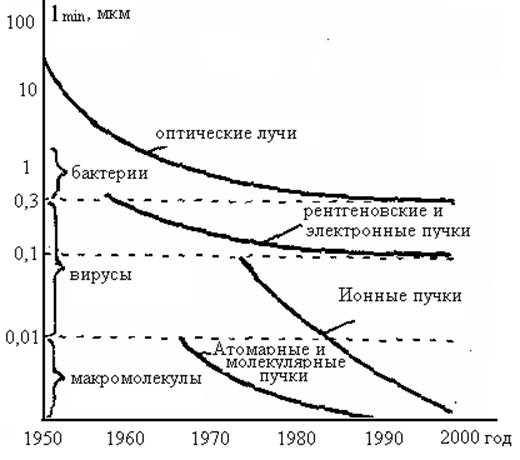
Рис. 1.3. Тенденции уменьшения минимальных размеров lmin, получаемых при обработке изделий
Получению элементов изделий электронной техники с размерами 10 - 25 нм препятствуют явления, связанные с фундаментальными свойствами материалов и включающие эффекты электромиграции и пробоя диэлектриков, изменения удельного сопротивления, рассеяния мощности, тепловых, механических и других характеристик. Для предотвращения их последствий, свойственных микромиру, осуществляют поиск новых физических эффектов как для создания микроструктур новых типов, так и для разработки новых технологических методов.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.