Из описанной модели формирования барьера можно сформулировать следующие выводы:
- увеличение плотности состояний в середине щели подвижности приводит к сужению ОПЗ и изменению j(х), утоньшению барьера в приконтактной области и, как следствие, понижению эффективной высоты барьера, изменению суперпозиции токов, протекающих через барьер;
- барьер формируется за время tS » tM ≤ 10-3 с, т.е. для измерения вольтфарадных характеристик частота тест сигнала должна быть соизмерима или меньше tM-1;
- на контакте Me-a-Si:H формируется барьер типа Шоттки, хотя классическая теория барьеров Шоттки не допускает формирования слоя Шоттки в собственном полупроводнике.
Таким образом, данная модель может быть применима для описания формирования барьера между металлом и некристаллическим полупроводником, имеющим высокую плотность глубоких состояний и низкую подвижность носителей.
Для получения распределения пространственного заряда r(x), профиля электростатического потенциала j(x) и напряженности электрического поля F(x) в ОПЗ на контакте Me/a-Si:H решается уравнение Пуассона с учетом особенностей электронного строения и электрофизических свойств a-Si:H.
Уравнение Пуассона устанавливает взаимосвязь между плотностью объемного заряда r(x) и ходом электростатического потенциала r(x) в ОПЗ полупроводника:
 ,
(69)
,
(69)
где для простоты в промежуточных расчетах координата x отсчитывается от внутренней границы ОПЗ.
Для его решения сформулируем следующие граничные условия:
1 *. Расстояние в запирающем слое на границе Me/a-Si:H отсчитывается от поверхности в глубь полупроводника (рис. 24), однако в промежуточных расчетах для простоты координата отсчитывается от внутренней границы ОПЗ [39].
2 *. Функция Ферми для электронов имеет вид [33]:
 ,
,
где EF0 – глубина залегания уровня Ферми в объеме a-Si:H; ej(x) – изгиб зоны на расстоянии x от границы Me/a-Si:H; kT – тепловая энергия, эВ.
3 *. При отсутствии внешнего электрического поля на внутренней границе ОПЗ значения электростатического потенциала j и внутреннего электрического поля F равны нулю; на границе Me/a-Si:H – j0 и F0 соответственно.

Рис. 24. Зонная диаграмма контакта Me/a-Si:H. j0 – изгиб зон в ОПЗ полупроводника, W – толщина ОПЗ
В зависимости от расстояния в запирающем слое r(x) определяется разностью подвижного (электронов) и неподвижного (ионизированных донороподобных состояний, локализованных в щели подвижности) зарядов:
![]() ,
(70)
,
(70)
или - в зависимости от электростатического потенциала:
![]() ,
(71)
,
(71)
где e – заряд электрона, Nd+(x) или Nd+(j) – концентрация ионизированных донороподобных состояний в зависимости от расстояния или электростатического потенциала в запирающем слое, n(x) или n(j) – концентрация электронов.
Для определения Nd+(j) используются модель Коэна-Фрицше-Овшинского распределения плотности состояний (ПС) в щели подвижности a-Si:H и экспоненциальная аппроксимация распределения ПС (рис. 4, а):
 ,
(72)
,
(72)
где gF0 – плотность состояний вблизи уровня Ферми, b - параметр аппроксимации распределения ПС. Переходим в формуле (72) от интегрирования по энергии к интегрированию по потенциалу:
![]() .
(73)
.
(73)
Тогда формулу (72) с учетом (73) переписываем в следующем виде:
 .
(74)
.
(74)
Концентрация свободных электронов в ОПЗ:
 .
(75)
.
(75)
Тогда формулу (71) с учетом (74) и (75) можно записать следующим образом:
 .
(76)
.
(76)
Рассмотрим область пространственного заряда при сильном изгибе зон, т.е. считаем, что ej >> kT. При этом exp(bej) >> 1; exp(-ej/kT) ® 0. При таком допущении уравнение (76) переписываем в следующем виде:
 .
(77)
.
(77)
Тогда уравнение Пуассона (69) можно записать так:
 .
(78)
.
(78)
Данное дифференциальное уравнение решаем методом разделения переменных с учетом граничных условий (1*, 3*). Зависимость электростатического потенциала от расстояния в ОПЗ выражается следующей формулой:
 ,
(79)
,
(79)
где длина экранирования LD, в отличие от кристаллов (27), определяется иначе [40]:
 .
(80)
.
(80)
Полученные результаты значительно отличаются от данных, полученных для кристаллических полупроводников (20), а также от аналогичных расчетов, полученных в работах В.В. Ильченко и В.И. Стрихи [41]. Данные результаты отличаются более высокой точностью. Во-первых, "опорной точкой" аппроксимации плотности электрически активных состояний является ее значение на уровне Ферми, а не на хвостах зон, как в [41]. Во-вторых, в выражении (79) переменные носят однозначный физический смысл и характеризуют свойства материала. И, в-третьих, теоретически рассчитанные зависимости находятся в хорошем согласии с экспериментальными данными (рис. 25 и 26) и удачно вписываются в теорию формирования барьеров на неупорядоченных полупроводниках [24].
Анализ (79) показывает, что ход потенциала в ОПЗ определяется значением ПС вблизи уровня Ферми gF0 и параметром аппроксимации b, характеризующим распределение ПС в щели подвижности [42]. Рассчитанный ход потенциала оказывается более "крутым" по сравнению с кристаллическим барьером (рис. 26), т.е распределение электрического поля F(x) = dj/dx отличается от линейного закона и достигает больших абсолютных значений [43]:
 .
(81)
.
(81)
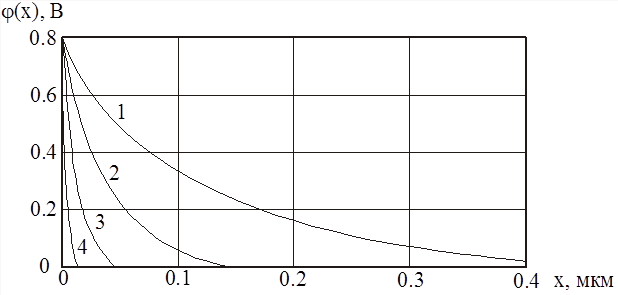
Рис. 25. Ход электростатического потенциала в ОПЗ в зависимости от параметров полупроводника: 1 – gF0 = 1016 см-3эВ-1, b = 5.76 эВ-1, W = 0.52 мкм; 2 – gF0 = 1017 см-3эВ-1, b = 5.18 эВ-1, W = 0164 мкм; 3 – gF0 = 1018 см-3эВ-1, b = 4.32 эВ-1, W = 0.049 мкм; 4 – gF0 = 1019 см-3эВ-1, b = 2.88 эВ-1, W = 00.14 мкм
Если известна высота потенциального барьера j0 на границе Me/a-Si:H, то можно рассчитать толщину ОПЗ при отсутствии внешнего смещения [39]:
 .
(82)
.
(82)
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.