В планарной технологии традиционно процесс диффузии проводят в две стадии, когда на первой, более короткой, осуществляют диффузию из бесконечного источника либо другим способом формируют сильно легированный поверхностный слой, а на второй стадии, более высокотемпературной, проводят отжиг структуры для перераспределения примеси в заданном объеме. В такой традиционной ситуации D2t2>>D1t1 и тонкий слой, созданный на первой стадии, можно считать ограниченным источником примеси. При этом количество атомов примеси, введенное на первой стадии, останется неизменным и
 .
.
С учетом (4.9)
 .
(4.10)
.
(4.10)
В случае, когда условие D2t2>>D1t1 не выполняется, нельзя считать, что на второй стадии осуществляется диффузия из ограниченного источника, тогда
 ,
(4.11)
,
(4.11)
где
 ,
,  .
.
После проведения второй стадии поверхностная концентрация определится как
 .
(4.12)
.
(4.12)
Глубина залегания p-nперехода будет соответствовать условию С(х,t) = СB, т.е.
 .
.
Таким образом, если известна величина xj, для момента времени t1, то для диффузии на глубину xj' потребуется время t2,
 . (4.13)
. (4.13)
Если учесть, что для большинства структур величина СВ в 103 – 105 раз ниже поверхностной концентрации, можно с точностью до 10 % оценить глубину залегания p-nперехода по приближенной формуле
![]() .
.
Практическая часть
1. Задание. Выбрать легирующую примесь и состав ПГС для процесса эпитаксии. Рассчитать «расползание» скрытого слоя во время процесса эпитаксии.
1. Выбор метода эпитаксии.
· Наиболее удобным для реализации процесса является хлоридный метод эпитаксии;
2. Выбор легирующей примеси.
· Основная цель — изменить тип проводимости и концентрацию носителей в объёме полупроводника для получения заданных свойств (проводимости, получения требуемой плавности p-n-перехода). Самыми распространёнными легирующими примесями для кремния являются фосфор и мышьяк (позволяют получить n-тип проводимости).
· В качестве легирующей примеси выбираем мышьяк.
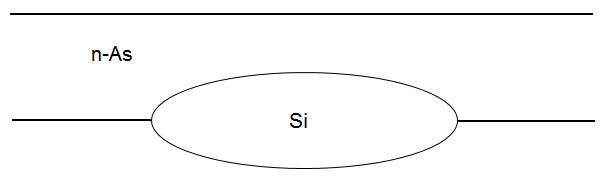
Рис.1 графическое представление желаемого результата
3. Выбор пгс
В качестве исходных реагентов первой реакции используются тетрахлорид кремния (SiCl4), трихлорсилан (SiHCl3), дихлорсилан (SiH2Cl2) и т. п., но наиболее часто—тетрахлорид кремния SiCl4.
4.
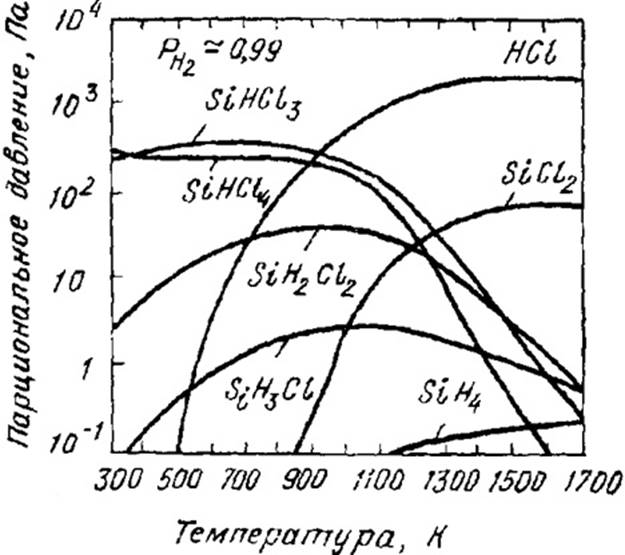 Рис. 1. Температурная зависимость равновесного парциального
давления соединений, образующихся в газовой фазе при давлении в 1 атм и
отношении Сl/Н=0,01
Рис. 1. Температурная зависимость равновесного парциального
давления соединений, образующихся в газовой фазе при давлении в 1 атм и
отношении Сl/Н=0,01
Согласно положениям о химическом равновесии, при избытке водорода первая реакция идет с образованием кремния, а при подаче в систему соляной кислоты НСl можно осуществить газовое травление кремниевой подложки. Поясним это более подробно. Как уже говорилось, первая реакция является обобщающей. В действительности в системе протекают, как минимум, следующие реакции: SiCl4+H2↔SiHCl3+HCl, SiHCl3+H2↔SiH2Cl2+HCl, SiH2Cl2 ↔SiCl2 +H2 SiHCl3↔SiCl2+HCl, SiCl2+H2↔Si+2HCl,
На рис. 1 показана зависимость состава смеси от температуры для обычно используемого в технологии отношения концентрации хлора к концентрации водорода, равном 0,01. Сразу же сделаем ряд выводов из вышесказанного.
Подходящая ПГС – SiH4 или SiH2Cl2
4. Рассчитать «расползание» скрытого слоя во время процесса эпитаксии.
Известные параметры:
Толщина слоя – s – 3 мкм
Скорость роста эпитаксиальноего слоя – v - примерно 0.1 мкм/мин
Температура процесса = 1200 с
Константы, полученные исходя из заданных параметров
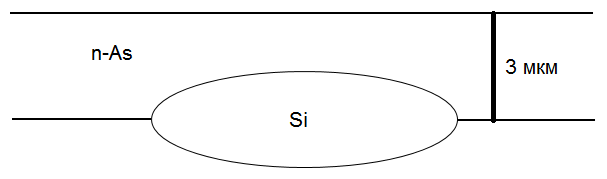
Рис. Схематичное изображения результата проведенного процесса. X - «расползание» скрытого слоя во время процесса эпитаксии
Расчет времени процесса:
T = время = s/v = 3/0.1 = 30 минут
Расчет диффузии
Для As
в Si: коэффициент диффузии ![]() ,
энергия активации
,
энергия активации ![]()
При Т = 1200 С°:
![]()
Расчет расползания слоя.
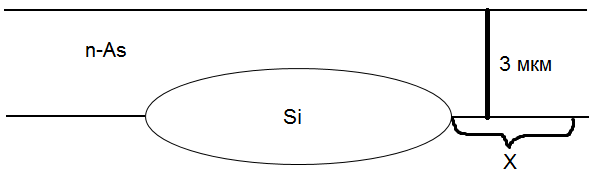
Рис. Схематичное изображения результата проведенного процесса. X - «расползание» скрытого слоя во время процесса эпитаксии
![]() - формула для расчета расползания слоя
- формула для расчета расползания слоя
![]() =
103.1 нм
=
103.1 нм
Ответ: ![]() 103.1
нм
103.1
нм
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.