7.11. Элементы ИС на полупроводниках группы A111BV
Полупроводники группы A111BV как материалы для ИС.
Сравнительный анализ свойств полупроводников группы A111BV и кремния позволяет выявить три основных различия при создании на их основе активных элементов ИС:
1. Сильно отличаются зависимости дрейфовой скорости электронов проводимости, особенно при низких полях.
2. Из полупроводников группы A111BV легко изготовить полуизолирующую подложку.
3. Эти полупроводники (арсенид галлия, фосфид индия, арсенид индия и др.) образуют твердые растворы не только двух-, но и трех- и четырехкомпонентные с широким диапазоном изменения их электрофизических свойств.
|
|
На рис. 7.46 приведена зависимость дрейфовой скорости электронов проводимости от напряженности электрического поля для двух- и трехкомпонентных полупроводников AI11BV и кремния. Причиной того, что зависимость скорости дрейфа электронов проводимости от поля в GaAs и InP имеет не монотонный, как у кремния, а экстремальный характер, кроется в различии зонной структуры этих материалов. Зонная структура GaAs приведена на рис. 7.47.
Абсолютный минимум зоны проводимости GaAs находится в т. Г. Во втором минимуме в т. X энергия на 0,36 эВ выше. Эффективная масса электронов проводимости в т. Г мала (0,068m, где т - масса покоя свободных электронов в вакууме) и поэтому дрейфовая подвижность электронов проводимости велика.
Как видно из рис. 7.47, в т. X имеет место второй минимум энергии. Однако здесь эффективная масса электронов значительно выше (1,2 т), и дрейфовая скорость электронов проводимости уменьшается. Этим объясняется участок с отрицательной дифференциальной проводимостью на рис. 7.46. Этот эффект получил название эффекта Ганна и используется для генерации высокочастотных сигналов. В ИС на GaAs этот эффект нежелателен и для его подавления необходимо выполнить условие ΔE/EГ > 1. Здесь ΔЕ — энергетический зазор между т. Г и т. X, а ЕГ — ширина запрещенной зоны в т. Г зоны проводимости.
Элементы ИС на полупроводниках группы A111Bv. Элементы ИС на A111BV можно грубо разделить на следующие группы: полевые транзисторы с затвором Шоттки, гетеробиполярные транзисторы и МДП-транзисторы.
Несмотря на то, что технологию изготовления материалов AI11BV и приборов на их основе по целому ряду причин нельзя считать столь же отработанной, как для кремниевых структур, исследования и разработки уже продемонстрировали возможности создания сверхбыстродействующих цифровых схем, конкурирующих с кремниевыми. Можно предположить, что главную роль в конкурентной борьбе будут играть полевые транзисторы с затвором Шоттки, т.к. они просты в изготовлении и потребляют незначительную энергию.
Структура и принцип работы полевого транзистора с затвором Шоттки (ЗШП-транзистора). Структура GaAs—ЗШП-транзистора изображена на рис. 7.48, а.
|
|
На полуизолирующей пластине GaAs с высоким удельным сопротивлением (порядка 108 Ом·см) формируют тонкий электропроводный слой n-типа, который называют активным слоем. В активном слое расположены области истока, затвора и стока. Для получения хороших омических контактов на активном слое под электродами истока и стока располагаются n+-области. Электрод затвора образует с активным слоем контакт Шоттки (см. раздел 3.3). Активный слой обычно формируется ионной имплантацией, например кремния. Толщина этого слоя 0,1-0,3 мкм, а концентрация примеси около 3·1017 см-3. Чем короче длина затвора, тем выше быстродействие прибора, в настоящее время длина затвора составляет 0,2-1,0 мкм. Омические электроды изготавливают из сплава Al-Ge-Ni, а электрод затвора — из А1 или силицида вольфрама.
Если к стоку приложить положительное напряжение, а к затвору отрицательное, обедненный слой под затвором расширится, а канал между истоком и стоком сузится и ток в цепи от истока к стоку изменится. Поскольку выходной сигнал стока можно регулировать малым входным сигналом затвора, такой прибор можно использовать как усилительный элемент. На рис. 7.48, б приведены статические характеристики такого прибора.
Длина канала в ЗШП-транзисторах является важнейшим параметром, определяющим быстродействие элемента. При использовании технологии самосовмещенной ионной имплантации при образовании слоев п+-типа оказывается возможным управлять величиной зазора между ними, что обеспечивает снижение последовательного сопротивления исток-сток и позволяет формировать затворы длиной около 0,1 мкм.
![]()
![]()
![]() Транзисторы с
высокой подвижностью электронов. Известны различные варианты конструкции
транзисторов с высокой подвижностью электронов (ВПЭТ). Общее представление о структуре ВПЭТ
с одним гетеропереходом дает рис. 7.49. Исток, сток и затворный
электрод формируются на поверхности GaAs. Повышение подвижности электронов в
канале достигается за счет использования гетероперехода GaAs с материалом
с большой шириной запрещенной
зоны (Al0,3 Ga0,7 As)
с введенной в него донорной примесью.
Транзисторы с
высокой подвижностью электронов. Известны различные варианты конструкции
транзисторов с высокой подвижностью электронов (ВПЭТ). Общее представление о структуре ВПЭТ
с одним гетеропереходом дает рис. 7.49. Исток, сток и затворный
электрод формируются на поверхности GaAs. Повышение подвижности электронов в
канале достигается за счет использования гетероперехода GaAs с материалом
с большой шириной запрещенной
зоны (Al0,3 Ga0,7 As)
с введенной в него донорной примесью.
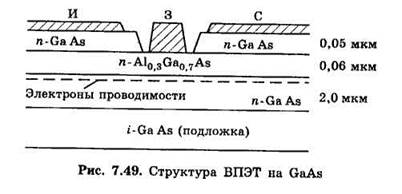
Создание такой структуры возможно методами либо высоко-контролируемого эпитаксиального наращивания слоев A111BV, либо методами молекулярно-лучевой эпитаксии. При реализации таких приборов удается достигнуть значений подвижности электронов до 105 см2/В • с при 77 К и до 2 • 105 см2/В • с при 4,2 К. Для сравнения отметим, что в обычных ЗШП-транзисторах подвижность электронов в слоях n-типа GaAs составляет всего 5 • 103 см2/В • с, т.е. меньше на два порядка.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.