Установка может работать как на эмульсионных фотопластинках, так и на фоторезисте. Экспонирование фоторезистивной заготовки фотошаблона позволяет получить более высокую точность координат границ элементов топологии, что объясняется отсутствием размытости края рисунка у фоторезиста в отличие от фотоэмульсии, где размытость края может составлять от долей до единиц микрона.

Рис. 8.11. Схема генератора изображений : 1 - лампа-вспышка; 2 - конденсорная система линз; 3 - щелевая наборная диафрагма; 4, 5, 6 - электродвигатели управления соответственно шириной, длиной щели и углом поворота щелевой диафрагмы; 7 - объектив; 8, 9 - интерферометрические датчики перемещений координатного стола по осям х и у; 10 - координатный стол; 11 - сервоэлектродвигатели перемещения координатного стола; 12 - программное устройство; 13 - ЭВМ.
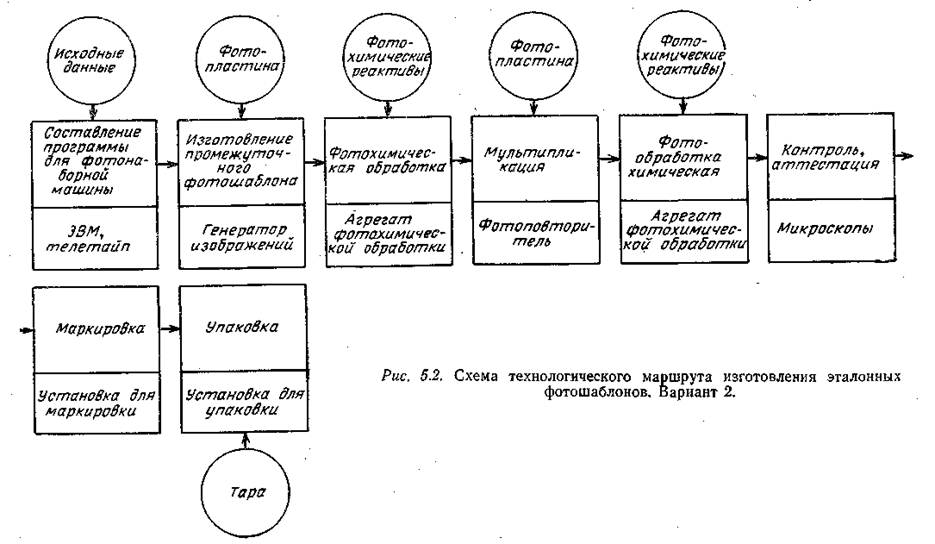
Электронолитография. В связи с физическими ограничениями оптического метода микрогравировки, проявляющимися прежде всего в ограниченной разрешающей способности и малой глубине резкости при работе вблизи предела разрешения, был поставлен вопрос об использовании электронных пучков для экспонирования резистивных пленок, т. е. о разработке метода электронолитографии. Применением в микроскопии электронных пучков, ускоренных до энергий 10—100 кэВ, дает возможность значительного (на несколько порядков) увеличения разрешающей способности.
Преимущества электронолитографии заключаются не только в более высокой разрешающей способности, но и в возможности автоматизировать процесс, использовав ЭВМ, и в результате значительно повысить производительность труда на микрогравировке, обеспечив более высокую точность и экономичность результатов. Пучки электронов, ускоренных в электрическом поле, обладают аналогично световым пучкам волновыми свойствами и с помощью специальных электростатических или магнитных линз могут быть сфокусированы на некоторую малую площадку. Минимальный диаметр этой площадки так же, как и в световой оптике, зависит от линейных размеров источника излучения* (кроссовера), энергии электронов и свойств линз. Если размер источника мал — точечный источник, — размер сфокусированного пятна ограничивается дифракционным пределом. В световой оптике минимальный диаметр центрального диска в сфокусированном пятне

Энергия движущегося электрона
![]()
где т — масса электрона; v — скорость движения электрона; е — заряд электрона; V — разность потенциалов на пути, пройденном электроном в процессе ускорения.
Любая элементарная частица массы т, движущаяся с некоторой скоростью v, может характеризоваться длиной волны X, которая может быть подсчитана по формуле
![]()
где h — постоянная Планка.
Для движущегося электрона из (13.36) получаем

Подставляя постоянные величины в формулу (33.39), получаем следующее выражение для длины волны электрона, ускоренного в поле с разностью потенциалов V [В].

Таким образом, для V =15∙103 В длина волны электрона составляет величину 0,01 нм.
Для электронолитографик, когда λ на несколько порядков меньше, высокое разрешение можно получить при очень малых апертурах. В результате глубина резкости сфокусированного электронного пучка может составлять 25-100 мкм, что позволяет получать одинаково резкие изображения по всей площади (искривленной) пластины.
Необходимо заметить, что в результате сферической аберрации электронно-оптических систем площадь сканирования электронным лучом плоской поверхности при заданном уровне допустимых искажений ограничена. Для систем, имеющих разрешение порядка 0,1 мкм, площадка сканирования не превышает 5х5 мм.
Установка для экспонирования резиста сфокусированным пучком электронов. Схема установки приведена на рис. 13.16.

Рис. 13.16. Схема установки для электронолитографии: 1 — устройство считывания; 2—устройство для управления экспонированием; 3—устройство для автоматического управления совмещением; 4— устройство для управления механическим перемещением; 5 —система управления; 6 — контрольно-измерительный прибор с электронно-лучевой трубкой; 7— устройство управления сканированием; 8 — детектор обратного рассеяния электронов; 9 — привод двигателя; 10 — счетчик импульсов; 11 — устройство для управления запиранием—отпиранием луча; 12— система отклонения; 13 — двигатель; 14 — электронная пушка; 15 — электронный луч; 16 — электронные линзы; 17 — устройство отклонения луча; 18 — камера экспонирования; 19 — подложка; 20 — детектор вторичных электронов; 21 — источник питания электронной пушки; 22 — устройство для возбуждения конденсорной линзы; 23 — камера замены подложки; 24 — откачивающие насосы; 25 — флюоресцентный экран; 26 — электронно-оптическая колонна; 27 — электронно-вычислительная машина.
Установка состоит из электронно-оптической колонны, содержащей электронную пушку, систему фокусирования и отклонения пучка и предметного столика, имеющего перемещения по координатным осям х, у от шаговых электродвигателей с точностью ±0,5 мкм, и устройство для его вращения с целью ориентации пластины.
Управление электронным пучком: включение и отключение его в процессе сканирования, и управление столиком осуществляются с помощью программного устройства и управляющей ЭВМ. Ускоряющее напряжение равно 30 кВ, минимальная ширина лилии экспонирования около 0,1 мкм (при токе пучка 10-8 А). Скорость сканирования составляет 100, 200 или 400 мм/сек, максимальная площадь сканирования 2x2 мм,максимальная площадь обработки 50х50 мм..В этом случае площадь экспонируемой структуры разбивается на квадраты размером 2х2 мм и для каждого квадрата составляется самостоятельная программа экспонирования с таким расчетом, чтобы рисунки отдельных квадратов образовали структуру микросхемы большой площади. Таким образом, схема развертки растрового микроскопа позволяет экспонировать при очень высоком разрешении значительные поля, что особенно важно при экспонировании структур сверхбольших интегральных микросхем, содержащих несколько тысяч компонентов в одной схеме.
На установке предусмотрена система для ориентации экспонируемой фигуры относительно специальных реперных меток. При движении пучка от нулевой точки число шагов фиксируется счетчиком. Когда пучок достигает реперной метки, в цепи специального детектора отраженных электронов возникает сигнал.
Таким образом электронолитография позволяет непосредственно создавать эталонный фотошаблон (одноступенчато).
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.