В той же час переміщення основних p і n носіїв з своїх нейтральних напівпровід-никових структур приводить до того, що за рахунок нерухомих іонів в p –області ство-рюється нескомпенсований від’ємний об’ємний заряд, а в n –області – аналогічний позитивний заряд ( рис. 1.10,а,), при чому обидва ці заряди будуть розміщуватися біля межі а-а (рис. 1.10,в).
Об’ємні заряди прикордонної області стають перешкодою на шляху переміщення основних носіїв з одної області в іншу. Це приводить до того, що тільки носії великих енергій можуть подолати цю перешкоду, яка називається потенційним бар’єром. Як результат, знижується величина струму через бар’єр за рахунок дифузії. З іншого боку поява об’ємних зарядів приводить до появи напрвленого електричного поля з потенціалом j0, який сприяє появі дрейфової складової струму. Джерелом дрейфового струму явялються неосновні носії p і n областей (позначені квадратами). Як результат, зменьшення Iдиф приводить до зростання Iдр появи установленого режиму, наслідком якого є умова
Iдр.+ Iдиф = 0,
якій відповідає величина потенціного бар’єру j0.Об’ємні заряди межі розподілу p і n структур, що створюють потенційний бар’єр j0 називаються p–n – переходом. Особливість потенційного бар’єру полягає в тому, що його висота, потенціал j0, залежить від температури, так як від неї залежить концентрація неосновних носіїв.
Розглянемо тепер особливість протікання струмів через p-n перехід при наявності зовнішньго електричного поля. В випадку, коли зовнішнє електричне поле від джерела Е прикладається плюсом до електрода p- області ( рис. 1.10,а), воно буде направлене протилежно дії внутрішньго поля p-n переходу, що приводить до зменшення величини потенційного бар’єру на величину Е ( рис.1.10,в).
Тобто, висота потенційного бар’єру jЕ при наявності зовнішньої напруги Е буде
jЕ = j0 – Е.
Це приведе до зростання дифузійної складової струму через p-n перехід, яка буде переміщуватись в глибину p і n структур. Дрейфова складова струму від зовнішнього потенціалу майже незалежить. Як результат, порушується баланс струмів через p-n перехід в сторону дифузійної складової. Подальше зростання зовнішньої напруги буде приводити до того, що величина потенційного бар’єру зменшиться до нуля і носії дифузійного струму будуть зростати.
Так як структура напівпровідникового приладу несиметрична, тобто концентрація основних носіїв в p – області на декілька порядків перевищує концентрацію електронів в n – області, то основна складова дифузійного струму – дірки, які переміщуються в глибину n – області. Область, яка забезпечує емісію дірок, як основної складової дифузійного струму, називається емітером, а друга ( в нашому випадку n - область) – називається базою. Ця назва обумовлена тим, що виготовлення p-n структур забезпечується на основі напівпровідника n – типу.
Зростання концентрації дірок в області бази компенсується електронами, які входять в неї від джерела зовнішнього електричного поля. В той же час, негативний заряд в емітері, накопичуємий за рахунок дифузії основних носіїв з бази під дією позитивного зовнішнього поля, виводиться в зовнішнє коло, створюючи тим самим постійні умоиви для протікання струму через p-n перехід. Фактично дифузійний струм через p-n перехід в глибині бази і емітера компенсується дрейфовим струмом, обумовленим полем зовнішньго джерела. З сказаного витікає важлива особливість p-n переходу з точки зору керування процесами в ньому:
- основним струмом через p-n перехід, який задає і струм в зовнішньому колі, являється струм, обумовлений дифузією основних носіїв;
- керування цим струмом за рахунок зовнішніх факторів забезпечується не безпосередньо, а побічним шляхом – створенням градієнтів концентрацій основних носіїв.
Звернемо увагу ще на одну властивість p-n переходу. Вона полягає в тому, що ширина його як при наявності зворотньої напруги, так і при її відсутності залежить від концентрації основних носіїв в p і n структурах. Збільшення концентрації приводить до вузьких p-n переходів з високим градієнтом потенціалу в ньому. Зменшення – навпаки приводить до створення широких p-n переходів. В тих випадках, коли p-n перехід створюється напівпровідниками з однаковою концентрацією основних носіїв, то його ширина по обидві сторони від межі розділення структур однакова і такий p-n перехід називають симетричним. Якщо ж створення переходу забезпечується напівпровідниками з різними концентраціями основних носіїв, то він буде ширший на стороні напівпровідника з меншою концентрацією основних носіїв. Такий p-n перехід називається несиметричним.
Як вже зазначалось, область p-n переходу в звичайних умовах не має вільних носіїв зарядів і, відповідно, провідність її дуже низька. Це призводить до того, що опір p-n переходу буде набагато вищим, ніж тих областей напівпровідника, які ним не зайняті. Тому прикладання зовнішньої напруги до p-n структури фактично приводить до того, що вся вона прикладається до p-n переходу.
Залежність струму через p-n перехід
від зовнішньої напруги визначається вольт-амперною характеристикою переходу,
яка для першого 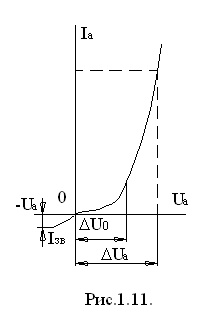 квадранту має вигляд, приведений на рис. 1.11.
зовнішня напругу Ua приводить до створення зовнішнього по
відношенню до приладу струму Ia.
В діапазоні напруги від 0 до DU0 має місце компенсація потенційного бар’єру j0,
який пов’язаний з градієнтом концентрації носіїв
співвідношеннями:
квадранту має вигляд, приведений на рис. 1.11.
зовнішня напругу Ua приводить до створення зовнішнього по
відношенню до приладу струму Ia.
В діапазоні напруги від 0 до DU0 має місце компенсація потенційного бар’єру j0,
який пов’язаний з градієнтом концентрації носіїв
співвідношеннями:
j0 = jТ ln(pP/pn) = jT ln(nn/np),
де jТ = kT/q – тепловий потенціал: Т – абсолют-на температура oK; k – стала Больцмана.
Тому ВАХ в указаному діапазоні має форму близьку до експоненти. При значеннях Ua > DU0 ВАХ представляє собою фактично пряму лінію з невеликим нахилом, який обумовлений падінням напруги дрейфового струму за рахунок наявності активного опору емітера і бази.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.