Конструкторско-технологическое обеспечение производства ЭВМ
1. Классификация интегральных схем
1.1. Пленочные: тонкопленочные (<10-6м), толстопленочные (>10-6м)
1.2. Гибридные (пассивные элементы в виде пленок, активные – навесные): тонкогибридные, толстогибридные
1.3. Совмещенные (пассивные элементы – в виде тонких пленок, активные в полупроводнике-подложке)
1.4. Полупроводниковые (все элементы выполнены в полупроводнике):
1.4.1. монолитные, многокристальные, кремний на сапфире
1.4.2. биполярные, МОП, КМОП, БИКМОП, ТТЛ, И2, ЭСЛ
2. Основные операции техпроцесса изготовления полупроводниковых ИС
2.1. Выжигание песка (25% Si) – грубая очистка
2.2. Очистка до степени 1 атом примеси на 109 атомов кремния. Например метод зонной очистки, когда кварцевая лодка с неочищенным кремнием гонится по кварцевой трубе с подогревом: примесь переходит в жидкую фазу и сдвигается в хвост лодки, который потом отрезается.
2.3. Получение монокремния из аморфного: в жидкий кремний помещается кристалл затравки и поднимается с вращением, образуя колбасу кремния с ориентированной атомной решеткой. Колбасу режут на диски D=100-150мм, h=0,3мм. Поверхность дисков шлифуют.
2.4. Многократное повторение процесса фотолитографии:
2.4.1. окисление кремния
2.4.2. покрытие фоторезистором
2.4.3. засвечивание через фотошаблон
2.4.4. протравка окисления
2.4.5. диффузия фосфора (для получения коллекторной и эмиттерной областей) или бора (базовая область).
2.4.6. после3х кратного повторения проводится окисление, протравка отверстий для алюминиевых контактов.
2.5. полученная карта МС тестируется на ВАХ, скрабируется (непрошедшие тест маркируются краской)
2.6. пластину делят на части и выкидывают помеченные
2.7. сборка в корпус (микросварка)
2.7.1. термокомпрессионная (каплей расправленной при t=400o проволоки)
2.7.2. расщепленным электродом (между двумя частями расщепленного электрода подают импульс – пролетает искра и соединяет)
2.7.3. ультразвуковая (клювик магнитоскриптора колеблется со скоростью 60 кГц и затирает проволоку); метод хорош тем, что нет высоких температур и не важен материал проволоки.
3. Методы изоляции полупроводниковых элементов
3.1. С помощью p-n перехода
3.1.1. метод встречной диффузии (встречная диффузия фосфора, что не позволяет концентрации фосфора на p-n переходе падать с расстоянием); обладает невысоким быстродействием из-за большой области диффузии
3.1.2. диффузия в коллекторную область (т.е. не встречная, а с той же стороны, что и p-n переходы); быстродействие выше, так как область диффузии меньше
3.1.3. эпитаксиально-диффузионный метод (выращивание слоя кристалла на подложке: кремний на кремнии или кремний на сапфире); низкое быстродействие, ненадежная изоляция
3.2. С помощью двуокиси кремния (перед изготовлением p-n переходов протравливаются «кармашки» для каждого набора К-Э-Б и окисляются, таким образом, два «кармашка» становятся полностью изолированными); ограничений на быстродействие нет
3.3. кремний на сапфире (кремний выращивается на сапфире, а затем области, ненужные для формирования области К-Э-Б удаляются, образуются выступы, в которых уже и происходит диффузия, а между собой выступы изолированы воздухом); ограничения на быстродействие нет.
4. Биполярные и МОП ИС
4.1. Биполярные ИС
4.1.1. Пассивные элементы
4.1.1.1.Диффузионное сопротивление
4.1.1.1.1. сопротивление базовой области

4.1.1.1.2. сопротивление эмиттерной области
![]()
(обладает большим сопротивлением, так как площать сечения меньше)
4.1.1.2.Диффузионный конденсатор
4.1.1.2.1. на основе p-n перехода
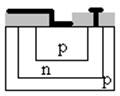 (наличие
транзитного сопротивления, нельзя запирать, так как является диодом, емкость
зависит от напряжения)
(наличие
транзитного сопротивления, нельзя запирать, так как является диодом, емкость
зависит от напряжения)
4.1.1.2.2. используя емкость между слоем диэлектрика и ал. электродом
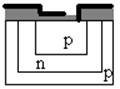 (наличие
транзитной емкости на подложке)
(наличие
транзитной емкости на подложке)
4.1.2. Активные элементы (транзисторы)
4.1.2.1.стоимость намного меньше, чем у навесных
4.1.2.2.высокая согласованность устройств (все имеют одни и те же параметры)
4.2. МОП позволяют получить ИС с:
4.2.1. увеличенным входным сопротивлением
4.2.2. высокой плотностью элементов
4.2.3. использованием транзисторов как резисторов
4.2.4. повышенной устойчивостью к влиянию окружающей среды
4.2.5. простой технологией изготовления
4.2.6. малой потребляемой мощностью
5. Пленочные элементы ИС
5.1. Резистор
5.1.1. Ширина, обеспечивающая рассеиваемую мощность bw2= r□W/(RW0)
5.1.2. Ширина, обеспечивающая точность: при DR=20% bt=0.2м, DR=10% bt=0.3м
5.1.3. Ширина резистора b=min(bw, bt)
5.1.4. Длина резистора l=Rb/r□
5.1.5. Коэффициент формы Kф=l/b. Если Кф>50 (длинный узкий резистор), необходимо изменить форму резистора:
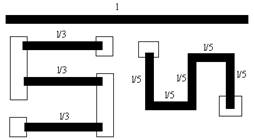
5.2. Конденсатор
5.2.1. Площадь конденсатора S’=C/C0. Данная площадь может быть получена любой конфигурацией
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.