![]() (1.17)
(1.17)
Во втором образце проводимость равна:
 (1.18)
(1.18)
Подставляем выражения (1.17) и (1.18) в выражение (1.16), получаем:
 (1.19)
(1.19)
Если предположить, что подвижности носителей в образцах равны:
![]() (1.20)
(1.20)
Учитывая выражения (1.9) и (1.13) получаем следующее неравенство:
 (1.21)
(1.21)
Эффективная плотность состояний одинакова и условие (1.16) должно выполняться, то можно сделать вывод:
![]() (1.22)
(1.22)
Концентрация примеси во втором образце больше концентрации примеси в первом.
При
дальнейшем росте температуры будет выполняться условие ![]() .
.
Рассмотрим значения температур, при которых все атомы уже ионизированы. Такое значение температур соответствует точкам с и с’ на графике изображенном, на рисунке 1.1.
Точке с соответствует температура Т3,а с’ – Т1. Из графика видно, что:
![]() (1.23)
(1.23)
Подвижность имеет зависимость от температуры (1.7). Значит:
![]() (1.24)
(1.24)
Построены зонные диаграммы исследуемых образцов полупроводниковых материалов (рис.1.2).
![]()

![]()
Рис.1.2. Зонные диаграммы для 2-х образцов полупроводниковых материалов.
Вывод: в результате выполнения данной лабораторной работы были определены соотношения ширины запрещенных зон, энергий активации донорных уровней, подвижностей носителей и концентраций атомов примеси для двух образцов полупроводниковых материалов. Данные соотношения были объединены в систему уравнений:

Данная
система физически реализуема. Так, например, в качестве образца А может
служить арсенид галлия с шириной запрещённой зоны ![]() 1,4
эВ и подвижностью электронов
1,4
эВ и подвижностью электронов ![]() 1,1
1,1![]() , а в качестве образца В -
кремний, ширина запрещённой зоны которого
, а в качестве образца В -
кремний, ширина запрещённой зоны которого ![]() 1,11 эВ,
подвижность электронов
1,11 эВ,
подвижность электронов ![]() 0,14
0,14 ![]() .
.
2.1 Формулировка задачи
Построить ВАХ реального p-n перехода (Iб = 10-6А, Imax = 1,5·10-2 А).
2.2 Краткие теоретические сведения
Основными причинами отличия ВАХ реального р—п – перехода от идеального являются неучитываемые процессы рекомбинации носителей в обедненном слое и распределенное сопротивление базы.
В данной работе будет построена ВАХ реального. С учётом падения напряжения на базе прямая ветвь ВАХ соответствует зависимостям:
 ,
,  (2.1)
(2.1)
n-область является базой, тогда Rб находится по формуле:
 ,
(2.2)
,
(2.2)
где ![]() - удельное
объемное сопротивление n-области,
- удельное
объемное сопротивление n-области,
![]() -
толщина базы (n-области),
-
толщина базы (n-области), ![]() - площадь
базы.
- площадь
базы.
Удельное объемное сопротивление n-области можно найти как
 ,
(2.3)
,
(2.3)
где ![]() - заряд электрона (
- заряд электрона (![]() Кл),
Кл), ![]() - подвижность
электронов,
- подвижность
электронов, ![]() - концентрация электронов.
- концентрация электронов.
С учётом этого выражение для сопротивления базы будет иметь вид:
 (2.4)
(2.4)
3.3 Решение задачи
Строим ВАХ реального p-n перехода при значении обратного тока Iобр=1 мкА.
ВАХ реального диода строится по формулам (2.1) с учётом того, что сопротивление базы рассчитывается по выражению (2.4).
Для построения необходимо задать необходимые параметры (рассматривается кремниевый полупроводник):
толщина базы ![]() , подвижность электронов
, подвижность электронов  , концентрации электронов
1023 м-3, площадь базы
, концентрации электронов
1023 м-3, площадь базы ![]() , заданный обратный ток Iобр=10 мкА.
, заданный обратный ток Iобр=10 мкА.
Диапазон изменения прямого тока от 0 до 200 мА.
Сопротивление базы равно 0,089 Ом.
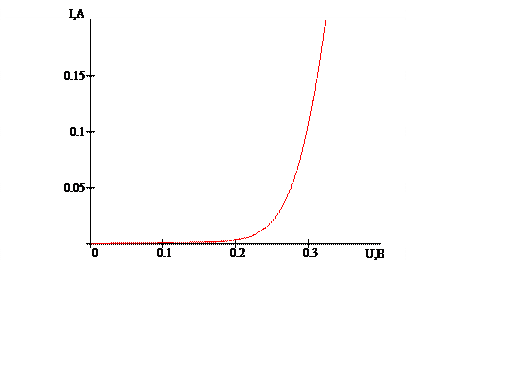
Рис. 2.1. ВАХ реального p-n перехода.
При значениях тока от 0 до 200 мА напряжение реального диода по формуле (2.1):
 .
.
При этом падение напряжения на базе растёт с увеличением прямого тока, от 0,005 до 0,02 В.
Высокий уровень инжекции, т.е. работа p-n переходов при больших прямых токах, сопровождается значительным увеличением вклада дрейфовой составляющей полного электронного тока перехода. Это отражается в увеличении эквивалентного коэффициента диффузии дырок вблизи границы перехода до удвоенного значения при низком уровне инжекции, т.е. при высоком уровне инжекции дрейфовая составляющая дырочного тока почти равна диффузионной, а полный дырочный ток удваивается.
Вывод: в этом задание рассматривается реальный p-n переход. В отличие от идеального здесь учитываются процессы генерации и рекомбинации носителей в обедненном слое, а также распределенное сопротивление базы p-n перехода. При увеличении прямого тока концентрация НН в базе возрастает, что сопровождается уменьшением сопротивления базы, т.е. имеет место эффект модуляции проводимости базы. Прямой ток при высоких уровнях инжекции (прямого смещения) необходимо удваивать. При сверхвысоких уровнях инжекции исчезает потенциальный барьер, ВАХ перестает быть экспоненциальной, постепенно приближаясь к степенной зависимости.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.