Министерство образования Российской Федерации
Владимирский государственный университет
Факультет радиофизики, электроники и
медицинской техники
Кафедра КТРЭС
Лабораторная работа №2
по дисциплине
Физические основы микроэлектроники
Выполнил:
Проверил:
Владимир, 2003
|
 ,
,
|
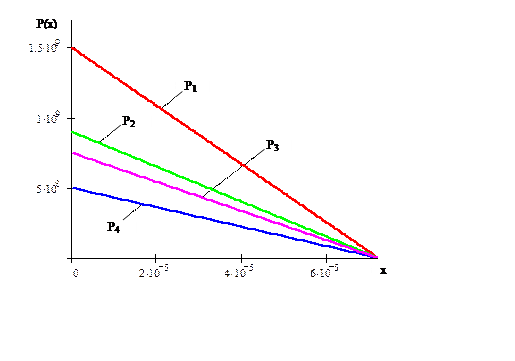
|
Из графика зависимости концентрации неосновных носителей в базе от координаты для различных значений концентрации дырок на границе p-n-пере
Из графика зависимости концентрации неосновных носителей в базе от координаты для различных значений концентрации дырок на границе p-n-перехода можно сделать вывод о том, что чем меньше будет концентрация неосновных носителей на границе (x=0), тем положе пройдет прямая, характеризующая зависимость концентрации дырок от координаты в базе диода.
|
 , где q – заряд электрона, q =
, где q – заряд электрона, q = ![]() Кл, p1 – мгновенное значение концентрации дырок на границе p-n-перехода, d – толщина базы, τр
– время жизни дырок в области базы, τр = 10-6 с.
Кл, p1 – мгновенное значение концентрации дырок на границе p-n-перехода, d – толщина базы, τр
– время жизни дырок в области базы, τр = 10-6 с.
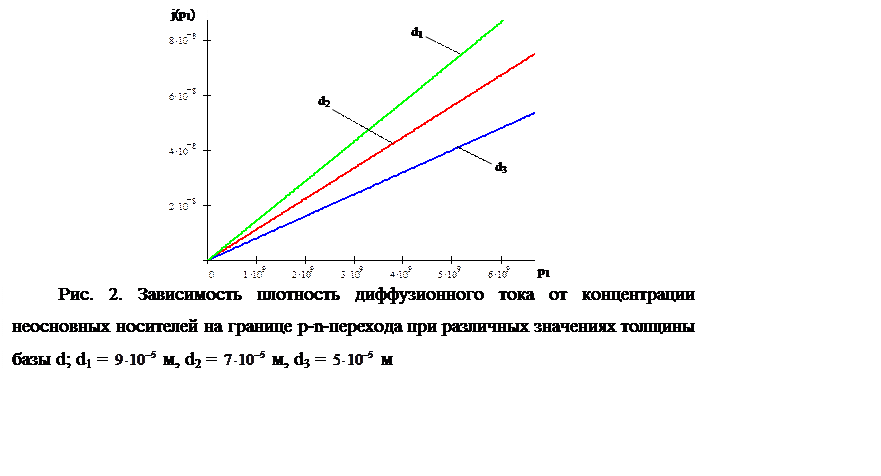
Очевидно, что если концентрация дырок на границе p-n-перехода равна нулю, то дырки не будут проникать в область базы, т. е. плотность тока также равна нулю. По характеру зависимости, изображенной на рис. 2, видно, что чем толще база диода, тем больший ток будет протекать через p-n-переход.
Напряжение на p-n-переходе определяется значением граничной концентрации p1 и из статистики Ферми-Дирака для невырожденных полупроводников следует:
|
 ,
,
|
 , где q – заряд электрона, q =
, где q – заряд электрона, q = ![]() Кл; k – постоянная Больцмана, k=
Кл; k – постоянная Больцмана, k=![]() Дж/К,
Т – текущая температура, К.
Дж/К,
Т – текущая температура, К.
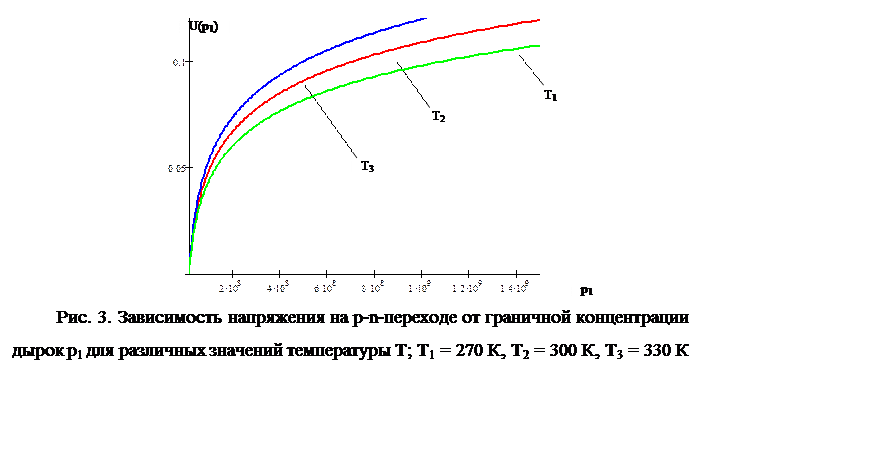 |
Анализируя зависимость на рис. 3, можно сделать вывод о том, что чем выше температура, тем больше будет напряжение на p-n-переходе, при одинаковых значениях граничной концентрации р1.
Выражение (1) лишь приближенно отражает стационарное распределение неосновных носителей в базе при длительном протекании прямого тока для диода с тонкой базой и омическим контактом рекомбинационного типа. В неупрощенном виде оно выглядит следующим образом:
|

Необходимо выяснить, возможно ли применение упрощенной формулы (1) во всем интервале изменения текущей координаты x (от 0 до d). Считать, что при этом необходимость применения формулы (6) возникает при отклонении значения p(x) на 10%.
Графики зависимостей, построенные по формулам (1) и (6) показаны на рис. 4.
Расчет показал, что при погрешности 10% упрощенную формулу (1) можно применять в интервале 0…0,89d. В интервале 0,89d…d необходимо применять формулу (6).
|
|
|
|
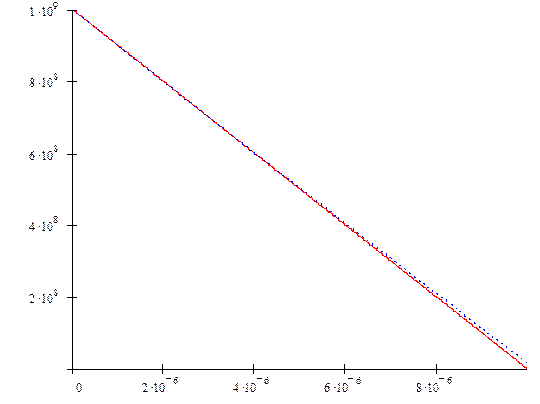
|
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.