Глава 17
Источникиотрицательных ионов
Отрицательные ионы, особенно ионы Н , широко используются в циклотронах и тандемных ускорителях для питания накопительных колец высокоэнергетических ускорителей и при генерировании пучков нейтральных частиц большой энергии для нагрева термоядерной плазмы. Отрицательные ионы могут быть образованы путем двойной перезарядки или путем непосредственного вытягивания из источника отрицательных ионов. Можно выделить два различных типа источников: 1) поверхностные источники, в которых отрицательные ионы создаются в результате столкновений частиц с поверхностью, имеющей низкую работу выхода; 2) объемные источники, в которых отрицательные ионы образуются в процессе столкновений электрон-молекула и электрон-ион в объеме плазмы разряда. В настоящей главе рассмотрено развитие этих двух типов источников отрицательных ионов и некоторые последние технологические разработки.2' Можно видеть, что всего за 20 лет ток установившегося пучка отрицательных ионов (например, Н " ) удалось увеличить от нескольких миллиампер до величины более 1 А.
17.1. ПОВЕРХНОСТНЫЕИСТОЧНИКИ ОТРИЦАТЕЛЬНЫХИОНОВ
17.1.1. Источникиотрицательныхионов распылительноготипа
Источник с распылением цсэиевым пучком, разработанный Миддлтоном и Адамсом, использовался для создания разнообразных атомарных и молекулярных ионов [1, 2]. На рис. 17.1 показана схема источника с использованием распыления. Положительные ионы цезия, испускаемые поверхностно-ионизационным источником, используются для распыления внутренней части полой конической мишени. Образующиеся отрицательные ионы вытягиваются из отверстия в задней части распыляемой мишени, и на выходе они ускоряются заземленным электродом. Энергия положительных ионов цезия обычно составляет 20—30 кэВ, а токи не превышают 1— 2 мА. Ток отрицательных ионов, генерированных этим источником, обычно составляет 0,1 —10 мкА. Вид отрицательных ионов можно быстро сменить, для чего требуется только повернуть барабан с мишенью.
На рис. 17.2 показан другой
источник отрицательных ионов распылительного типа (так называемый
«инвертированный» распыли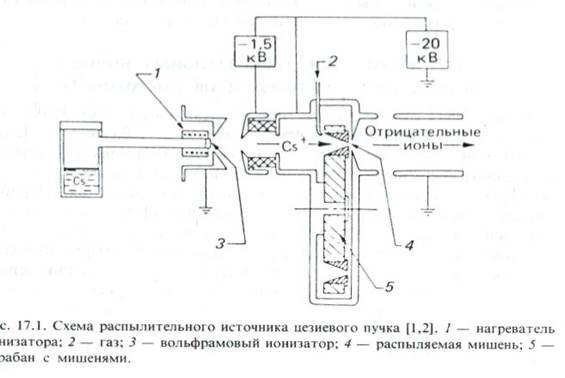

Рис. П.2. Схема инверсированного распылительного источника 2— распыляемая мишень; 3- ионизатор; 4- шн реиатсль ионизатора тельный источник), разработанный Миддлтоном в 1976 г. [1, 3]. В конструкции этого источника для генерирования распыляющего цеэиевого пучка используется кольцевой ионизатор, а отрицательные ионы вытягиваются через отверстие в ионизаторе.
17.1.2. Источники отрицательных ионов с преобразованием плазмы на поверхности
Существуют два основных типа источников отрицательных ионов с преобразованием (конверсией) плазмы на поверхности. В источниках первого типа используются геометрия разряда Пеннинга, радиальное вытягивание ионов и несущий газ, к которому добавлены пары цезия. Источники с использованием распыления, разработанные независимо в Орхуском университете [4], Висконсинском университете [5] и Новосибирске [6, 7], относятся к этой категории. В источниках второго типа в качестве разрядной камеры применяется многополюсный генератор плазмы [8]. Этот источник первоначально был разработан в Лаборатории им. Лоуренса в Беркли с целью создания пучка нейтральных частиц. Недавно он использовался как источник ионов Н"" для ускорителей частиц в Лос-Ала-мосской национальной лаборатории и в Японии [9, 10].

Рис. 17.3. Схема, иллюстрирующая принцип работы источника отрицательных ионов, разработанною | Орхусе [1,4]. / — распыляемый КАТОД; 2 — вытягивающий злекзрод; 3 — граница плазмы; 4 — анод.
На рис. 17.3 схематически показан принцип работы источника первого типа. Разряд Пеннинга генерирует плазму несущего газа и цезия. Цезий выполняет двойственную функцию: во-первых, действует как распыляющий агент и, во-вторых, снижает работу выхода поверхности мишени, чтобы увеличить поток
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.