Крутизна S=dID/dUGдля всех полевых транзисторов примерно линейно зависит от
напряжения на затворе и обращается в нуль вместе с током при пороговом
напряжении или в точке отсечки, запирания транзистора. Удельная крутизна  представляет собой приращение крутизны на
один вольт напряжения на затворе. Эта величина может быть отсчитана по графику GDG(UG) в точке UG -Un = 1 B, рис. 21.
представляет собой приращение крутизны на
один вольт напряжения на затворе. Эта величина может быть отсчитана по графику GDG(UG) в точке UG -Un = 1 B, рис. 21.

Рис. 21. Зависимость крутизны от напряжения на затворе МОП транзистора.
Смысл этого определения понятен, поскольку
проводимость GDG и есть крутизна передаточной характеристики ID(UG). Используя
маркер на зависимости GDG(UG) из SibGraf 2D отсчитать в XY окошке две пары значений
крутизны и напряжения на затворе и рассчитать удельную крутизну ![]() как отношение приращений:
как отношение приращений:
 .
.
Аналогично для ПТУП удельная крутизна может быть определена как отношение крутизны GDG(0) при нулевом напряжении на затворе к напряжению отсечки UG0 , рис.22.


Рис. 22. Зависимость крутизны от напряжения на затворе для ПТУП.
Во всех точках анализируемой передаточной
характеристики транзисторы должны находиться в пологой области, т.е. ![]() или
или ![]() ,
поскольку само понятие крутизны S определяется для пологой области ВАХ.
Следует иметь в виду, что удельная крутизна аналогично коэффициенту подложки не
зависит от режима, а определяется только подвижностью носителей в канале и его
размерами. Для МОП транзистора
,
поскольку само понятие крутизны S определяется для пологой области ВАХ.
Следует иметь в виду, что удельная крутизна аналогично коэффициенту подложки не
зависит от режима, а определяется только подвижностью носителей в канале и его
размерами. Для МОП транзистора  ,
,  , d - толщина диэлектрика, b и L
– ширина и длина канала. В ПТУП аналогично
, d - толщина диэлектрика, b и L
– ширина и длина канала. В ПТУП аналогично  ,
здесь W- толщина канала.
,
здесь W- толщина канала.
6. Дополнительные возможности МТ 4.21
В предыдущих разделах мы везде подразумевали применение старой версии МТ 3.05. Последняя версия МТ 4.21 среди прочих дополнительных возможностей позволяет создавать в структуре прибора изолированные окисные канавки. На рис. 1 показана структура арсенидгаллиевого ПТШ с окисными канавками, а на рис. 2 соответствующие фрагменты входного командного файла.
Возможности программы SemSim в старой версии ограничивались диффузионно-дрейфовым приближением, применением модели Шокли-Рида для рекомбинации и моделированием лавинного умножения в сильных электрических полях. Версия МТ 4.21 содержит дополнительные функции моделирования рекомбинационных процессов: Оже рекомбинацию, излучательную рекомбинацию и модель междузонного туннелирования в сильных электрических полях. Соответствующие распределения представлены на рис.3 , а на рис. 4 ВАХ германиевого P+N+-перехода.
Далее представлен тексты командных файлов германиевого и GaAs туннельных диодов
COMM:PROJ='Ge_Tun_Diode',METH='SemSim',TIME='15:57:51 03/27/2009';
#BAS:
MESH:NX=60,NY=90,XX=1,YY=1,ZZ=1,MESH=2,HY0=0.1;
SOLV:COMM='Diode test',BATC=1,GUMM=20,GRES=0.001;
MODE:BBTL=2,ELHL=0,HVDO=1,IMPI=1;
}
#DOP:
DOPA:COMM='P-type',DOP=-5e+20,IWEL=3,XLFT=0.000000,XRGT=0.3,YTOP=0.000000,YBOT=0.2,
ALX=0.01,ALY=0.01,EXPX=2,EXPY=2;
DOPA:COMM='N-type',DOP=2e+19,IWEL=1,XLFT=0,XRGT=1,YTOP=0,YBOT=1,ALX=0.0005,ALY=1e-06,
EXPX=2,EXPY=2;
}
#MAT:
BAND:TEMP=290,EGAL=0.000473,EG30=0.66,ENV3=7.04e+17,ENC3=4.7e+17,CNSB=0.5,EGBE=636
;
PERM:EPSS=13.1;
BBTL:BBA=3.5e+24,BBE=2.13e+07;
WORK:FIS=4.17;
}
#REC:
SRH:ETRA=0.5,TAUN=1e-7;
RADI:RATE=1e-07;
RCMR:XLFT=0,XRGT=1,YTOP=0,YBOT=1,TNRR=1e-7,TPRR=1e-7,ETRR=0.5;
}
#IMP:
IONP:AN0=0;
IONE:EN0=0;
}
#ELE:
OHMI:NAME='Anode',NUM=1,LOC=1,XLT=0,XRT=0.2;
OHMI:NAME='Cathode',NUM=2,LOC=2,XLT=0,XRT=0.8;
}
#IVD:
IVDA:TEXT='IV-curve',NUMC=1,NPNT=21,V1=-0.02,VSTE=0.01,V2=0;
}
$
COMM:PROJ='GaAs_Tun_Diode',METH='SemSim',TIME='17:16:59 03/27/2009';
#BAS:
MESH:NX=90,NY=90,XX=1,YY=1,ZZ=1,MESH=2,HY0=0.1;
SOLV:COMM='Diode test',BATC=1,GUMM=50,GRES=0.001;
MODE:BBTL=2,ELHL=0,HVDO=1,IMPI=1;
}
#DOP:
DOPA:COMM='P-type',DOP=-2e+20,IWEL=3,XLFT=0.000000,XRGT=0.3,YTOP=0.000000,YBOT=0.2,
ALX=0.01,ALY=0.01,EXPX=2,EXPY=2;
DOPA:COMM='N-type',DOP=2e+19,IWEL=1,XLFT=0,XRGT=1,YTOP=0,YBOT=1,ALX=0.0005,ALY=1e-06,
EXPX=2,EXPY=2;
}
#MAT:
BAND:TEMP=290,EGAL=0.00054,EG30=1.42,ENV3=7.04e+17,ENC3=4.7e+17,CNSB=0.5,EGBE=204
;
PERM:EPSS=13.1;
BBTL:BBA=3.5e+24,BBE=2.13e+07;
WORK:FIS=4.17;
}
#REC:
SRH:ETRA=0.5,TAUN=1e-7;
RADI:RATE=1e-07;
RCMR:XLFT=0,XRGT=1,YTOP=0,YBOT=1,TNRR=1e-7,TPRR=1e-7,ETRR=0.5;
}
#IMP:
IONP:AN0=0;
IONE:EN0=0;
}
#ELE:
OHMI:NAME='Anode',NUM=1,LOC=1,XLT=0,XRT=0.2;
OHMI:NAME='Cathode',NUM=2,LOC=2,XLT=0,XRT=0.8;
}
#IVD:
IVDA:TEXT='IV-curve',NUMC=1,NPNT=33,V1=-0.02,VSTE=0.02,V2=0;
}
$
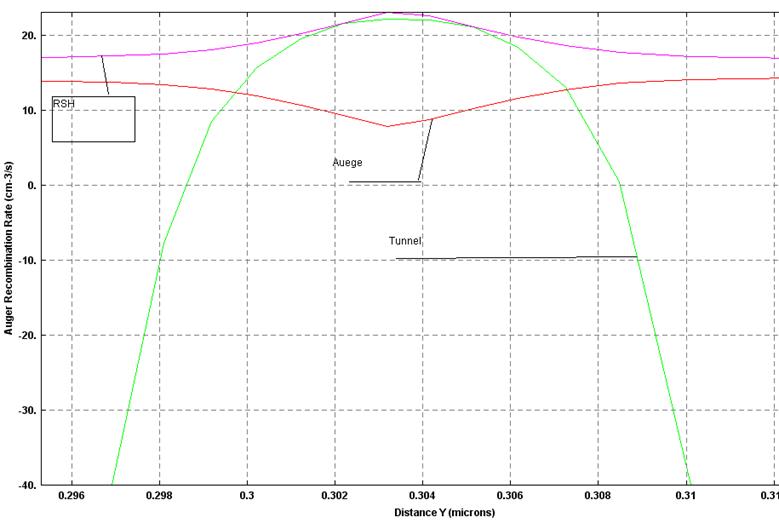
Рис.23 . Распределение скоростей генерации вблизи металлургической границы перехода.

Рис.24 . Вольтамперная характеристика германиевого туннельного диода, полученная с помощью MT 4.21

Рис.25 . Вольтамперная характеристика арсенид-галлиевого туннельного диода, полученная с помощью MT 4.21
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.