ЛИТЕРАТУРА
ОПИСАНИЕ
установки термовакуумного нанесения
тонких пленок УВН-7-3 и измерительных
приборов
2012
Установка УВН-7-3 предназначена для исследования технологии напыления и серийного производства ИС. Оно позволяет наносить тонкие пленки в высоком вакууме методом резистивного испарения материала.
Установка состоит из следующих основных частей (рис. 1):
установка универсальная автоматическая вакуумной откачки 1, подколпачное устройство 2, шкаф питания и управления 3.
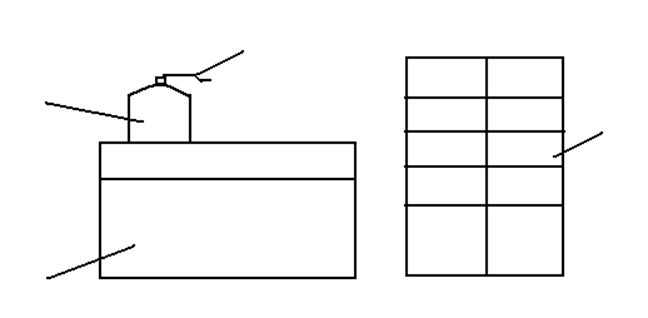
4
2
3
1
Рис. 1
Откачка подколпачного устройства производится последовательно двумя насосами. Вначале до давления 10-1 Па откачка осуществляется механическим насосом. Затем вместо механического насоса подключается паромасляный (диффузионный) насос, который обеспечивает получение вакуума 10-4 Па.
Контроль вакуума в установке осуществляется вначале термопарным датчиком, затем ионизационным.
Термопарный датчик предназначен для измерения вакуума в пределах 5*10-1 . . . 1*10-1 мм.рт.ст. (Па). Принцип действия термопарного вакуумметра (рис. 2) основан на зависимости температуры нити 1, нагреваемой стабильным электрическим током, от давления газа. При изменении давления меняется тепловое сопротивление нить-среда, это приводит к изменению температуры нити. Для изменения температуры (эта зависимость прокалибрована в единицах вакуума) в тепловом контакте с нитью находится термопара 2.

Рис. 2
Ионизационный вакуумметр предназначен для измерения вакуума в пределах 1*10-3 . . . . .1*10-8 мм рт.ст. Он представляет собой трехэлектродную лампу (рис. 3), содержащую термокатод 1, электрод 2 в виде сетки, выполняющий роль анода, коллектор положительных ионов 3.
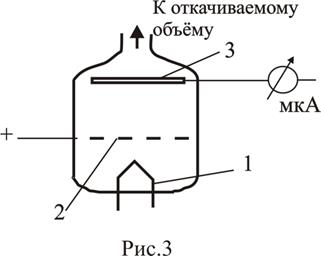
При пролете электронов от катода 1 до электрода 2 они сталкиваются с атомами остаточных газов и ионизируют их. Положительные ионы притягиваются коллектором, на который подается отрицательный потенциал.
Ток, текущий через коллектор положительных ионов 3, зависит от концентрации атомов остаточных газов, то есть от степени вакуума. Прибор, измеряющий этот ионизационный ток, прокалиброван в единицах давления (вакуума).
Подколпачное устройство (рис. 4) состоит из следующих основных элементов:
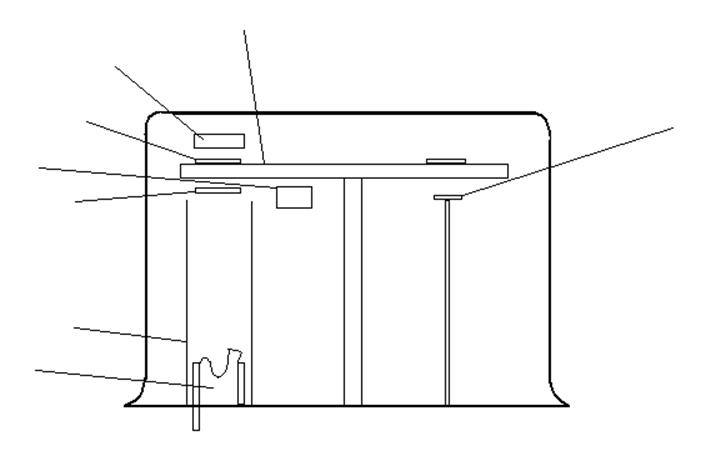
5
7
4 6
3
2
8
1
Рис. 4
Подъем и опускание колпака в установке осуществляется гидроприводом. Кнопки управления находятся в верхней левой области установки вакуумной откачки 1 (рис.)
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.