1. Проведення роботи по дослідженню стійкості фоторезистів до кислих розчинів
1.1 Мета роботи
Вивчити питання стійкості фоторезистивних покриттів в різних кислотах та їх сумішах при кімнатній температурі. Розглянути механізми руйнування фоторезисту, а також можливість використання його в технологічних процесах.
В процесі виготовлення напівпровідникових приладів фоторезистивні маски витримують дію різних агресивних середовищ, починаючи зі слабких розчинів та до концентрованих кислот.
Причому було помічено, що в нейтральних розчинах типу травника для двоокису кремнію питання о стійкості фоторезисту не стоїть. Воно виникає при травленні алюмінію, при виготовленні розводки на приладі. Особо це питання підіймається при виготовленні напівпровідникових приладів з високою ступеню інтеграції з многорівневою розводкою, коли перший шар металу повинен мати визначений профіль травлення. Перетин струмоведучої доріжки повинен уявляти трапецію з нахилом бокових граней під кутом 30-45° до основи та закругленими верхніми кутами. Такий перетин позволяє отримати діелектричні та металічні шари, що лежать вище, з плавними переходами по рельєфній поверхні без розривів, що приводить до покращення якості напівпровідникових приладів.
Мета даної роботи – розбір впливву кислот, які входять у склад травника для алюмінію, на фоторезистивну маску та механізм отримання регулюємого профілю травлення.
1.2 Хід роботи
Розчин для травлення алюмінію складається з концентрованих кислот: оцтової, ортофосфорної та азотної у співвідношенні 15:70:15 відповідно. Для визначення впливу кожної кислоти на фоторезистивну маску було випробувано вплив цих кислот на фоторезисти. В якості підложки були використані двоокис кремнію та алюміній, на яких формувалася маска фоторезисту з полосами шириною 2-8 мкм та довжиною декілька міліметрів. Елементи фоторезистивної маски підвергалися дії кислот при температурі 50°С.
Руйнування фоторезисту після витримки у кислотах протягом 5 годин специфічно для кожного фоторезисту при одній подібності. В фосфорній кислоті усі фоторезисти руйнуються значно сильніше, ніж в оцтовій та азотній. Тому взявши у якості основного розчинника ортофосфорну кислоту, випробували руйнуючі властивості композицій фосфорно-оцтової, фосфорно-азотної та фосфорно-оцтово-азотної кислот.
В таблиці 1 приведені дані по стійкості фоторезистів в композиційних розчинах кислот та по часу стійкості фоторезиствної маски на двоокису кремнію в кислотних розчинах. Сама велика стійкість фоторезисту в розчині ортофосфорної та оцтової кислот, тобто в кислотах які мають найменшу ступінь дисоціації, а найменша стійкість фоторезисту в розчинах з вмістом азотної кислоти, яка сильно дисоціює.
Таблиця 1 – Час витримки фоторезистивної маски в кислотах до її руйнування на поверхні SiO2 (діаграми 1-3)
|
Фоторезисти |
Композиції кислот. Протягом часу, година |
||
|
H3PO4:CH3COOH= =70:30 |
H3PO4:HNO3= =70:30 |
H3PO4:HNO3:CH3COOH= =70:15:15 |
|
|
ФП-РН-7-2 |
2 |
1 |
1 |
|
ФП-383 |
4 |
3 |
1 |
|
ФП-626 |
4 |
3,5 |
3 |
|
ФП-5п16(3т) |
2 |
1 |
1 |
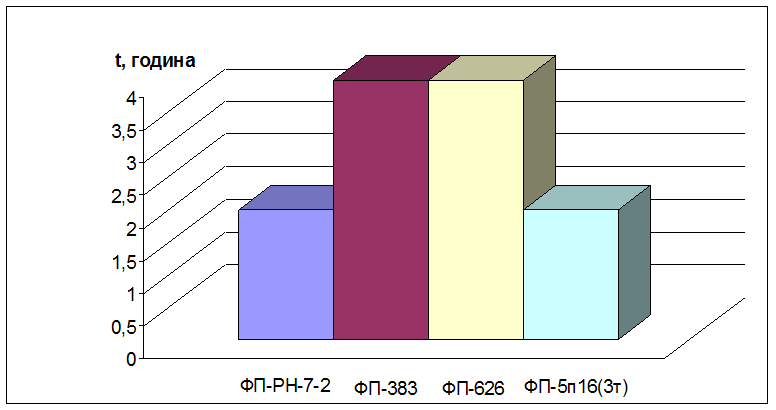
Діаграма 1 - Час витримки фоторезистивної маски в кислоті H3PO4:CH3COOH= =70:30 до її руйнування на поверхні SiO2
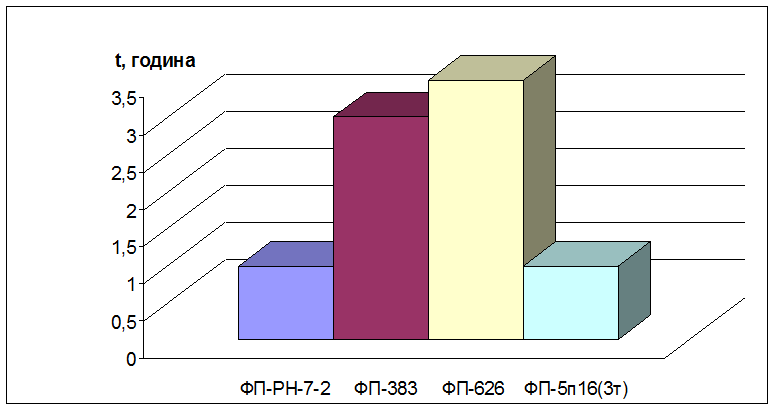
Діаграма 2 - Час витримки фоторезистивної маски в кислоті H3PO4:HNO3= =70:30 до її руйнування на поверхні SiO2
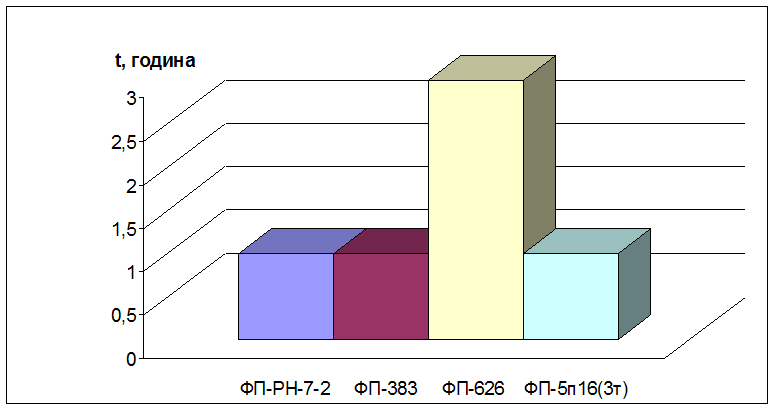
Діаграма 3 - Час витримки фоторезистивної маски в кислоті H3PO4:HNO3:CH3COOH= =70:15:15 до її руйнування на поверхні SiO2
При вивченні стійкості фоторезистивної маски на поверхні алюмінію було виявлено, що стійкість фоторезисту на двоокису кремнію на порядок вище ніж на алюмінію. З’явилася така думка, що в даному випадку на зниження стійкості фоторезистивної маски впливає сам алюміній.
Оскільки склад для травлення алюмінію включає в себе окислювач та розчинник окислу, то він являється одночасно травником для алюмінію та електролітом для його окислення. Тому фоторезистивна маска на алюмінії підвертається не тільки руйнуючому впливу хімічних процесів, але й електрохімічних.
В таблиці 2 приведені дані по часу стійкості фоторезистів в азотній, оцтовій кислотах та їх сумішах. Оскільки фосфорна кислота є розчинником для алюмінію, то експеримент по стійкості в ній фоторезисту не проводився.
Таблиця 2 - Кислотостійкість фоторезистивної маски на поверхні алюмінію (діаграми 4-5)
|
Фоторезисти |
Кислоти |
|
|
HNO3 |
HNO3:СН3СООН=1:1 |
|
|
ФП-РН-7-2 |
8хв 10 с |
8 хв 30 с |
|
ФП-383 |
6 хв 5 с |
9 хв 40 с |
|
ФП-626 |
6 хв |
9 хв 50 с |
|
ФП-5ц16(Зт) |
7 хв 5 с |
9 хв 25 с |
Примітка: для усіх фоторезистів час стійкості у СН3СООН склав 1,5 години
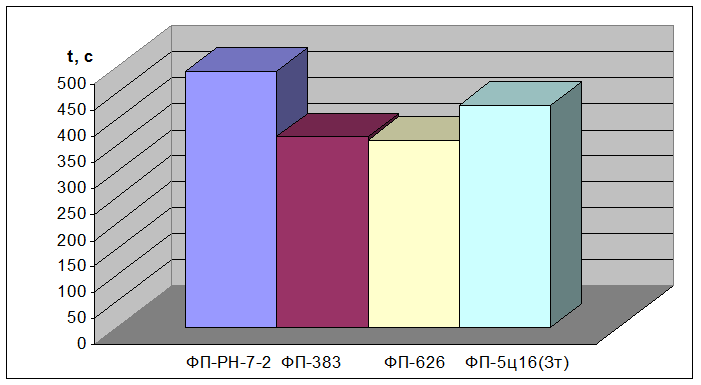
Діаграми 4 – Кислотостійкість фоторезистивної маски на поверхні алюмінію до кислоти HNO3
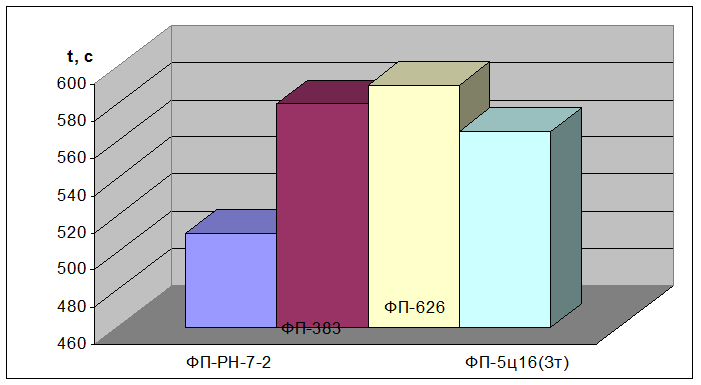
Діаграми 5 – Кислотостійкість фоторезистивної маски на поверхні алюмінію до кислоти HNO3:СН3СООН=1:1
З таблиці 2 видно, що азотна кислота значно швидше руйнує фоторезист на алюмінії, ніж оцтова кислота. В суміші цих кислот позначається невелике зменшення електролітичних властивостей розчину та збільшення часу стійкості фоторезисту. Але при загальному збільшенні часу стійкості фоторезистів більше всього воно зростає у ФП-626 та ФП-383.
При проведенні процесу травлення алюмінію в розчині H3PO4:HNO3:CH3COOH в співвідношенні 70:15:15 відповідно. Фото резистивна маска ФП-383 не руйнується протягом 6-7 хвилин. Цей час є середнім по відношенню до лівої та правої колони таблиці 2.
1.3 Аналіз отриманих результатів
Таким чином, при випробуванні фоторезистів на хімічну стійкість було виявлено, що найбільшим руйнуючим фактором фоторезистивної маски при виготовленні металевої розводки є наявність азотної кислоти в травнику для алюмінію. Це від'ємне явище в роботі використовується для бічного підтравлювання металічних провідників, а процес відшарування фоторезистивної маски по її периметру, яка використовується для отримання трапецієподібного профілю провідника заснована на електрохімічних властивостях, які виникають в розчині при наявності в ньому алюмінію. Оскільки фото резистивна маска закриває на поверхні алюмінію певну частку, то на їх межах концентрується більше число силових ліній, ніж на відкритій частині алюмінію, та в цих місцях йде більш інтенсивне розчинення алюмінію як на відкритих участках, так і з боків під фоторезистом, що призводить до відриву фоторезисту по периметру його маски.
1.4 Висновки
Отже, наявність розчинної кислоти в розчині для травлення алюмінію визначає бокове підтравлювання алюмінію під фоторезист та швидкість руйнування останнього. Вибираючи температуру розчину можна змінити відношення швидкостей цих двох процесів, а тим самим регулювати профілем травлення алюмінієвого провідника.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.