 (5)
(5)
Из соотношения (5) видно, что, если
![]() >>
>>![]() , то
, то ![]() -
скорость роста определяется скоростью диффузии реагентов через газовую фазу
(диффузионная область, наблюдаемая при высоких температурах). Если
-
скорость роста определяется скоростью диффузии реагентов через газовую фазу
(диффузионная область, наблюдаемая при высоких температурах). Если ![]() >>
>>![]() ,
, ![]() -
скорость роста определяется скоростью химической реакции на поверхности
(кинетическая область, наблюдается при низких температурах).
-
скорость роста определяется скоростью химической реакции на поверхности
(кинетическая область, наблюдается при низких температурах).
Переходная область определяется комплексом газодинамических факторов и обычно наблюдается в диапазоне температур 1100...1150 °С. Как показала практика, наиболее совершенные пленки получаются обычно в диффузионной области, т.е. при температурах свыше 1100...1150 °С.
В литературе приводится целый ряд
механизмов, позволяющий оценивать эти составляющие, причем обычно
предполагается, что при реальных технологических режимах лимитирующим фактором
является диффузионная составляющая (![]() ), роль
которой возрастает при увеличении температуры. Однако в последнее время намечается
тенденция к снижению температуры эпитаксии, что увеличивает роль кинетической
составляющей (
), роль
которой возрастает при увеличении температуры. Однако в последнее время намечается
тенденция к снижению температуры эпитаксии, что увеличивает роль кинетической
составляющей (![]() ). Наиболее полная модель, учитывающая оба фактора,
приведена в работе [1].
). Наиболее полная модель, учитывающая оба фактора,
приведена в работе [1].
![]() (6)
(6)
![]() .
(7)
.
(7)
Параметры ![]() и
bопределяются
газодинамическими характеристиками системы:
и
bопределяются
газодинамическими характеристиками системы:
 , (8)
, (8)
где ![]() ,
, ![]() - радиус реактора и подставки, см;
- радиус реактора и подставки, см;
![]() ,
, ![]() - температура эпитаксии и стенок реактора, К;
- температура эпитаксии и стенок реактора, К; ![]() - в мкм/мин.
- в мкм/мин.
 ,
(9)
,
(9)
где ![]() - температура ПГС, К;
- температура ПГС, К; ![]() -
давление ПГС (мм рт. ст.) - на входе в реактор; Q- общий расход ПГС (л/мин); z - расстояние от верха подставки, см.
-
давление ПГС (мм рт. ст.) - на входе в реактор; Q- общий расход ПГС (л/мин); z - расстояние от верха подставки, см.
Если образующая подставка отклонена от
вертикали на угол ![]() , то величина Qдолжна
быть умножена на корректирующий множитель:
, то величина Qдолжна
быть умножена на корректирующий множитель:
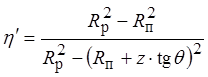 .
(10)
.
(10)
Как показывают расчеты и эксперимент, при использовании
цилиндрической подставки скорость роста закономерно уменьшается от верхнего
яруса к нижнему, для компенсации этого уменьшения следует отклонять образующую
от вертикали (угол ![]() ) - это приводит к
сужению сечения и, соответственно, увеличению линейной скорости газового потока
и компенсирует уменьшение скорости.
) - это приводит к
сужению сечения и, соответственно, увеличению линейной скорости газового потока
и компенсирует уменьшение скорости.
2.3. Оценка воспроизводимости пленок по толщине.
Толщина эпитаксиальной пленки (![]() ) является
одной из основных характеристик.
) является
одной из основных характеристик.
![]() (11)
(11)
В связи с тем, что время процесса может регулироваться с очень высокой точностью, разброс толщины определяется в основном разбросом скорости роста. Оценка воспроизводимости может быть произведена по формуле [1]:
 ,
(12)
,
(12)
где ![]() - относительная погрешность скорости роста (
- относительная погрешность скорости роста ( );
);
![]() - относительная погрешность i-го технологического
параметра (
- относительная погрешность i-го технологического
параметра ( );
); ![]() - коэффициент влияния;
- коэффициент влияния; ![]() - может быть вычислено в соответствии с выражением (5):
- может быть вычислено в соответствии с выражением (5):
 .
(13)
.
(13)
Здесь ![]() - значение скорости роста при номинальных значениях
параметров технологического процесса;
- значение скорости роста при номинальных значениях
параметров технологического процесса; ![]() - номинальное значение i-го параметра
технологического процесса;
- номинальное значение i-го параметра
технологического процесса; ![]() - абсолютное отклонение скорости от номинала при
абсолютном отклонении параметра
- абсолютное отклонение скорости от номинала при
абсолютном отклонении параметра ![]() . Выражение
(12) позволяет учесть суммарный вклад всех отклонений технологического процесса
и выделить факторы, вносящие максимальный вклад.
. Выражение
(12) позволяет учесть суммарный вклад всех отклонений технологического процесса
и выделить факторы, вносящие максимальный вклад.
2.4. Практическое осуществление процесса эпитаксии.
В связи с тем, что смесь водорода с воздухом образует взрывоопасную смесь, после загрузки и герметизации установки ее продувают азотом в течение 10...20 минут для вытеснения воздуха. Затем пускают водород и продувают установку для вытеснения азота (10...20 мин), водород продолжает поступать в установку в течение всего процесса роста пленки и в течение 10...20 минут после его окончания и выключения индуктора. Затем водород сменяется азотом, который подается до полного остывания подставки (до температуры 60...120 °С), после чего установка вскрывается. За 3...5 минут до начала процесса водородом продувается испаритель с SiCl4. Продувка проводится через обводную линию, процесс роста начинается сразу после переключения испарителя с обводной линии на реактор.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.