2.1 Конструкции и параметры биполярных транзисторов ИС
Различным требованиям, предъявляемым к транзисторам, отвечают различные их конфигурации в плане, или топологии, а также профили вертикальной структуры. Установление связи характеристик транзисторов с их топологией и свойствами слоев являются необходимой предпосылкой конструирования ИС.
2.1.1 Типовые конструкции n-p-n-транзисторов VT1 и VT2 ИС усилителя широкополосного
Свойства диффузантов, данные им от природы, обеспечивают более высокое качество транзисторов n-p-n-структуры по сравнению с p-n-p. Это учитывается при разработке электрической схемы ИС: преимущественно используются n-p-n-транзисторы. Соответственно для них осуществляется разработка вертикальной структуры ИС и поочередное проектирование топологии.
Основным параметром, по которому разделяют конструкции транзисторов, являются рассеиваемая мощность Р. Различают транзисторы маломощные (менее 3 мВт), средней (от 3 до 25 мВт) и большой (от 25 до 250 мВт) мощности.
Таким образом, анализируя ТЗ, можно сделать вывод, что транзисторы VT1 и VT2, представленные в данной схеме усилителя широкополосного, относятся к
транзисторам маломощным и средней мощности соответственно.
В маломощных транзисторах электрические нагрузки обычно много меньше предельных (при минимальных технологически достижимых размерах топологии), поэтому размеры их конструкции определяются в основном технологическими ограничениями (рис. 2.1)

Рисунок 2.1
Для улучшения растекания тока и уменьшения сопротивления тела коллектора используют конструкции, в которых коллекторный ток подходит к эммитеру с двух сторон (рис. 2.2).

Рисунок 2.2
2.1.2 Вертикальная структура и подложка ИС
При различных методах изоляции используются соответственно различные структуры подложек. Предприятиями цветной металлургии выпускается широкий ассортимент как однородно легированных полупроводниковых пластин, так и сложных эпитаксиальных структур, характеристики которых зашифрованы в обозначениях.
При использовании ЭПИК-изоляции исходной является подложка n-типа, которая в результате проведения соответствующих операций оказывается областью коллектора.
Уровень легирования коллекторной области n-области определяет последовательного сопротивления коллектора rк, а также емкость Ск и напряжение пробоя перехода «коллектор-база» Uпр.к. Для обеспечения малого Ск и высокого Uпр.к степень легирования эпитаксиального n-слоя (т.е. коллектора) должна быть малой. Обычно принимают ρ≈0,1-5 Ом∙см, чаще - в пределах 1,5-2,5 Ом∙см. Меньшие значения (менее 1,5) оправданы при больших токовых нагрузках. Легирующая примесь – фосфор.
Необходимо помнить, что при ЭПИК-процессе локализация n+-слоя в плане не требуется, и он может располагаться по всей поверхности подложки.
Таким
образом, обозначение однородно легированного слоя кремния имеет следующую
структуру: 5А1 КЭФ 3/0,1-60, а структура кремниевой однородной
пластины-подложки:  .
.
Для защиты элементов ИС используется пленка двуокиси кремния толщиной 0,3-0,6 мкм, а для выполнения коммутации ИС – термически напыляемая пленка алюминия толщиной 0,6-1 мкм, в которой фотолитографией выполняется рисунок проводников.
2.1.3 Расчет транзисторов VT1 и VT2
Учитывая сказанное выше (пп 2.1-2.1.2), для проектирования транзисторов необходимо задаться вертикальной структурой ИС. Для этого нужно задать уровни легирования всех областей и металлургические глубины залегания всех p-n-переходов, а также толщины этих областей.
Фрагмент разреза n-p-n-транзистора представлен на рисунке 2.3. С учетом перекомпенсации примесей разного типа результирующее распределение может быть записано в виде:
 ,
(2.1)
,
(2.1)
где NSЭ – поверхностная концентрация эммитера, задана и равна 1021;
NБ -концентрация базы, задана и равна 5∙1017 (т.к. база – однородно легированная область);
dЭО – характеристическая длина эммитерной диффузии.
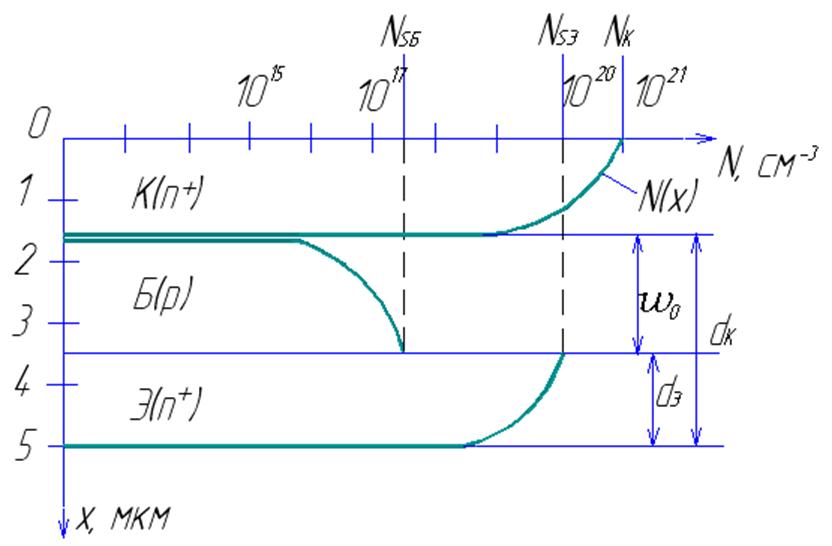
NSЭ=1021;
NSK=1020;
р=5∙1017;
dЭ=1.5∙10-4 см;
dК=3.5∙10-4 см.
Рисунок 2.3 - Фрагмент разреза n-p-n-транзистора
В формулу (2.1) не входит концентрация коллекторного эпитаксиального слоя NК, т.к. база наращивается эпитаксиально и тем самым сформированный переход «база - коллектор» не оказывает влияния как технологически, так и конструктивно на епреход «эмиттер - база».
Из выражения (2.1) можно выразить аналитическую характеристическую длину диффузии (dЭО), обеспечивающую заданную глубину залегания эмиттерного перехода (dЭ):
 , (2.2)
, (2.2)
 (мкм).
(мкм).
2.1.3.1 Расчет параметров обедненного слоя p-n-перехода
По обе стороны металлургической границы p-n-перехода возниакет обедненный носителями слой или область пространственного заряда (ОПЗ), а между p- и n-областями устанавливается контактная разность потенциалов Δφ, которая по определению выглядит следующим образом:
 , (2.3)
, (2.3)
где NА, NД – концентрации доноров и акцепторов на границах ОПЗ, равны соответственно 4∙1016 и 5∙1018;
ni – концентрация носителя заряда в собственном (нелегированном) полупроводнике [1, П5];
k – постоянная Больцмана;
q – заряд электрона [1, П1];
Т – абсолютная температура.
kT/q=0,0259 (эВ);
 (В).
(В).
Если исходный материал до получения диффузионного p-n-перехода был однородно легирован до концентрации примесей N0, контактная разность потенциалов может быть найдена из решения трансцендентного уравнения
 ,
(2.4)
,
(2.4)
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.