Предельная растворимость примеси N0 = 1,0.1025м-3
Константа диффузии при T=1473K, D0 = 1,40.10-3м2/c
Энергия активации: 3,89 эВ
Исходная концентрация доноров C = 5,0.1011м-3
Временная зависимость глубины залегания p-n перехода

Выводы:
При росте температуры глубина залегания p-n перехода экспоненциально увеличивается (закон Аррениуса). В результате того, что легирование производится из неограниченного источника, при том же времени проведения диффузии примеси проникают на меньшее расстояние, (чем при легировании из ограниченного источника). Это следует из того, что при диффузии из постоянного источника концентрация на границе не меняется, и примеси не успевают проникать в глубь объема (необходимо большее время на их распределение по объему).
ЛАБОРАТОРНАЯ РАБОТА №5
"Двустадийная диффузия. Расчет распределения примеси при диффузии из бесконечно тонкого слоя"
Цель: Научиться рассчитывать распределения примеси при диффузии из бесконечно тонкого слоя.
Краткие сведения о работе
Введя в кремний легирующую примесь, в случаи двустадийной диффузии находим распределения примеси при диффузии из бесконечно тонкого слоя. Расчет профиля распределения примесей по толщине полупроводника и глубины залегания р-n перехода, проводится по выражениям
 (1)
(1)
 (2)
(2)
При выполнении условия
![]() (3)
(3)
Ваш вариант: 6
Исходные данные:
Исходный материал - кремний n -типа;
Удельное сопротивление R0: 0,4
Легирующая примесь - Фосфор (P)
- Фосфор (P)
Загонка:
Температура Т1: 1000 0C
Время t1: 10 мин.
Коэффициент диффузии D1 при температуре T1: 4,4.10-14 см2/с
Предельная растворимость N0 для температуры T1: 1,1.1021 см-3
Разгонка:
Температура Т2: 1100 0C
Время t2: 180 мин.
Коэффициент диффузии D2 при температуре T2: 5,0.10-13 см2/с
Результаты вычислений:
Глубина залегания p-n перехода: 4,409 мкм
Поверхностная плотность атомов N: 6,37749.1016 см-2
Расчетные профили распределения для Фосфор (P):
после загонки
xp-n , мкм С
0,00 1,0053.1021
0,20 7,0812.1018
0,40 2,5574.1013
после разгонки
xp-n , мкм С
0,00 4,8964.1019
0,20 4,5468.1019
0,40 3,6408.1019
0,60 2,5139.1019
0,80 1,4968.1019
1,00 7,6847.1018
1,20 3,4022.1018
1,40 1,2988.1018
1,60 4,2756.1017
1,80 1,2137.1017
2,00 2,9709.1016
2,20 6,2706.1015
2,40 1,1413.1015
2,60 1,7912.1014
2,80 2,4242.1013
3,00 2,8290.1012
3,20 2,8469.1011
3,40 2,4704.1010
3,60 1,8485.109
3,80 1,1927.108
4,00 6,6358.106
4,20 3,1836.105
4,40 1,3171.104
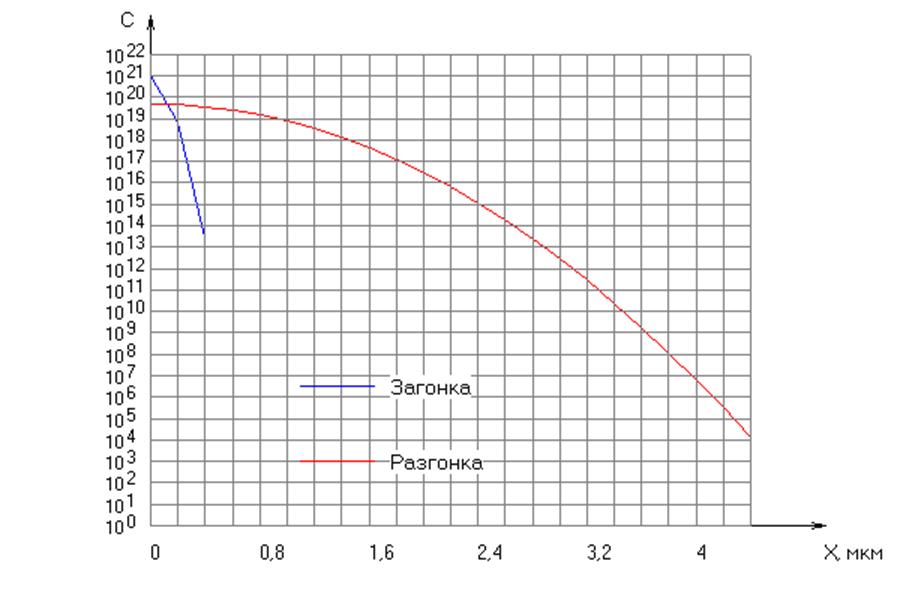
Выводы:
Условие ![]() выполняется
выполняется
При создании р-n перехода диффузионный процесс проводят в две стадии. На первой стадии - стадии загонки- осуществляется низкотемпературная диффузия(900 0C) из источника постоянной концентрации в течение 15 минут. В результате, в тонком поверхностном слое полупроводника формируется область, обогащенная примесями противоположного типа проводимости. Затем, проводится вторая стадия - стадия разгонки примесей. Она осуществляется при более высокой температуре (1000 0С) и более длительное время 180 минут. В процессе разгонки атомы примеси, находящиеся в тонком поверхностном диффузионном слое перераспределяются по объему полупроводника. Из графика видно, что глубина залегания p-n перехода при разгонке (1,7 мкм) намного больше глубины залегания при загонке (0.2 мкм). Под действием температуры на первой стадии мы получаем p-n переход, глубина залегания которого очень мала. На второй стадии в процессе разгонки атомы примеси, находящиеся в тонком диффузионном поверхностном слое, перераспределяются по объему полупроводника, что ведет к смещению p-n перехода вглубь кристалла. Можно считать, что тонкий диффузионный поверхностный слой, сформированный на первой стадии, и есть источник ограниченной концентрации. Форма профиля распределения примеси, полученная на стадии загонки, не влияет на профиль распределения после разгонки, так как глубины залегания примесей по координате несопоставимы.
ЛАБОРАТОРНАЯ РАБОТА №6
"Двустадийная диффузия. Расчет распределения примеси при диффузии из слоя конечной толщины"
Цель: Научиться рассчитывать распределения примеси при диффузии из слоя конечной толщины.
Краткие сведения о работе:
Введя в кремний легирующую примесь, в случаи двустадийной диффузии находим распределения примеси при диффузии из слоя конечной толщины
В конечном счете, получается комбинированное распределение, которое определяется решением уравнения второго закона диффузии для слоя конечной толщины (второе уравнение Фика):
 ,
,
где y - постоянная интегрирования;
![]() - поверхностная концентрация после
загонки;
- поверхностная концентрация после
загонки;
 ;
;
 .
.
Ваш вариант: 6
Исходные данные:
Исходный материал - кремний n -типа;
Удельное сопротивление R0: 0,4
Легирующая примесь - Фосфор (P)
- Фосфор (P)
Загонка:
Температура Т1: 1200 0C
Время t1: 10 мин.
Коэффициент диффузии D1 при температуре T1: 8,8.10-12 см2/с
Предельная растворимость N0 для температуры T1: 1,2.1021 см-3
Разгонка:
Температура Т2: 900 0C
Время t2: 180 мин.
Коэффициент диффузии D2 при температуре T2: 4,5.10-15 см2/с
Результаты вычислений:
Глубина залегания p-n перехода: 0,4183 мкм
Поверхностная плотность атомов N: 1,07781.1018 см-2
Расчетные профили распределения для Фосфор (P):
после загонки
xp-n , мкм С
0,00 1,0967.1021
0,40 8,6193.1020
0,80 5,8217.1020
1,20 3,3793.1020
1,60 1,6857.1020
2,00 7,2270.1019
2,40 2,6627.1019
2,80 8,4312.1018
3,20 2,2943.1018
3,60 5,3655.1017
4,00 1,0784.1017
4,40 1,8626.1016
4,80 2,7649.1015
5,20 3,5272.1014
после разгонки
xp-n , мкм С
0,00 3,5272.1014
0,40 7,6045.1020
0,80 7,0546.1020
1,20 5,6321.1020
1,60 3,8696.1020
2,00 2,2880.1020
2,40 1,1643.1020
2,80 5,0984.1019
3,20 1,9214.1019
3,60 6,2317.1018
4,00 1,7394.1018
4,40 4,1780.1017
4,80 8,6367.1016
5,20 1,5365.1016
5,60 2,3523.1015
Поверхностная концентрация примеси после разгонки:
1,1269.1021
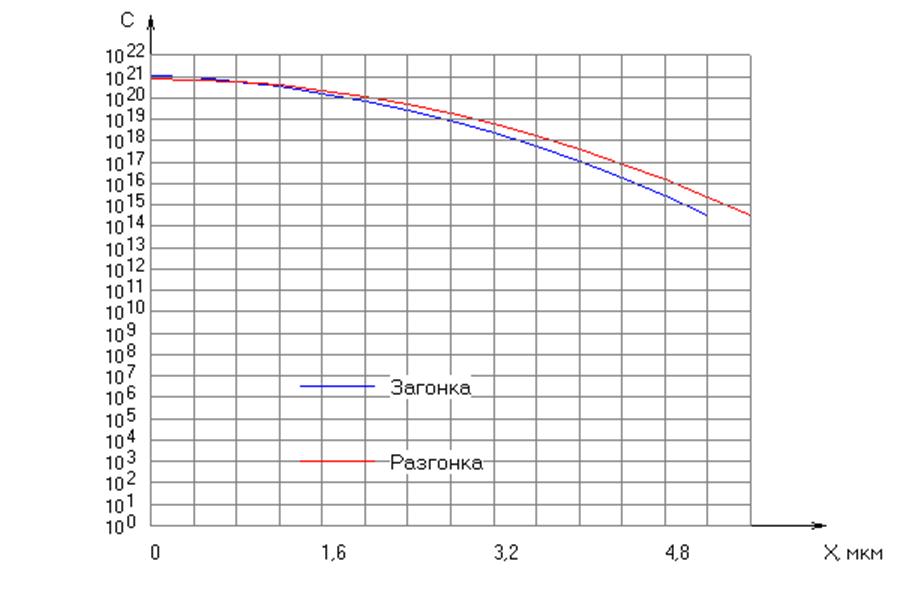
Выводы:
Как и в предыдущей работе при создании p-n перехода диффузионный процесс проводят в две стадии. В данной лабораторной работе условие Dзtз<Dрtр не выполняется. Глубина диффузии на стадии разгонки сравнима с глубиной на стадии загонки. Это означает, что данные стадий взаимосвязаны. Поэтому при расчете профиля распределения примесей следует использовать условие, справедливое для процесса диффузии из ограниченного источника конечной толщины. Отсюда следует, что для расчета распределения примесей на стадии загонки используют формулу второго уравнения Фика.
Уважаемый посетитель!
Чтобы распечатать файл, скачайте его (в формате Word).
Ссылка на скачивание - внизу страницы.